窒化物半導体の展開-結晶基板とデバイス-
|
|
|
- うまじ かいじ
- 7 years ago
- Views:
Transcription
1 特別論文 窒化物半導体の展開 - 結晶基板とデバイス - 元木健作 Advances in Nitride Semiconductors - Substrates and Devices - by Kensaku Motoki Gallium nitride (GaN) and other nitride compound semiconductors show high potential as optical and electronic devices. Sumitomo Electric Industries, Ltd. has been researching this potential, and in the early 2s succeeded in developing the world s first 2-inch GaN single crystal substrates with high quality and low dislocation density, which were essential features for violet lasers, by using vapor phase growth technique. Moreover, we have worked on the development of optical and electronic devices using GaN substrates. Taking advantage of the characteristics of GaN s semi-polar {2-21} plane, we succeeded in demonstrating the world s first room-temperature continuous-wave operation of a 52 nm green laser diode. We also successfully fabricated Schottky barrier diodes with a specific on-resistance of.71 mωcm 2 and breakdown voltage of 11 V as well as pn-junction diodes with a breakdown voltage of 925 V. Furthermore, we have developed novel vertical heterojunction field-effect transistors which exhibit a low specific onresistance of 7.6 mωcm 2 with a breakdown voltage of 672 V. This paper reviews our R&D activities on GaN-related semiconductors for over the past ten years. Keywords: GaN, substrate, dislocation, laser, diode, transistor 1. 緒言 周期律表におけるⅢ-Ⅴ 族を中心とする化合物半導体は 発光ダイオード (LED) や半導体レーザ (LD) 等の光デバイスとして 信号機やディスプレイ用デバイス さらには照明 および CD や DVD などのデジタル情報読み取りの中核デバイスとして応用され さらに電子デバイスとしては 携帯電話基地局の増幅デバイスとして また携帯電話中の高周波増幅デバイスとして用いられ 世の中の必要欠くべからざるものとなっている 当社は 196 年台初頭の頃から GaAs 等の化合物半導体のバルク結晶成長に取り組み デバイスの基礎となる結晶基板 さらにはその上にエピタキシャル成長を行ったエピウエハの開発 製品化を行い 世界の化合物半導体の進展に貢献してきた そこから発展して 197 年台後半からは InP 系 GaAs 系の光通信用光デバイスや電子デバイスの研究開発 およびその事業化を進めてきた (1) これらの化合物半導体は Ga In Al 等のⅢ 族元素と As P Sb 等のⅤ 族元素の組み合わせからなるⅢ-Ⅴ 族の化合物であり それぞれが親和性のある似通った性質を示す材料系であった 例えば それらは全て立方晶系の閃亜鉛鉱型の結晶構造を示し 全て高温で溶融させ凝固過程でバルク単結晶を得ることの出来る溶融成長が可能であった また それぞれが比較的広い組成比で化合した混晶を作ることが出来た バンドギャップは比較的狭く 混晶により発光素子としては赤外光から可視光の黄緑色まで比較的長い波長を 得ることが出来た それに対して 198 年台末から大きな進展を見たのが 窒化ガリウム (GaN) を初めとする窒化物系の化合物半導体である これは 前述の化合物半導体と同じⅢ-Ⅴ 族半導体であり Ⅲ 族元素として Ga In Al からなるが Ⅴ 族元素がそれまでとは違った N( 窒素 ) で構成されている しかも結晶構造は 六方晶系のウルツ型であり 前述の GaAs 系 InP 系の化合物半導体とは化合物を作りにくく 親和性の乏しい異質な材料系である また 高温では溶融せずに高い分解圧で窒素が分解してしまうため バルク結晶は 得られていなかった バンドギャップも大きく 光デバイスとしては 可視光から紫外光をカバーする事が出来る このように異質な窒化物系化合物半導体は 従来の化合物半導体のようなバルク結晶が得られないため そのデバイスは サファイアなどの全く異なる異種材料からなる異種基板上へのヘテロエピによって登場した 1993 年にサファイア基板上のダブルヘテロ型エピ構造を有した青色 LED が公表され 日本を中心に世界的に研究開発が加速された このように LED に関しては 主にサファイア基板を用いたヘテロエピで開発 産業化が進み 現在も照明用途を含めて市場は拡大途上である しかしながら 窒化物半導体のポテンシャルは サファイア基板上のヘテロエピだけでは全ての花を開かせることはことは出来ない バルクの窒 ( 4 ) 窒化物半導体の展開 結晶基板とデバイス
2 化物半導体基板も必要であった 当社は GaN のバルク結晶基板の研究開発から開始し それを実現すると共に その事業化を進めた 同時に その GaN 基板を用いて窒化物半導体の応用の幅を広げるべく 各種の窒化物半導体デバイスの研究開発をも進めてきた ここでは 当社におけるここ 1 数年にわたる窒化物半導体に関する取り組みについて その基板材料と窒化物半導体デバイスとの関係についてレビューする 2. 窒化ガリウム基板の開発当社では 他のⅢ-Ⅴ 族化合物半導体についてそうであったように窒化物半導体に対しても やはりバルク結晶からその研究開発に着手した それまでに培って来た窒化ガリウム (GaN) の気相合成法である Hydride Vapor Phase Epitaxy(HVPE) 1 を用いて 異種基板上のヘテロエピタキシャル成長の技術を発展させ 199 年台後半頃からバルク結晶成長に取り組んだ 当時は GaN のバルク成長は 数万気圧の高温超高圧状態での結晶成長法の研究が行われていたが 大口径化が困難で かつ量産性が低いと考えられていた 当社は バルク結晶を得るに当たり HVPE によるエピタキシャル成長により 下地基板上に高速で厚く GaN の結晶成長を行い その後下地基板を除去する というプロセスにより GaN 結晶基板を得るべく開発を進めた 下地基板として GaN と熱膨張係数が近く 加工しやすく除去が容易な GaAs 単結晶基板を選択した これにより初めて 2 インチ径の GaN 基板の開発に成功した ( 写真 1) (2) 位と呼ぶ線状の結晶欠陥が 1 9 cm -2 も多量に存在しているのであるが レーザ用の GaN 基板には レーザ素子寿命を伸ばすために転位欠陥の密度をその 1 万分の 1 以下に低減する必要があった 上記の転位密度を大幅に低減するために 当社が開発した 2インチ径 GaN 基板には 当社独自開発による DEEP (dislocation elimination by the epitaxial-growth with inverse-pyramidal pits) と呼ぶ転位低減手法により 転位密度の低減がなされた DEEP とは ヘテロエピの際の基板とエピの間の結晶格子の違いから発生する多量の転位欠陥を低減するために 結晶成長の際の最表面にピット状の窪みを形成し その形状を維持して厚く成長するというものである その結果 成長の進行と共に 転位は窪みの中心部分に集合し その周辺の領域の転位密度を低減する事が出来る この手法により 数百 µm 径程度の広さの低転位領域を形成する事が出来る もちろんその後 研磨加工により平坦化されるが この低転位領域にデバイス構造を形成すればよい ( 3 ) ( 8 ) DEEP 法による基板には 図 1の様なバリエーションがある 図 1(a) は 転位の集合部とその周囲の低転位密度部とがランダムに分布している (b) (c) は DEEP 法の応用というべきもので A-DEEP(Advanced-DEEP) と呼ぶが 転位を集合させる部分にコアと呼ぶ領域を作ったものである このコア領域は 他の領域に対して GaN 結晶の C 軸方向 ([1] 方向 ) が 18 反転している ドット型 (b) は 転位の集合部のドット型コアが規則正しく配置され 低転位密度部もそのサイズがほぼ均一となっている ストライプ型 (c) は 転位の集合部であるコアがドット型ではなくストライプ型となっており 1 4 cm -2 程度の転位密度も得られている (9) (11) このストライプ型は レーザ用として開発したもので この低欠陥密度の実現に 写真 1 2 インチ径 GaN 基板 当時の GaN 基板の用途は まずは光ディスクに用いられる青紫色レーザ用であった 既にヘテロエピで製品化されていた LED とは異なり レーザではチップ端面の平坦な反射面を劈開面によって得るために 劈開性を有したホモエピ用基板である GaN 基板が必要とされた さらに 通常サファイア基板上のヘテロエピの GaN 結晶中には 転 図 1 DEEP 法による GaN 基板 212 年 7 月 SEI テクニカルレビュー 第 181 号 ( 41 )
3 より初めてレーザ素子寿命が延び 青紫色レーザの実用化を進める事が出来た 既に 22 年頃からこの基板を用いたレーザが報告されている (12) (13) ブルーレイディスクなどの光ディスク用のレーザ用基板として またそれ以外への適用も進み 多くの顧客に採用され 当社の半導体基板事業として貢献している (1) 3. GaN 基板上のエピタキシャル成長と LED 3-1 エピタキシャル成長 GaN 基板の実現を受けて 当社では GaN 基板上への GaN 系エピタキシャル成長 特に光デバイス用エピタキシャル成長と LED 応用の研究開発を開始した 既に述べたように 通常 窒化物系の LED 等の光デバイスは 下地基板としてサファイア基板が用いられており 前述のように多くの欠陥を有している これに対し 低欠陥の GaN 基板を用いる事により 当然ながら低欠陥のエピタキシャル成長層が得られる エピタキシャル成長法として OMVPE(Organo-metallic Vapor Phase Epitaxy) 2 を用いてその最適化を行った 3-2 GaN 基板上の紫外 LED 窒化物系光デバイスでは 発光波長が短くなり紫外領域に達すると 転位密度の影響が現れ 転位密度が高いと発光輝度が低下することが知られていた 紫外 LED は 蛍光体の励起や 殺菌等への応用が考えられ 当社でも低欠陥の GaN 基板の特長が生かせる紫外 LEDの研究を実施した GaN 基板上に図 2 に示した LED を製作した 発光層として InAlGaN 層からなる多重量子井戸 (MQW) を有したエピ構造を採用した 同時にサファイア基板を用いたテンプレート上にも同じ構造のエピ成長を同時に行い 両者の LED 特性を比較した この光出力の差は 評価解析の結果 転位欠陥の為であると考えられる 図 4にカソードルミネッセンス (CL) 像に示されたように サファイア基板上 LED には 多くの発光しない黒点が見られ これが光出力の低下の原因であった (14) (15) サファイア対比で熱伝導率が 5 倍優れる GaN 基板は 発生した熱を効率良く逃がすために光出力が飽和しないというメリットもあった このように 紫外 LED においては GaN 基板を使用することで サファイア対比で遙かに優れた発光特性を有する LED が得られ GaN 基板の優位性が明確化した EL Intensity (a.u.) Wavelength (nm) 図 3 紫外 LED の光出力 電流特性 1µm 1µm 図 4 InAlGaN からなる MQW 活性層からの CL 像 (a)gan 基板上 (b) サファイア基板上 図 2 紫外 LED の構造その結果 両者には LED の発光輝度において大きな差が見られ GaN 基板上に作成した LED からは サファイア基板上の LED に対して図 3に見られるように 1mA 時には約 3 倍の光出力で波長 351nm の紫外光が得られた 3-3 GaN 基板上の青色 LED 一方 可視光の青色 LEDは 白色 LEDの光源として世の中で広く用いられているが 一般に用いられているのは サファイア基板である 青色 LED に対しては 通常の使用であれば転位密度はその特性に影響しないものと考えられていた 当社では この青色 LED において低転位の GaN 基板が用いることの優位性はないか と言う視点からも研究を行った サファイア基板上に InGaN 発光層からなる MQW 構造を ( 42 ) 窒化物半導体の展開 結晶基板とデバイス
4 有したエピ構造を形成して作成された波長 45nm 前後の青色 LED に対しては 注入電流を上げていった場合 光出力が電流値に比例せずに発光効率が低下して行く droop と呼ばれる現象が知られており 青色 LED の高出力化における障害となっていた これに対して 低転位の GaN 基板を用いる事によって MQWにおける量子井戸層の厚さによっては droop の改善がなされることを見出した (16) (17) 井戸層の厚さを 3nm とした場合 注入電流値を 2mA から 2mA へと上げる際に droop により電流値の比例値より 3 ~ 4 % の発光効率 ( 外部量子効率 ) の低下が見られるが 井戸層厚さを 5nm へと厚くした場合 低転位の GaN 基板を使用することによって図 5に示したように 13 % 程度の効率低下となり 効率低下の減少が見られた これは 井戸層を厚くする事によって設計上 活性層の In 組成を下げる事が出来 droop の影響を弱められる上に 貫通転位が少ない事による活性層の結晶性の改善が寄与しているためと考えた 青色 LED において 条件付きながらも 低転位 GaN 基板が優位である可能性が示されたと言える またこれ以外にも GaN 基板を用いる事により 基板に導電性があるため電流を均一に広げる効果や 熱伝導率が上がることにより放熱性が良くなるという効果が加わることになる かしながら C 面の場合 この内部電界の為に 活性層内で電子とホールの存在場所が分離され 結合する確率が大きく低下する 特に 長い波長の光を得ようとすると 活性層中の InGaN 層の In 組成比率を上げる必要があるため 結晶格子が大きくなり 内部応力が増大し この内部電界も大きくなる このため発光効率が低下し 長波長の光デバイスの実現が困難であった ( 図 6 図 7) これに対する解決策は既に知られていた それは 窒化ガリウム結晶において C 面以外の面を用いる事である C 面は極性面と呼ばれ C 面に垂直方向に内部電界が発生し 最も分極の影響が大きい しかし C 面に垂直な {1-1} 面 (M 面 ) {11-2}(A 面 ) などの面に対しては 分極が発生せず 無極性面と呼ばれ 発光効率の低下が防止できる可能性がある また C 面以外の面で無極性面から傾いた面は 半極性面と呼ばれ 内部電界を低減できる事が予測されていた ( 図 6 図 7) (2) ところで 半導体レーザにおいては 窒化ガリウム系の InGaN を発光層とする半導体レーザでは 短波長側で紫色から青色までが実現されているものの 前述の理由で波長が長くなると共に発光効率が低くなるため 緑色やそれより長波長のレーザは未実現であった 一方 波長が長い方は InGaAsPや AlInGaPを発光層とするレーザにより 赤外から赤色までが実用化されており ちょうど波長 5 ~ 6nm 程度の緑色付近の半導体レーザが未実現であっ 図 5 GaN 基板上青色 LED の光出力および外部量子効率の順方向電流との関係 図 6 GaN の結晶構造と結晶面 4. 窒化ガリウムの半極性面と緑色レーザの開発 4-1 圧電性と半極性面これまで述べてきた窒化ガリウム基板上のエピタキシャル成長および 光デバイスは 全て 窒化ガリウム結晶の (1) 面 (C 面と呼ばれる ) を用いる事を前提としていた 一方 窒化ガリウムの結晶は 物性として圧電性 ( ピエゾ効果 ) を有する事が知られている 即ち 結晶に応力が掛かるとそれに応じた分極による電界が結晶中に生じる 光デバイスでは n 型半導体層とp 型半導体層の間に挟まれた活性層において 前者から供給される電子と後者から供給されるホールとが 結合し エネルギーを光として放出する事で発光する し 図 7 極性面と無極性面の内部電界の影響 212 年 7 月 SEI テクニカルレビュー 第 181 号 ( 43 )
5 た 可視光レーザとして 赤色 青色が既に実用化されているため あと緑色が実現出来れば 光の 3 原色が揃うことになり 映像ディスプレイ用途等に応用範囲が大きく広がると考えられる 4-2 緑色レーザの開発当社では このような状況に対応し GaN 基板技術を保有する当社の優位性を生かし 無極性面及び非極性面の窒化ガリウム基板を開発して提供することにより 緑色レーザの実現を目指して研究を行ってきた 緑色レーザには 分極の影響を排除するために 無極性面 半極性面の窒化ガリウム基板が必要であり かつ 活性層の MQW の InGaN 量子井戸層には高い In 組成と同時に優れた結晶性が要求されると 当社は考えた まずは それらを全て満足する面方位を有する無極性面 半極性面を見出して しかる後にレーザを作製する必要があった 当社での研究開発の結果 見出したのが半極性面である {2-21} 面であった この面を有した GaN 基板上にレーザを作製した {2-21} 面とは C 面を M 軸方向へ 75 傾けた面であり 基板の貫通転位密度は 1 6 cm -2 以下であった ( 図 6) その上に n-gan 層 n-inalgan クラッド層 n-ingan 光ガイド層 InGaN 井戸層を有した MQW 発光層 p-algan 電子ブロック層 p-ingan 光ガイド層 p-alinganクラッド層 p-ganコンタクト層からなるエピ構造を成長した 得られた {2-21} 面レーザは 注入電流量を上げた際の自然放出光の波長のブルーシフト量は 無極性面のm 面でのレーザに比べると大きいものの C 面のレーザに比べると遙かに小さく 分極の影響は十分に低減出来ていることが判明した また その自然放出光の半値幅は C 面 M 面でのレーザに比較して最も小さく また {2-21} 面のエピ表面の蛍光顕微鏡による観察では 面内が非常に均一で 非発光領域は全く認められなかった 極めて均一な結晶品質となっていることが判明した この活性層の均一性が {2-21} 面レーザの特長であると言える (18) (24) この {2-21} 面レーザによって 29 年に世界で初めて緑色レーザ発振を実現した 波長 531nm でパルス発振 ( デューティ比.5%) し 発振のしきい電流 Ith は 924mA(15.4kA/cm 2 ) しきい電圧 Vth は 23.3V であった さらには 室温連続発振も実現し 波長 52nm Ith が 95mA(7.9kA/cm 2 ) V th が 9.4Vであった ( 図 8) その後 特性改善も進み 21 年には 波長 525nm Ith が 51mA(4.3kA/cm 2 ) V th が 6.38Vのレーザも公表した (23) この様に当社において {2-21} 面を用いた緑色レーザの開発は進展しているものの 一方 当社以外の他機関でも C 面を用いた緑色レーザの開発も進んできた 図 9に現状の他機関の公表データを含めた 緑色レーザの研究開発の状況を示した この図より明らかなように C 面レーザも発振波長は長くなり 52nm をも上回ってきた しかしながら 52nm 程度まではほとんどしきい電流に差はないも のの 52nm を超えたところから C 面レーザでは 波長発振のしきい電流が高くなり {2-21} 面レーザとの差がはっきりしてきた {2-21} 面レーザでは 発振波長が長くなっても しきい電流の大きな増加は認められない これは 半極性面を用いる事で ピエゾ電界の影響を大きく低減出来た事に加えて 長波長領域においても活性層の均一な結晶性が保たれていることに起因していると考えられる 緑色レーザの実用化を巡り 開発競争は まだ継続しているが 現時点 原理的にも {2-21} 面レーザの方が優位であると考えられる 51 at 25 C 図 8 {2-21} 面レーザの室温連続発振における光出力特性 (a) 光出力 - 電流 - 電圧特性 (b) 波長スペクトル (1mA 時の CW 発振下 ) (c)52nm レーザ光の発振 図 9 5 c-plane, cw; T. Miyoshi c-plane, pulse; A. Avramescu c-plane, cw; A. Avramescu {2-21}, pulse (gain-guided); This work {2-21}, cw (ridge waveguide); This work レーザ発振波長とそのしきい電流密度との関係 C 面レーザと {2-21} 面レーザとの比較を示し 円形は {2-21} 面レーザ それ以外の三角 菱形は C 面レーザを示す ( 44 ) 窒化物半導体の展開 結晶基板とデバイス
6 5. GaN 基板と電子デバイスの開発 GaN 基板を用いた光デバイスの開発について述べてきたが 電子デバイスへの応用についても並行して研究開発を行った 低転位の GaN 基板を用いて 優位性のある電子デバイスの可能性を追求した 当社では GaN-HEMT などの通信用高周波デバイスについては 伝送デバイス研究所や住友電工デバイス イノベーション (SEDI) において研究 事業化が行われているが それらは SiC 基板上のヘテロエピタキシャル成長によるものである ここでは GaN 基板を用いた電子デバイスの研究開発を取り上げる 5-1 低転位 GaN 基板上のエピ成長電子デバイスには 光デバイスとは違って遙かに大きな耐電圧が要求され そのためには低濃度の領域でのキャリア濃度の制御性が重要になってくる たとえば 耐圧数 1V から 1kV 以上が要求されるパワーデバイス用途においては n 型キャリアで cm -3 程度以下での制御が必要となる GaN 基板の特長を明確化するために サファイア基板との比較研究を行った 転位密度が cm -2 以下の GaN 基板と サファイア基板上に GaN のエピタキシャル成長層を有したテンプレート ( 転位密度 cm -2 ) を準備し その上に n 型不純物の Siを所定量の低濃度ドーピングをそれぞれ行って GaNのエピタキシャル成長を行った GaNエピ成長は OMVPEにより 原料ガスとして有機金属の TMG( トリメチルガリウム ) NH3 を混合して流し また SiH4 を所定量流して Si ドーピングを行った その結果 SiH4 の供給量と GaN エピ層のキャリア濃度との関係は 図 1 の通りとなった GaN 基板上には ほぼ 想定通りの SiH4 供給量に比例したキャリア濃度が得られたのに対し サファイアテンプレート上では 低濃度領域で明らかに想定値とのズレが発生した 分析の結果 両者の間では Si 以外の不 1 18 純物の含有量が異なり 特に炭素の不純物濃度がサファイア基板上では一桁多く この不純物や転位欠陥そのものが 原因となっている事が明らかとなった GaN 基板上では 平坦な 2 次元成長により GaN のエピ成長が行われるのに対して 転位密度の高いサファイア上では 結晶格子のズレが生じるために 2 次元成長が乱れ 不純物の取り込みが増加するためであると考えられる (25) (26) このように 低転位密度の GaN 基板を用いる事で 低キャリア濃度で制御された高純度エピ層が得られる事が明らかとなり 電子デバイス用途における GaN 基板使用のメリットの一つが明らかとなった 5-2 ショットキーバリヤダイオード GaN 基板を用いた電子デバイスとして 最初に 導電性の GaN 基板を用いた縦型構造であるショットキーバリヤダイオード (SBD) の研究を行った GaN 基板上に n + -GaN バッファ層を 2µm 成長した後にキャリア濃度 cm -3 の n - -GaN ドリフト層を 7µm 成長し ショットキー電極を形成した簡易な構造を作製した 比較のためにサファイアテンプレート上にも同様な成長を行い 比較検討した サファイア基板は裏面に電極が取れないために ショットキー電極横にオーミック電極を形成した 結果としては GaN 基板上の SBD は 耐圧 58V 特性オン抵抗 1.3mΩ cm 2 に対し サファイア上では 耐圧 163V 特性オン抵抗 14.4mΩcm 2 となり 耐圧 オン抵抗共に GaN 基板の明らかな優位性が示された この 1 桁のオン抵抗の相違は GaN 基板上のドリフト層の高純度化による移動度の増加とデバイス構造の差によるものと考えられる (25) (26) さらに GaN 基板上の SBD の特性向上のために ショットキー電極の耐圧構造の検討を行い 電極端部の電界集中を緩和するために 電極端部に SiNx 絶縁膜を挟んだフィールドプレート (FP) を形成した ( 図 11) この FP を有した SBD は GaN 基板の転位密度 cm -2 以下で n - -GaN ドリフト層厚さは 5µm Si 濃度は cm -3 であったが 評価の結果 降伏電圧 11V 以上 特性オン抵抗.71mΩcm 2 を示した また パワーデバイスと on Sapphire templetes on GaN substrates proportional Ni/Au 5µm n - -GaN SiN x n + -GaN Sub. 図 1 GaN エピ成長時の SiH4 供給量とエピ層実効キャリア濃度の関係 ( : サファイア基板上 : GaN 基板上 ) 図 11 Ti/Al/Ti/Au 試作したフィールドプレート構造を有した GaN 基板上 SBD 212 年 7 月 SEI テクニカルレビュー 第 181 号 ( 45 )
7 Ω Si Limit Florida Univ. 1 (Ref 12) GaN SBD (our reports) GaN SBD SiC SBD SiC Limit Our Results 1, 1, Mitsubishi 9 (Ref 13) GaN Limit 図 12 GaN 基板上の SBD における特性オン抵抗と降伏電圧の関係 : 過去の報告との比較を示す しての実用サイズの 1.1mm 角電極サイズでは 6A での順方向電圧 1.46V を示した (27) (29) これらは 図 12 に示したように他機関を含めた過去の GaN の SBD に関する報告の中でも最も優れたものであり 低欠陥の GaN 基板を用いる事の優位性を示すものと言える 5-3 縦型 pn 接合型ダイオードまた GaN 基板を用いて縦型の pn 接合型ダイオードの試作も行った GaN 基板上に.6µm 厚の n + -GaN バッファ層と 7µm の n - -GaN 層.5µm の p-gan 層 p + -GaN コンタクト層を形成し GaN 基板の裏面とp 型コンタクト層の表面にn 型電極とp 型電極をそれぞれ形成し pn 接合型ダイオードを作製した 比較のために 2.6µm の n + -GaN 層が形成されたサファイア基板の上にも同様な構造を形成し n 型電極は 表側からエッチングにより n 型層を露出した上に形成した p 型層の Mgドーピング量を最適化する事により GaN 基板上のダイオードで 逆方向の耐圧 925V 順方向の特性オン抵抗 6.3mΩcm 2 を得た サファイア上のダイオード での耐圧 588Vと比較しても大きな耐圧であり これは 低転位の効果であると考えられる ( 図 13) この際の絶縁破壊電界強度は 3.27MV/cmとなり 理論値である 3.3MV/cm と近い値であった これは 世界のトップデータであり GaN 基板の優位性を示すものであった (26) (3) 5-4 縦型トランジスタの開発さらに当社では低欠陥の導電性 GaN 基板を用いて 縦型トランジスタの研究開発も行った GaN 系の窒化物半導体には Si や SiC の様にイオン注入による n 型や p 型領域の形成が出来ないと言う欠点がある そのため エピ成長による n 型層 p 型層を組み込む必要があり デバイス設計に工夫が必要である 図 14 に示した構造の 2 次元電子ガス (2DEG) を用いた縦型トランジスタを提案し 試作を行った GaN 基板上に n - -GaN 層 p + -GaN 層 n + -GaN 層のエピ成長層を重ねた後 n - -GaN 層まで傾斜を付けてエッチングし その斜面に 2DEG を形成するための n 型 AlGaN/GaN ヘテロエピ層を成長した構造であり この斜面のエピ成長面にゲート電極を形成している チャネルにヘテロ接合部の 2DEG を用いているため高電子移動度による低オン抵抗が期待できる ソース電極は リセス構造を作って p + -GaN 層とオーミックコンタクトしている ゲートがオンの際には n + -GaN 層からヘテロエピ部の 2DEG を通って 縦方向にn - -GaN 層を経由してドレイン電極に到達する この縦型トランジスタの評価の結果 トランジスタ動作を確認し ドレイン電流とドレイン電圧の関係を図 15 に示した ゲート電圧 1V ドレイン電圧 2V の時のオン抵抗は 7.6mΩcm 2 であり この数値は GaN 系の縦型トランジスタの特性として世界のトップデータであった とはいうものの まだまだ設計上 低オン抵抗化の余地はあると言える また 耐圧に対しては ゲート電圧 -5V において ソース=ドレイン間の耐圧は 672V であった また 通常 GaN 系のパワーデバイスにおいては 電流コラプスという特性劣化の問題があるが 本開発のトランジスタにはこの現象は発生しな on GaN on sapphire 図 13 pn 接合ダイオードの I-V 特性の比較 (GaN 基板上およびサファイア基板上のダイオードの比較 ) 図 14 2 次元電子ガスを用いた縦型トランジスタ ( 46 ) 窒化物半導体の展開 結晶基板とデバイス
8 3 VGS = +1 to -3 V step -1 V mΩcm = 2V 写真 2 6 インチ径 GaN 基板と非極性面 半極性面 2 インチ GaN 基板 図 15 縦型トランジスタのドレイン電流 電圧特性 かった これは ゲート電極の直下から裏面のドレイン電極に向けて電流が流れる構造になっており 半導体表面に高電界が生じないためであると考えられる (31) (33) 一般にパワーデバイスに対しては 安全性の面からノーマリオフが要求されており さらに +3V 程度のしきい電圧が要求されている このトランジスタでは チャネル形成のためn 型 AlGaN/GaN ヘテロエピ層を用いているため 界面に生じる応力により ピエゾ電界が発生し 自然に 2DEG が形成され ノーマリオンとなってしまう しかし AlGaN 層の厚さを 35nm から 1nm へ薄くすることでピエゾ電界を軽減し しきい電圧を-3.2V から +.3Vへ変化させ ノーマリオフを実現した +3V のしきい電圧へ向けての改善は 今後の課題である また パワーデバイスについては 低コスト化が重要な問題であり GaN 基板コストの問題は 実用化までに解決が必要な課題である 6. 今後の展開へむけて GaN 基板の開発とそれを用いた光デバイスおよび電子デバイスに関する当社での研究開発について述べてきた 今後の発展を考えると さらにデバイス側の要求を先取りした基板開発を進めていく必要がある 基板開発においては 詳細はここでは述べないが 半導体技術研究所および半導体事業部においてさらなる展開に向けての対応を行っている 既に 21 年には 6 インチ径の窒化ガリウム基板の開発に成功し また同じく 21 年に 2 インチ径の半極性面 無極性面の窒化ガリウム基板の量産技術を確立している ( 写真 2) (34) (35) さらに 他社との協業により 1 枚の GaN 基板より複数の極薄の GaN 薄膜を転写して低コストの薄膜 GaN 基板の開発を行うことを公表している (36)(37) 品質 コストを含めて今後の窒化物系半導体デバイスの進展を見越して活動を行っている また 窒化ガリウム単結晶基板のみならず 窒化アルミニ 1mm 写真 3 AlN 単結晶成長ウム単結晶基板の開発にも 1 年来取り組んでいる (38) (43) 窒化アルミニウムは GaN と同じⅢ-Ⅴ 族の窒化物半導体であるが バンドギャップが 6.2eV と GaN の 3.4eVに比べても大きく GaN 系の次の基板材料として期待されるものである 結晶成長方法は 昇華法という 2 近い高温で AlN 原料を蒸発させて低温部に凝縮することで結晶成長する ( 写真 3) 既に半導体用基板としても使用しており 特に当社は NEDO 3 のプロジェクトに参画して 世界で初めて AlN 基板上に AlGaNチャネルの HEMTを作製し その優れた高温特性の実証に成功した (44) (46) 今後の窒化物半導体における新材料としての発展を期待したい 7. 結言当社における 1 数年にわたる GaN 系半導体基板及びそれを用いたデバイス等の研究開発の状況をレビューした この期間は 筆者にとっては非常に短かった様に感じるが この間に当社の窒化ガリウム系半導体に関する研究開発は相当に幅が広がったと言える また レーザ用窒化ガリウム基板 緑色レーザ 電子デバイス それぞれ完成度は様々ではあるが 研究としては 世界的に見ても相当の成果を収めてきたと思われる 窒化物半導体に取り組み始め 212 年 7 月 SEI テクニカルレビュー 第 181 号 ( 47 )
9 た時点では 当社は むしろ後発であったと思われる それでもここまで進めて来る事が出来た理由の一つは 当社が 基板結晶から研究開発に着手し その後 その基板応用としてエピ デバイスまで展開してきたと言う点がある 基板とデバイスとの間の相互作用の下に研究開発が進展してきた これは当社の化合物半導体研究の DNA とも言えよう このことは 当社の半導体基板事業の顧客にとってもメリットとなっているはずである しかしながら 研究開発はこれからであり まだまだ続く 我々は 窒化物半導体に対するさらなる貢献に向かって歩んでいく所存である 用語集ーーーーーーーーーーーーーーーーーーーーーーーーーーーー 1 Hydride Vapor Phase Epitaxy(HVPE) Ⅲ 族元素の塩化物 Ⅴ 族元素の水素化物を原料ガスに用いるエピ成長法の事であるが GaNの場合 高温で Gaと HCl を反応させて塩化物の GaCl ガスを合成し さらに水素化物の NH3 と反応させて GaN 膜を基板上に成長させる気相成長法を言う 大きな成長速度が得られやすい 2 OMVPE Organo-metallic Vapor Phase Epitaxy : 有機金属を原料ガスに用いる気相エピ成長法のこと Ⅲ-Ⅴ 族化合物半導体は 通常 Ⅲ 族元素は有機金属とし Ⅴ 族元素は 水素化物が用いられることが多い GaN の場合は トリメチルガリウムと NH3 との反応により GaN 薄膜の気相成長を行う 3 NEDO 独立行政法人新エネルギー 産業技術総合開発機構 参考文献 (1) 住友電工百年史 (1999) (2) K. Motoki, T. Okahisa, N. Matsumoto, M. Matsushima, H. Kimura, H. Kasai, K. Takemoto, K. Uematsu, T. Hirano, M. Nakayama, S. Nakahata, M. Ueno, D. Hara, Y. Kumagai, A. Koukitu and H. Seki, Preparation of Large Freestanding GaN Substrates by Hydride Vapor Phase Epitaxy Using GaAs as a Starting Substrate, Japanese Journal of Applied Physics 4, L14-143(21) (3) K. Motoki, T. Okahisa, S. Nakahata, N. Matsumoto, H. Kimura, H. Kasai, K. Takemoto, K. Uematsu, M. Ueno, Y. Kumagai, A. Koukitu and H. Seki, Preparation of Large GaN Substrates, Materials Science and Engineering B, B93, (22) (4) K. Motoki, T. Okahisa, S. Nakahata, N. Matsumoto, H. Kimura, H. Kasai, K. Takemoto, K. Uematsu, M. Ueno, Y. Kumagai, A. Koukitu and H. Seki, Growth and Characterization of Freestanding GaN Substrates, Journal of Crystal Growth , (22) (5) 中畑成二 岡久拓司 松本直樹 元木健作 上松康二 上野昌紀 笠井仁 木村浩也 竹本菊郎 大口径 GaN 単結晶基板の開発 SEI テクニカルレビュー第 161 号 76-79(22) (6) K. Motoki, T. Okahisa, S. Nakahata, K. Uematsu, H. Kasai, N. Matsumoto, Y. Kumagai, A. Koukitu and H. Seki, Preparation of 2- inch GaN substrates, Proc. 21st century COE Joint Workshop on Bulk Nitride, IPAP Conf. Series 4, 32-37(23) (7) 元木健作 Hydride Vapor Phase Epitaxy( HVPE) によるバルク結晶 白色 LED 照明システム技術の応用と将来展望 ( シーエムシー出版 )(23) (8) 元木健作 窒化ガリウム基板結晶 日本電子材料技術協会会報 Vol.37 p2-6(26 Oct.) (9) Kensaku Motoki, Takuji Okahisa, Ryu Hirota, Seiji Nakahata, Koji Uematsu and Naoki Matsumoto, Dislocation reduction in GaN crystal by advanced-deep, Journal of Crystal Growth 35, (27) (1) 元木健作 窒化ガリウム基板の開発 SEI テクニカルレビュー第 175 号 1-18(29) (11) 日本ファインセラミックス協会編 発光 照明材料 4.2 章 (21) (12)Motonobu Takeya, Takashi Mizuno, Tomomi Sasaki, Shinro Ikeda, Tsuyoshi Fujimoto, Yoshio Ohfuji, Kenji Oikawa, Yoshifumi Yabuki, Shiro Uchida and Masao Ikeda, Degradation in AlGaInN lasers, physica status solidi (c) Volume, Issue 7, pp (23) (13)O. Matsumoto, S. Goto, T. Sakai, Y. Yabuki, T. Tojyo, S. Tomiya, K. Naganuma, T. Asatsuma, K. Tamamura, S. Uchida, and M. Ikeda, Extremely Long Lifetime Blue-violet Laser Diode Grown Homoepitaxially on GaN Substrates, Extended Abstracts of the 22 International Conference on Solid State Devices and Materials, Nagoya, pp (22) (14)Katsushi Akita, Takao Nakamura and Hideki Hirayama, Advantages of GaN Substrates in InAlGaN Quaternary Ultraviolet- Light-Emitting Diodes, Japanese Journal of Applied Physics, Vol. 43, No. 12, pp (24) (15) 秋田勝史 京野孝史 上野昌紀 中村孝夫 平山秀樹 紫外 LED における GaN 基板の効果 SEI テクニカルレビュー第 165 号 1-6(24) (16)Katsushi Akita, Takashi Kyono, Yusuke Yoshizumi, Hiroyuki Kitabayashi and Koji Katayama, Improvements of external quantum efficiency of InGaN-based blue light-emitting diodes at high current density using GaN substrates, Journal of Applied Physics 11, 3314(27) (17) 秋田勝史 京野孝史 善積祐介 北林弘之 片山浩二 低転位 GaN 基板を用いた青色 LED の高効率化 SEI テクニカルレビュー第 171 号 4-45(27) (18)Yohei Enya, Yusuke Yoshizumi, Takashi Kyono, Katsushi Akita, Masaki Ueno, Masahiro Adachi,Takamichi Sumitomo, Shinji Tokuyama, Takatoshi Ikegami, Koji Katayama and Takao Nakamura, 531nm Green Lasing of InGaN Based Laser Diodes on Semi-Polar (2-21) Free-Standing GaN Substrates, Applied Physics Express 2, 8211(29) (19)Yusuke Yoshizumi, Masahiro Adachi, Yohei Enya, Takashi Kyono, Shinji Tokuyama, Takamichi Sumitomo, Katsushi Akita, Takatoshi Ikegami, Masaki Ueno, Koji Katayama and Takao Nakamura, Continuous-Wave Operation of 52nm Green InGaN-Based Laser Diodes on Semi-Polar (2-21) GaN Substrates, Applied Physics Express 2, 9211(29) (2) 京野孝史 塩谷陽平 秋田勝史 上野昌紀 足立真寛 住友隆道 徳山慎司 池上隆俊 片山浩二 中村孝夫 世界初の新規 GaN 基板上純緑色レーザ開発 Ⅰ SEI テクニカルレビュー第 176 号 88-92(21) (21) 足立真寛 京野孝史 塩谷陽平 秋田勝史 上野昌紀 住友隆道 徳山慎司 池上隆俊 片山浩二 中村孝夫 世界初の新規 GaN 基板上純緑色レーザ開発 Ⅱ SEI テクニカルレビュー第 176 号 93-96(21) ( 48 ) 窒化物半導体の展開 結晶基板とデバイス
10 (22)Takashi Kyono, Yusuke Yoshizumi, Yohei Enya, Masahiro Adachi, Shinji Tokuyama, Masaki Ueno, Koji Katayama and Takao Nakamura, Optical Polarization Characteristics of InGaN Quantum Wells for Green Laser Diodes on Semi-Polar {2-21} GaN Substrates, Applied Physics Express 3, 113(21) (23)Masahiro Adachi, Yusuke Yoshizumi, Yohei Enya, Takashi Kyono, Takamichi Sumitomo, Shinji Tokuyama, Shinpei Takagi, Kazuhide Sumiyoshi, Nobuhiro Saga, Takatoshi Ikegami, Masaki Ueno, Koji Katayama and Takao Nakamura, Low Threshold Current Density InGaN Based 52 53nm Green Laser Diodes on Semi-Polar {2-21} Free-Standing GaN Substrates, Applied Physics Express 3, 1211(21) (24)Masaki Ueno, Yusuke Yoshizumi, Yohei Enya, Takashi Kyono, Masahiro Adachi, Shinpei Takagi, Shinji Tokuyama, Takamichi Sumitomo, Kazuhide Sumiyoshi, Nobuhiro Saga, Takatoshi Ikegami, Koji Katayama and Takao Nakamura, InGaN-based true green laser diodes on novel semi-polar {2-21} GaN substrates, Journal of Crystal Growth, 315, (211) (25)S. Hashimoto, Y. Yoshizumi, T. Tanabe and M. Kiyama, High-purity GaN epitaxial layers for power devices on low-dislocation-density GaN substrates, Journal of Crystal Growth 298, (27) (26) 田辺達也 橋本信 善積祐介 木山誠 GaN 基板上 GaN エピタキシャル成長とパワーデバイスへの応用 SEI テクニカルレビュー第 17 号 34-39(27) (27)Taku Horii, Tomihito Miyazaki, Yu Saitoh, Shin Hashimoto, Tatsuya Tanabe and Makoto Kiyama, High-Breakdown-Voltage GaN Vertical Schottky Barrier Diodes with Field Plate Structure, Materials Science Forum Vols , pp (29) (28) 堀井拓 宮崎富仁 斎藤雄 橋本信 田辺達也 木山誠 GaN 基板上縦型 SBD の FP 構造による高耐圧化 SEI テクニカルレビュー第 174 号 77-8(29) (29)Yu Saitoh, Kazuhide Sumiyoshi, Masaya Okada, Taku Horii, Tomihito Miyazaki, Hiromu Shiomi, Masaki Ueno, Koji Katayama, Makoto Kiyama and Takao Nakamura, Extremely Low On- Resistance and High Breakdown Voltage Observed in Vertical GaN Schottky Barrier Diodes with High-Mobility Drift Layers on Low- Dislocation-Density GaN Substrates, Applied Physics Express 3, 811(21) (3)Yusuke Yoshizumi, Shin Hashimoto, Tatsuya Tanabe and Makoto Kiyama, High-breakdown-voltage pn-junction diodes on GaN substrates, Journal of Crystal Growth 298, (27) (31)Masaya Okada, Yu Saitoh, Mitsunori Yokoyama, Ken Nakata, Seiji Yaegassi, Koji Katayama, Masaki Ueno, Makoto Kiyama, Tsukuru Katsuyama and Takao Nakamura, Novel Vertical Heterojunction Field-Effect Transistors with Re-grown AlGaN/GaN Two- Dimensional Electron Gas Channels on GaN Substrates, Applied Physics Express 3, 5421(21) (32)Seiji Yaegashi, Masaya Okada, Yuu Saitou, Mitsunori Yokoyama, Ken Nakata, Koji Katayama, Masaki Ueno, Makoto Kiyama, Tsukuru Katsuyama and Takao Nakamura, Vertical heterojunction fieldeffect transistors utilizing re-grown AlGaN/GaN two-dimensional electron gas channels on GaN substrates, Phys. Status Solidi C 8, No. 2, (211) (33) 岡田政也 斎藤雄 横山満徳 中田健 八重樫誠司 片山浩二 上野昌紀 木山誠 勝山造 中村孝夫 低転位 GaN 基板上縦型トランジスタの開発 SEI テクニカルレビュー第 178 号 84-88(211) (34) 住友電気工業 プレスリリース (21 年 11 月 16 日付 ) (35) 住友電気工業 プレスリリース (21 年 11 月 24 日付 ) (36) 住友電気工業 プレスリリース (21 年 12 月 1 日付 ) (37) 住友電気工業 プレスリリース (212 年 1 月 24 日付 ) (38)M. Tanaka, S. Nakahata, K. Sogabe, H. Nakahata and M. Tobioka, Morphology and X-ray diffraction peak widths of Aluminium Nitride single crystals prepared by the sublimation method, Jpn. J. Appl. Phys., Vol.36, L1621(1997) (39) 宮永倫正 水原奈保 藤原伸介 嶋津充 中幡英章 昇華法による AlN 単結晶成長 SEIテクニカルレビュー第 168 号 (26) (4)Michimasa Miyanaga, Naho Mizuhara, Shinsuke Fujiwara, Mitsuru Shimazu, Hideaki Nakahata and Tomohiro Kawase, Evaluation of AlN single-crystal grown by sublimation method, Volume 3, Issue 1, pp (1 March 27) (41)N. Mizuhara, M. Miyanaga, S. Fujiwara, H. Nakahata and T. Kawase, Growth of high-quality 1-inch diameter AlN single crystal by sublimation method, physica status solidi (c), Volume 4, Issue 7, pp (27) (42)Issei Satoh, Satoshi Arakawa, Keisuke Tanizaki, Michimasa Miyanaga and Yoshiyuki Yamamoto, Sublimation growth of nonpolar AlN single crystals and defect characterization, physica status solidi (c), Volume 7, Issue 7-8, pp (21) (43) 佐藤一成 荒川聡 谷崎圭祐 宮永倫正 櫻田隆 山本喜之 中幡英章 窒化アルミニウム単結晶基板の開発 SEIテクニカルレビュー第 177 号 87-91(21) (44) 橋本信 秋田勝史 田辺達也 中幡英章 竹田健一郎 天野浩 AlN 基板を用いた AlGaN チャネル HEMT エピの開発 SEI テクニカルレビュー第 177 号 92-96(21) (45)S. Hashimoto, K. Akita, T. Tanabe, H. Nakahata, K. Takeda and H. Amano, Study of two-dimensional electron gas in AlGaN channel HEMTs with high crystalline quality, Phys. Stat. Sol. (c) 7, 1938 (21) (46) 秋田勝史 橋本信 山本喜之 矢船憲成 徳田博邦 葛原正明 岩谷素顕 天野浩 AlN 基板を用いた高 Al 組成 AlGaN HEMT の開発 SEI テクニカルレビュー第 18 号 83-88(212) 執筆者 元木健作 : シニアスペシャリスト半導体技術研究所コア技術研究部部長博士 ( 工学 ) 窒化物半導体を含む化合物半導体関連の研究開発に従事 年 7 月 SEI テクニカルレビュー 第 181 号 ( 49 )
窒化ガリウム基板の開発
 特別論文 窒化ガリウム基板の開発 元木健作 Development of GaN Substrates by Kensaku Motoki To commercialize violet lasers, the mass production of high quality gallium nitride (GaN) single crystal substrates is the key. Sumitomo
特別論文 窒化ガリウム基板の開発 元木健作 Development of GaN Substrates by Kensaku Motoki To commercialize violet lasers, the mass production of high quality gallium nitride (GaN) single crystal substrates is the key. Sumitomo
低転位GaN 基板上縦型トランジスタの開発
 エレクトロニクス 低転位 GaN 基板上縦型トランジスタの開発 岡 田 政 也 * 斎 藤 雄 横 山 満 徳 中 田 健 八重樫 誠 司 片 山 浩 二 上 野 昌 紀 木 山 誠 勝 山 造 中 村 孝 夫 Development of Vertical Heterojunction Field-Effect Transistors on Low Dislocation Density GaN
エレクトロニクス 低転位 GaN 基板上縦型トランジスタの開発 岡 田 政 也 * 斎 藤 雄 横 山 満 徳 中 田 健 八重樫 誠 司 片 山 浩 二 上 野 昌 紀 木 山 誠 勝 山 造 中 村 孝 夫 Development of Vertical Heterojunction Field-Effect Transistors on Low Dislocation Density GaN
Microsoft Word - プレリリース参考資料_ver8青柳(最終版)
 別紙 : 参考資料 従来の深紫外 LED に比べ 1/5 以下の低コストでの製造を可能に 新縦型深紫外 LED Ref-V DUV LED の開発に成功 立命館大学総合科学技術研究機構の黒瀬範子研究員並びに青柳克信上席研究員は従来 の 1/5 以下のコストで製造を可能にする新しいタイプの縦型深紫外 LED(Ref-V DUV LED) の開発に成功した 1. コスト1/5 以下の深紫外 LED 1)
別紙 : 参考資料 従来の深紫外 LED に比べ 1/5 以下の低コストでの製造を可能に 新縦型深紫外 LED Ref-V DUV LED の開発に成功 立命館大学総合科学技術研究機構の黒瀬範子研究員並びに青柳克信上席研究員は従来 の 1/5 以下のコストで製造を可能にする新しいタイプの縦型深紫外 LED(Ref-V DUV LED) の開発に成功した 1. コスト1/5 以下の深紫外 LED 1)
低転位GaN 基板上の低抵抗・高耐圧GaNダイオード
 エレクトロニクス 低転位 G a N 基板上の低抵抗 高耐圧 G a N ダイオード 住 吉 和 英 * 岡 田 政 也 上 野 昌 紀 木 山 誠 中 村 孝 夫 Low On-Resistance and High Breakdown Voltage GaN SBD on Low Dislocation Density GaN Substrates by Kazuhide Sumiyoshi,
エレクトロニクス 低転位 G a N 基板上の低抵抗 高耐圧 G a N ダイオード 住 吉 和 英 * 岡 田 政 也 上 野 昌 紀 木 山 誠 中 村 孝 夫 Low On-Resistance and High Breakdown Voltage GaN SBD on Low Dislocation Density GaN Substrates by Kazuhide Sumiyoshi,
AlN 基板を用いた高Al 組成AlGaN HEMTの開発
 エレクトロニクス Drain Current I D [ma] 9 8 7 6 5 4 3 2 2 4 6 8 12 14 1618 2 Drain Voltage V DS [V] A l N 基板を用いた高 A l 組成 A l G a N H E M T の開発 秋 田 勝 史 * 橋 本 信 山 本 喜 之 矢 船 憲 成 徳 田 博 邦 葛 原 正 明 岩 谷 素 顕 天 野 浩 Development
エレクトロニクス Drain Current I D [ma] 9 8 7 6 5 4 3 2 2 4 6 8 12 14 1618 2 Drain Voltage V DS [V] A l N 基板を用いた高 A l 組成 A l G a N H E M T の開発 秋 田 勝 史 * 橋 本 信 山 本 喜 之 矢 船 憲 成 徳 田 博 邦 葛 原 正 明 岩 谷 素 顕 天 野 浩 Development
高出力・高効率純緑色レーザ
 エレクトロニクス 高出力 高効率純緑色レーザ 髙 木 慎 平 * 上 野 昌 紀 片 山 浩 二 池 上 隆 俊 中 村 孝 夫 簗 嶋 克 典 High-Power and High-Efficiency True Green Laser Diodes by Shimpei Takagi, Masaki Ueno, Koji Katayama, Takatoshi Ikegami, Takao Nakamura
エレクトロニクス 高出力 高効率純緑色レーザ 髙 木 慎 平 * 上 野 昌 紀 片 山 浩 二 池 上 隆 俊 中 村 孝 夫 簗 嶋 克 典 High-Power and High-Efficiency True Green Laser Diodes by Shimpei Takagi, Masaki Ueno, Koji Katayama, Takatoshi Ikegami, Takao Nakamura
PowerPoint プレゼンテーション
 加工 Si 基板上への 非極性 GaN 結晶成長 1) 名古屋大学工学研究科 赤崎記念研究センター 2) 愛知工業大学工学研究科 1) 本田善央 1) 谷川智之 1) 鈴木希幸 1) 山口雅史 2) 澤木宣彦 豊田講堂時計台 赤崎研究センター auditorium Akasaki research center 常圧 MOVPE 減圧 MOVPE (2inch) HVPE MOVPE #3 MOVPE
加工 Si 基板上への 非極性 GaN 結晶成長 1) 名古屋大学工学研究科 赤崎記念研究センター 2) 愛知工業大学工学研究科 1) 本田善央 1) 谷川智之 1) 鈴木希幸 1) 山口雅史 2) 澤木宣彦 豊田講堂時計台 赤崎研究センター auditorium Akasaki research center 常圧 MOVPE 減圧 MOVPE (2inch) HVPE MOVPE #3 MOVPE
第 1 回窒化物半導体応用研究会平成 20 年 2 月 8 日 講演内容 1. 弊社の概要紹介 2. 弊社における窒化物半導体事業への展開 3. 知的クラスター創生事業での取り組み Si 基板上 HEMT 用 GaN 系エピ結晶結晶成長成長技術技術開発
 第 1 回窒化物半導体応用研究会 平成 20 年 2 月 8 日 GaN 結晶成長技術の開発 半導体事業部 伊藤統夫 第 1 回窒化物半導体応用研究会平成 20 年 2 月 8 日 講演内容 1. 弊社の概要紹介 2. 弊社における窒化物半導体事業への展開 3. 知的クラスター創生事業での取り組み Si 基板上 HEMT 用 GaN 系エピ結晶結晶成長成長技術技術開発 弊社社名変更について 2006
第 1 回窒化物半導体応用研究会 平成 20 年 2 月 8 日 GaN 結晶成長技術の開発 半導体事業部 伊藤統夫 第 1 回窒化物半導体応用研究会平成 20 年 2 月 8 日 講演内容 1. 弊社の概要紹介 2. 弊社における窒化物半導体事業への展開 3. 知的クラスター創生事業での取り組み Si 基板上 HEMT 用 GaN 系エピ結晶結晶成長成長技術技術開発 弊社社名変更について 2006
GaNの特長とパワーデバイス応用に向けての課題 GaNパワーデバイスの低コスト化技術 大面積 Si 上 MOCVD 結晶成長技術 Si 上大電流 AlGaN/GaNパワー HFET GaN パワーデバイスのノーマリオフ動作 伝導度変調を用いたAlGaN/GaNトランジスタ - Gate Inject
 高耐圧 GaN パワーデバイス開発 松下電器産業 ( 株 ) 半導体社半導体デバイス研究センター 上田哲三 GaNの特長とパワーデバイス応用に向けての課題 GaNパワーデバイスの低コスト化技術 大面積 Si 上 MOCVD 結晶成長技術 Si 上大電流 AlGaN/GaNパワー HFET GaN パワーデバイスのノーマリオフ動作 伝導度変調を用いたAlGaN/GaNトランジスタ - Gate Injection
高耐圧 GaN パワーデバイス開発 松下電器産業 ( 株 ) 半導体社半導体デバイス研究センター 上田哲三 GaNの特長とパワーデバイス応用に向けての課題 GaNパワーデバイスの低コスト化技術 大面積 Si 上 MOCVD 結晶成長技術 Si 上大電流 AlGaN/GaNパワー HFET GaN パワーデバイスのノーマリオフ動作 伝導度変調を用いたAlGaN/GaNトランジスタ - Gate Injection
Microsoft PowerPoint - H30パワエレ-3回.pptx
 パワーエレクトロニクス 第三回パワー半導体デバイス 平成 30 年 4 月 25 日 授業の予定 シラバスより パワーエレクトロニクス緒論 パワーエレクトロニクスにおける基礎理論 パワー半導体デバイス (2 回 ) 整流回路 (2 回 ) 整流回路の交流側特性と他励式インバータ 交流電力制御とサイクロコンバータ 直流チョッパ DC-DC コンバータと共振形コンバータ 自励式インバータ (2 回 )
パワーエレクトロニクス 第三回パワー半導体デバイス 平成 30 年 4 月 25 日 授業の予定 シラバスより パワーエレクトロニクス緒論 パワーエレクトロニクスにおける基礎理論 パワー半導体デバイス (2 回 ) 整流回路 (2 回 ) 整流回路の交流側特性と他励式インバータ 交流電力制御とサイクロコンバータ 直流チョッパ DC-DC コンバータと共振形コンバータ 自励式インバータ (2 回 )
PowerPoint プレゼンテーション
 半極性バルク GaN 基板上への LED の開発 実用レベルの発光効率と面内偏光の実現 船戸充講師, 川上養一助教授, 上田雅也 (D1) 京都大学 工学研究科 電子工学専攻 成川幸男, 小杉卓生, 高橋正良, 向井孝志日亜化学工業株式会社 謝辞 : 京都ナノテク事業創造クラスター 背 景 III 族窒化物半導体 :AlN,GaN,InN 紫外域 (AlN) から可視域 (GaN) を通って赤外域
半極性バルク GaN 基板上への LED の開発 実用レベルの発光効率と面内偏光の実現 船戸充講師, 川上養一助教授, 上田雅也 (D1) 京都大学 工学研究科 電子工学専攻 成川幸男, 小杉卓生, 高橋正良, 向井孝志日亜化学工業株式会社 謝辞 : 京都ナノテク事業創造クラスター 背 景 III 族窒化物半導体 :AlN,GaN,InN 紫外域 (AlN) から可視域 (GaN) を通って赤外域
AlGaN/GaN HFETにおける 仮想ゲート型電流コラプスのSPICE回路モデル
 AlGaN/GaN HFET 電流コラプスおよびサイドゲート効果に関する研究 徳島大学大学院先端技術科学教育部システム創生工学専攻電気電子創生工学コース大野 敖研究室木尾勇介 1 AlGaN/GaN HFET 研究背景 高絶縁破壊電界 高周波 高出力デバイス 基地局などで実用化 通信機器の発達 スマートフォン タブレットなど LTE LTE エンベロープトラッキング 低消費電力化 電源電圧を信号に応じて変更
AlGaN/GaN HFET 電流コラプスおよびサイドゲート効果に関する研究 徳島大学大学院先端技術科学教育部システム創生工学専攻電気電子創生工学コース大野 敖研究室木尾勇介 1 AlGaN/GaN HFET 研究背景 高絶縁破壊電界 高周波 高出力デバイス 基地局などで実用化 通信機器の発達 スマートフォン タブレットなど LTE LTE エンベロープトラッキング 低消費電力化 電源電圧を信号に応じて変更
PowerPoint プレゼンテーション
 第 12 回窒化物半導体応用研究会 2011 年 11 月 10 日 ノーマリオフ型 HFET の高性能化 前田就彦 日本電信電話株式会社 NTT フォトニクス研究所 243-0198 神奈川県厚木市森の里若宮 3-1 E-mail: [email protected] 内容 (1) 電力応用におけるノーマリオフ型デバイス (2) / HFETにおけるノーマリオフ化 - デバイス構造のこれまでの展開
第 12 回窒化物半導体応用研究会 2011 年 11 月 10 日 ノーマリオフ型 HFET の高性能化 前田就彦 日本電信電話株式会社 NTT フォトニクス研究所 243-0198 神奈川県厚木市森の里若宮 3-1 E-mail: [email protected] 内容 (1) 電力応用におけるノーマリオフ型デバイス (2) / HFETにおけるノーマリオフ化 - デバイス構造のこれまでの展開
Microsoft PowerPoint - 9.菅谷.pptx
 超多積層量子ドット太陽電池と トンネル効果 菅谷武芳 革新デバイスチーム 量子ドット太陽電池 電子 バンド3:伝導帯 E23 E13 E12 正孔 バンド2:中間バンド 量子ドット超格子 ミニバンド 量子ドットの井戸型 ポテンシャル バンド1:価電子帯 量子ドット太陽電池のバンド図 量子ドット超格子太陽電池 理論上 変換効率60%以上 集光 A. Luque et al., Phys. Rev. Lett.
超多積層量子ドット太陽電池と トンネル効果 菅谷武芳 革新デバイスチーム 量子ドット太陽電池 電子 バンド3:伝導帯 E23 E13 E12 正孔 バンド2:中間バンド 量子ドット超格子 ミニバンド 量子ドットの井戸型 ポテンシャル バンド1:価電子帯 量子ドット太陽電池のバンド図 量子ドット超格子太陽電池 理論上 変換効率60%以上 集光 A. Luque et al., Phys. Rev. Lett.
高耐圧SiC MOSFET
 エレクトロニクス 高耐圧 S i C M O S F E T 木村錬 * 内田光亮 日吉透酒井光彦 和田圭司 御神村泰樹 SiC High Blocking Voltage Transistor by Ren Kimura, Kousuke Uchida, Toru Hiyoshi, Mitsuhiko Sakai, Keiji Wada and Yasuki Mikamura Recently,
エレクトロニクス 高耐圧 S i C M O S F E T 木村錬 * 内田光亮 日吉透酒井光彦 和田圭司 御神村泰樹 SiC High Blocking Voltage Transistor by Ren Kimura, Kousuke Uchida, Toru Hiyoshi, Mitsuhiko Sakai, Keiji Wada and Yasuki Mikamura Recently,
untitled
 213 74 AlGaN/GaN Influence of metal material on capacitance for Schottky-gated AlGaN/GaN 1, 2, 1, 2, 2, 2, 2, 2, 2, 2, 1, 1 1 AlGaN/GaN デバイス ① GaNの優れた物性値 ② AlGaN/GaN HEMT構造 ワイドバンドギャップ半導体 (3.4eV) 絶縁破壊電界が大きい
213 74 AlGaN/GaN Influence of metal material on capacitance for Schottky-gated AlGaN/GaN 1, 2, 1, 2, 2, 2, 2, 2, 2, 2, 1, 1 1 AlGaN/GaN デバイス ① GaNの優れた物性値 ② AlGaN/GaN HEMT構造 ワイドバンドギャップ半導体 (3.4eV) 絶縁破壊電界が大きい
この講義のねらい ナノ 量子効果デバイス 前澤宏一 本講義は 超高速 超高周波デバイスの基盤となる化合物半導体 へテロ接合とそれを用いたデバイスに関して学ぶ 特に高電子移動度トランジスタ (HEMT) やヘテロバイポーラトランジスタ (HBT) などの超高速素子や これらを基礎とした将来デバイスであ
 この講義のねらい ナノ 量子効果デバイス 前澤宏一 本講義は 超高速 超高周波デバイスの基盤となる化合物半導体 へテロ接合とそれを用いたデバイスに関して学ぶ 特に高電子移動度トランジスタ (HEMT) やヘテロバイポーラトランジスタ (HBT) などの超高速素子や これらを基礎とした将来デバイスである 量子効果 ナノデバイスとその応用について学ぶ 2 年 量子力学 1,2 電子物性工学 1 半導体デバイス
この講義のねらい ナノ 量子効果デバイス 前澤宏一 本講義は 超高速 超高周波デバイスの基盤となる化合物半導体 へテロ接合とそれを用いたデバイスに関して学ぶ 特に高電子移動度トランジスタ (HEMT) やヘテロバイポーラトランジスタ (HBT) などの超高速素子や これらを基礎とした将来デバイスである 量子効果 ナノデバイスとその応用について学ぶ 2 年 量子力学 1,2 電子物性工学 1 半導体デバイス
窒化アルミニウムによる 高効率フィールドエミッションを実現 ディスプレイパネル実用レベルのフィールドエミッション特性
 Copyright NTT Basic Research Laboratories, NTT Corporation. All rights reserved. ダイヤモンド 高周波電力デバイスの開発とマイクロ波 ミリ波帯電力増幅器への応用 (614314) 研究代表者嘉数誠 (1) NTT 物性科学基礎研究所 研究分担者植田研二 (2) 小林康之 中川匡夫 NTT 物性科学基礎研究所 NTT 未来ねっと研究所
Copyright NTT Basic Research Laboratories, NTT Corporation. All rights reserved. ダイヤモンド 高周波電力デバイスの開発とマイクロ波 ミリ波帯電力増幅器への応用 (614314) 研究代表者嘉数誠 (1) NTT 物性科学基礎研究所 研究分担者植田研二 (2) 小林康之 中川匡夫 NTT 物性科学基礎研究所 NTT 未来ねっと研究所
Microsoft PowerPoint - 14.菅谷修正.pptx
 InGaAs/系量子ドット太陽電池の作製 革新デバイスチーム 菅谷武芳 電子 バンド3:伝導帯 E3 E3 E 正孔 バンド:中間バンド 量子ドット超格子 ミニバンド 量子ドットの井戸型 ポテンシャル バンド:価電子帯 量子ドット太陽電池のバンド図 6%を超える理想的な量子ドット太陽 電池実現には E3として1 9eVが必要 量子ドット超格子太陽電池 理論上 変換効率6%以上 集光 を採用 MBE
InGaAs/系量子ドット太陽電池の作製 革新デバイスチーム 菅谷武芳 電子 バンド3:伝導帯 E3 E3 E 正孔 バンド:中間バンド 量子ドット超格子 ミニバンド 量子ドットの井戸型 ポテンシャル バンド:価電子帯 量子ドット太陽電池のバンド図 6%を超える理想的な量子ドット太陽 電池実現には E3として1 9eVが必要 量子ドット超格子太陽電池 理論上 変換効率6%以上 集光 を採用 MBE
Figure 1. Center and Edge comparison of a HEMT epi measured by PCOR-SIMS SM 図 1 は直径 150mm の Si ウェハ上に成長させた GaN HEMT 構造全体の PCOR-SIMS による深さプ ロファイルを示しています
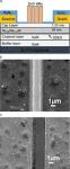 PCOR-SIMS による Si 基板上 GaN HEMT エピ構造の解析 Temel H. Buyuklimanli ([email protected]), Charles W. Magee, Ozgur Celik, Wei Ou, Andrew Klump, Wei Zhao, Yun Qi and Jeffrey Serfass 810 Kifer Road, Sunnyvale, CA 94086
PCOR-SIMS による Si 基板上 GaN HEMT エピ構造の解析 Temel H. Buyuklimanli ([email protected]), Charles W. Magee, Ozgur Celik, Wei Ou, Andrew Klump, Wei Zhao, Yun Qi and Jeffrey Serfass 810 Kifer Road, Sunnyvale, CA 94086
Microsoft PowerPoint - semi_ppt07.ppt [互換モード]
![Microsoft PowerPoint - semi_ppt07.ppt [互換モード] Microsoft PowerPoint - semi_ppt07.ppt [互換モード]](/thumbs/94/122068205.jpg) 1 MOSFETの動作原理 しきい電圧 (V TH ) と制御 E 型とD 型 0 次近似によるドレイン電流解析 2 電子のエネルギーバンド図での考察 理想 MOS 構造の仮定 : シリコンと金属の仕事関数が等しい 界面を含む酸化膜中に余分な電荷がない 金属 (M) 酸化膜 (O) シリコン (S) 電子エ金属 酸化膜 シリコン (M) (O) (S) フラットバンド ネルギー熱平衡で 伝導帯 E
1 MOSFETの動作原理 しきい電圧 (V TH ) と制御 E 型とD 型 0 次近似によるドレイン電流解析 2 電子のエネルギーバンド図での考察 理想 MOS 構造の仮定 : シリコンと金属の仕事関数が等しい 界面を含む酸化膜中に余分な電荷がない 金属 (M) 酸化膜 (O) シリコン (S) 電子エ金属 酸化膜 シリコン (M) (O) (S) フラットバンド ネルギー熱平衡で 伝導帯 E
Microsoft PowerPoint - semi_ppt07.ppt
 半導体工学第 9 回目 / OKM 1 MOSFET の動作原理 しきい電圧 (V( TH) と制御 E 型と D 型 0 次近似によるドレイン電流解析 半導体工学第 9 回目 / OKM 2 電子のエネルギーバンド図での考察 金属 (M) 酸化膜 (O) シリコン (S) 熱平衡でフラットバンド 伝導帯 E c 電子エネルギ シリコンと金属の仕事関数が等しい 界面を含む酸化膜中に余分な電荷がない
半導体工学第 9 回目 / OKM 1 MOSFET の動作原理 しきい電圧 (V( TH) と制御 E 型と D 型 0 次近似によるドレイン電流解析 半導体工学第 9 回目 / OKM 2 電子のエネルギーバンド図での考察 金属 (M) 酸化膜 (O) シリコン (S) 熱平衡でフラットバンド 伝導帯 E c 電子エネルギ シリコンと金属の仕事関数が等しい 界面を含む酸化膜中に余分な電荷がない
低炭素社会の実現に向けた技術および経済 社会の定量的シナリオに基づくイノベーション政策立案のための提案書 技術開発編 GaN 系半導体デバイスの技術開発課題とその新しい応用の展望 平成 29 年 3 月 Technological Issues and Future Prospects of GaN
 低炭素社会の実現に向けた技術および経済 社会の定量的シナリオに基づくイノベーション政策立案のための提案書 技術開発編 GaN 系半導体デバイスの技術開発課題とその新しい応用の展望 平成 29 年 3 月 Technological Issues and Future Prospects of GaN and Related Semiconductor Devices Strategy for Technology
低炭素社会の実現に向けた技術および経済 社会の定量的シナリオに基づくイノベーション政策立案のための提案書 技術開発編 GaN 系半導体デバイスの技術開発課題とその新しい応用の展望 平成 29 年 3 月 Technological Issues and Future Prospects of GaN and Related Semiconductor Devices Strategy for Technology
SiC 高チャネル移動度トランジスタ
 エレクトロニクス SiC 高チャネル移動度トランジスタ 日吉透 * 増田健良 和田圭司 原田真 築野孝 並川靖生 SiC MOSFET with High Channel Mobility by Toru Hiyoshi, Takeyoshi Masuda, Keiji Wada, Shin Harada, Takashi Tsuno and Yasuo Namikawa SiC (silicon
エレクトロニクス SiC 高チャネル移動度トランジスタ 日吉透 * 増田健良 和田圭司 原田真 築野孝 並川靖生 SiC MOSFET with High Channel Mobility by Toru Hiyoshi, Takeyoshi Masuda, Keiji Wada, Shin Harada, Takashi Tsuno and Yasuo Namikawa SiC (silicon
1-2 原子層制御量子ナノ構造のコヒーレント量子効果 Coherent Quantum Effects in Quantum Nano-structure with Atomic Layer Precision Mutsuo Ogura, Research Director of CREST Pho
 1-2 原子層制御量子ナノ構造のコヒーレント量子効果 Coherent Quantum Effects in Quantum Nano-structure with Atomic Layer Precision Mutsuo Ogura, Research Director of CREST Photonics Research Institute, AIST TBAs) AlGaAs/GaAs TBAs)
1-2 原子層制御量子ナノ構造のコヒーレント量子効果 Coherent Quantum Effects in Quantum Nano-structure with Atomic Layer Precision Mutsuo Ogura, Research Director of CREST Photonics Research Institute, AIST TBAs) AlGaAs/GaAs TBAs)
 特別賞 酸化ガリウムパワーデバイスの研究開発 1 独立行政法人情報通信研究機構 2 株式会社タムラ製作所 3 株式会社光波 1 2,1 東脇正高佐々木公平倉又朗人 3 2 増井建和山腰茂伸 2 1. 諸言 近年 温室効果ガス削減 化石燃料に替わる新エネルギーの創出などの革新的省エネルギー技術の開発が 将来に向けた地球規模の命題となっている 加えて 現在我が国では東日本大震災の影響もあり 電力需要を減らす努力がこれまで以上に強く求められている
特別賞 酸化ガリウムパワーデバイスの研究開発 1 独立行政法人情報通信研究機構 2 株式会社タムラ製作所 3 株式会社光波 1 2,1 東脇正高佐々木公平倉又朗人 3 2 増井建和山腰茂伸 2 1. 諸言 近年 温室効果ガス削減 化石燃料に替わる新エネルギーの創出などの革新的省エネルギー技術の開発が 将来に向けた地球規模の命題となっている 加えて 現在我が国では東日本大震災の影響もあり 電力需要を減らす努力がこれまで以上に強く求められている
Microsystem Integration & Packaging Laboratory
 2015/01/26 MemsONE 技術交流会 解析事例紹介 東京大学実装工学分野研究室奥村拳 Microsystem Integration and Packaging Laboratory 1 事例紹介 1. 解析の背景高出力半導体レーザの高放熱構造 2. 熱伝導解析解析モデルの概要 3. チップサイズの熱抵抗への影響 4. 接合材料の熱抵抗への影響 5. ヒートシンク材料の熱抵抗への影響 Microsystem
2015/01/26 MemsONE 技術交流会 解析事例紹介 東京大学実装工学分野研究室奥村拳 Microsystem Integration and Packaging Laboratory 1 事例紹介 1. 解析の背景高出力半導体レーザの高放熱構造 2. 熱伝導解析解析モデルの概要 3. チップサイズの熱抵抗への影響 4. 接合材料の熱抵抗への影響 5. ヒートシンク材料の熱抵抗への影響 Microsystem
Microsoft PowerPoint - 第11回半導体工学
 207 年 2 月 8 日 ( 月 ) 限 8:45~0:5 I05 第 回半導体工学天野浩項目 8 章半導体の光学的性質 /24 光る半導体 ( 直接遷移型 ) と光らない半導体 ( 間接遷移型 ) * 原理的に良く光る半導体 :GaAs GaN IP ZSe など * 原理的に殆ど光らない半導体 ( 不純物を入れると少し光る ):Si Ge GaP SiCなど結晶構造とバンド構造 E E 伝導帯
207 年 2 月 8 日 ( 月 ) 限 8:45~0:5 I05 第 回半導体工学天野浩項目 8 章半導体の光学的性質 /24 光る半導体 ( 直接遷移型 ) と光らない半導体 ( 間接遷移型 ) * 原理的に良く光る半導体 :GaAs GaN IP ZSe など * 原理的に殆ど光らない半導体 ( 不純物を入れると少し光る ):Si Ge GaP SiCなど結晶構造とバンド構造 E E 伝導帯
Microsoft PowerPoint - アナログ電子回路3回目.pptx
 アナログ電 回路 3-1 電気回路で考える素 ( 能動素 ) 抵抗 コイル コンデンサ v v v 3-2 理 学部 材料機能 学科岩 素顕 [email protected] トランジスタ トランジスタとは? トランジスタの基本的な動作は? バイポーラトランジスタ JFET MOFET ( エンハンスメント型 デプレッション型 ) i R i L i C v Ri di v L dt i C
アナログ電 回路 3-1 電気回路で考える素 ( 能動素 ) 抵抗 コイル コンデンサ v v v 3-2 理 学部 材料機能 学科岩 素顕 [email protected] トランジスタ トランジスタとは? トランジスタの基本的な動作は? バイポーラトランジスタ JFET MOFET ( エンハンスメント型 デプレッション型 ) i R i L i C v Ri di v L dt i C
Microsoft PowerPoint - 集積デバイス工学5.ppt
 MO プロセスフロー ( 復習 集積デバイス工学 ( の構成要素 ( 抵抗と容量 素子分離 -well 形成 ゲート形成 拡散領域形成 絶縁膜とコンタクト形成 l 配線形成 6 7 センター藤野毅 MO 領域 MO 領域 MO プロセスフロー ( 復習 素子分離 -well 形成 ゲート形成 拡散領域形成 絶縁膜とコンタクト形成 l 配線形成 i 膜 ウエルポリシリコン + 拡散 + 拡散コンタクト
MO プロセスフロー ( 復習 集積デバイス工学 ( の構成要素 ( 抵抗と容量 素子分離 -well 形成 ゲート形成 拡散領域形成 絶縁膜とコンタクト形成 l 配線形成 6 7 センター藤野毅 MO 領域 MO 領域 MO プロセスフロー ( 復習 素子分離 -well 形成 ゲート形成 拡散領域形成 絶縁膜とコンタクト形成 l 配線形成 i 膜 ウエルポリシリコン + 拡散 + 拡散コンタクト
<4D F736F F F696E74202D208FE393635F928289BB95A894BC93B191CC8CA48B8689EF5F47614E F815B835E5F88F38DFC97702E707074>
 21 年 6 月 24 日第 8 回窒化物半導体応用研究会 GaN 系電子デバイスの現状とその可能性 GaN パワーデバイスのインバータ応用 パナソニック株式会社 セミコンダクター社半導体デバイス研究センター 上田哲三 講演内容 GaNインバータによる省エネルギー化 GaNパワーデバイス技術 低コストSi 基板上 GaN 結晶成長 ノーマリオフ化 : Gate Injection Transistor
21 年 6 月 24 日第 8 回窒化物半導体応用研究会 GaN 系電子デバイスの現状とその可能性 GaN パワーデバイスのインバータ応用 パナソニック株式会社 セミコンダクター社半導体デバイス研究センター 上田哲三 講演内容 GaNインバータによる省エネルギー化 GaNパワーデバイス技術 低コストSi 基板上 GaN 結晶成長 ノーマリオフ化 : Gate Injection Transistor
記者発表資料
 2012 年 6 月 4 日 報道機関各位 東北大学流体科学研究所原子分子材料科学高等研究機構 高密度 均一量子ナノ円盤アレイ構造による高効率 量子ドット太陽電池の実現 ( シリコン量子ドット太陽電池において世界最高変換効率 12.6% を達成 ) < 概要 > 東北大学 流体科学研究所および原子分子材料科学高等研究機構 寒川教授グループはこの度 新しい鉄微粒子含有蛋白質 ( リステリアフェリティン
2012 年 6 月 4 日 報道機関各位 東北大学流体科学研究所原子分子材料科学高等研究機構 高密度 均一量子ナノ円盤アレイ構造による高効率 量子ドット太陽電池の実現 ( シリコン量子ドット太陽電池において世界最高変換効率 12.6% を達成 ) < 概要 > 東北大学 流体科学研究所および原子分子材料科学高等研究機構 寒川教授グループはこの度 新しい鉄微粒子含有蛋白質 ( リステリアフェリティン
世界最高面密度の量子ドットの自己形成に成功
 同時発表 : 筑波研究学園都市記者会 ( 資料配布 ) 文部科学記者会 ( 資料配布 ) 科学記者会 ( 資料配布 ) 世界最高面密度の量子ドットの自己形成に成功 - 高性能量子ドットデバイス実現に向けた研究がさらに加速 - 平成 24 年 6 月 4 日 独立行政法人物質 材料研究機構 概要 : 独立行政法人物質 材料研究機構 ( 理事長 : 潮田資勝 ) 先端フォトニクス材料ユニット ( ユニット長
同時発表 : 筑波研究学園都市記者会 ( 資料配布 ) 文部科学記者会 ( 資料配布 ) 科学記者会 ( 資料配布 ) 世界最高面密度の量子ドットの自己形成に成功 - 高性能量子ドットデバイス実現に向けた研究がさらに加速 - 平成 24 年 6 月 4 日 独立行政法人物質 材料研究機構 概要 : 独立行政法人物質 材料研究機構 ( 理事長 : 潮田資勝 ) 先端フォトニクス材料ユニット ( ユニット長
【NanotechJapan Bulletin】10-9 INNOVATIONの最先端<第4回>
 企画特集 10-9 INNOVATION の最先端 Life & Green Nanotechnology が培う新技術 < 第 4 回 > プリンテッドエレクトロニクス時代実現に向けた材料 プロセス基盤技術の開拓 NEDO プロジェクトプロジェクトリーダー東京 学教授染 隆夫 に聞く 図6 4 3 解像度を変えた TFT アレイによる電子ペーパー 提供 凸版印刷 株 大面積圧力センサの開発
企画特集 10-9 INNOVATION の最先端 Life & Green Nanotechnology が培う新技術 < 第 4 回 > プリンテッドエレクトロニクス時代実現に向けた材料 プロセス基盤技術の開拓 NEDO プロジェクトプロジェクトリーダー東京 学教授染 隆夫 に聞く 図6 4 3 解像度を変えた TFT アレイによる電子ペーパー 提供 凸版印刷 株 大面積圧力センサの開発
2θχ/φ scan λ= å Al 2 (11-20) Intensity (a. u.) ZnO(<1nm)/MgO(0.8nm)/Al 2 MgO(0.8nm)/Al 2 WZ-MgO(10-10) a=3.085å MgZnO(10-10) a=3.101å
 MgO/c-Al 2 界面構造解析 課題番号 2005B0434 利用ビームライン BL13XU 東北大学金属材料研究所博士課程後期 3 年の過程 2 年嶺岸耕 1. 背景 ZnO は直接遷移型のワイドギャップ半導体で バンドギャップは室温で 3.37eV 光の波長に換算すると 368nm と紫外域にあることから貸し領域で透明である この性質を利用して紫外域での発光素子としての応用に関する研究 [1-3]
MgO/c-Al 2 界面構造解析 課題番号 2005B0434 利用ビームライン BL13XU 東北大学金属材料研究所博士課程後期 3 年の過程 2 年嶺岸耕 1. 背景 ZnO は直接遷移型のワイドギャップ半導体で バンドギャップは室温で 3.37eV 光の波長に換算すると 368nm と紫外域にあることから貸し領域で透明である この性質を利用して紫外域での発光素子としての応用に関する研究 [1-3]
スライド 1
 2014 年 9 月 17 日 ( 水 ) 第 75 回応用物理学会秋季学術講演会 TiC 電極,TiSi 2 電極と SiC 基板の Schottky ダイオード特性評価 Schottky diode characteristics of TiC and TiSi 2 electrodes on SiC substrates 東工大フロンティア研 1, 東工大総理工 2, 鈴木智之 1, 岡本真里
2014 年 9 月 17 日 ( 水 ) 第 75 回応用物理学会秋季学術講演会 TiC 電極,TiSi 2 電極と SiC 基板の Schottky ダイオード特性評価 Schottky diode characteristics of TiC and TiSi 2 electrodes on SiC substrates 東工大フロンティア研 1, 東工大総理工 2, 鈴木智之 1, 岡本真里
Microsoft Word - 第9章発光デバイス_
 第 9 章発光デバイス 半導体デバイスを専門としない方たちでも EL( エレクトロルミネッセンス ) という言葉はよく耳にするのではないだろうか これは電界発光の意味で ディスプレイや LED 電球の基本的な動作原理を表す言葉でもある 半導体は我々の高度情報社会の基盤であることは言うまでもないが 情報端末と人間とのインターフェースとなるディスプレイおいても 今や半導体の技術範疇にある この章では 光を電荷注入により発することができる直接遷移半導体について学び
第 9 章発光デバイス 半導体デバイスを専門としない方たちでも EL( エレクトロルミネッセンス ) という言葉はよく耳にするのではないだろうか これは電界発光の意味で ディスプレイや LED 電球の基本的な動作原理を表す言葉でもある 半導体は我々の高度情報社会の基盤であることは言うまでもないが 情報端末と人間とのインターフェースとなるディスプレイおいても 今や半導体の技術範疇にある この章では 光を電荷注入により発することができる直接遷移半導体について学び
<4D F736F F D208CF595A890AB F C1985F8BB389C88F CF58C9F8F6F8AED2E646F63>
 光検出器 pin-pd 数 GHzまでの高速応答する光検出器に pin-フォトダイオードとアバランシェフォトダイオードがある pin-フォトダイオードは図 1に示すように n + 基板と低ドーピングi 層と 0.3μm 程度に薄くした p + 層からなる 逆バイアスを印加して 空乏層を i 層全体に広げ 接合容量を小さくしながら光吸収領域を拡大して高感度にする 表面より入射した光は光吸収係数 αによって指数関数的に減衰しながら光励起キャリアを生成する
光検出器 pin-pd 数 GHzまでの高速応答する光検出器に pin-フォトダイオードとアバランシェフォトダイオードがある pin-フォトダイオードは図 1に示すように n + 基板と低ドーピングi 層と 0.3μm 程度に薄くした p + 層からなる 逆バイアスを印加して 空乏層を i 層全体に広げ 接合容量を小さくしながら光吸収領域を拡大して高感度にする 表面より入射した光は光吸収係数 αによって指数関数的に減衰しながら光励起キャリアを生成する
Microsoft PowerPoint 修論発表_細田.ppt
 0.0.0 ( 月 ) 修士論文発表 Carrier trasort modelig i diamods ( ダイヤモンドにおけるキャリヤ輸送モデリング ) 物理電子システム創造専攻岩井研究室 M688 細田倫央 Tokyo Istitute of Techology パワーデバイス基板としてのダイヤモンド Proerty (relative to Si) Si GaAs SiC Ga Diamod
0.0.0 ( 月 ) 修士論文発表 Carrier trasort modelig i diamods ( ダイヤモンドにおけるキャリヤ輸送モデリング ) 物理電子システム創造専攻岩井研究室 M688 細田倫央 Tokyo Istitute of Techology パワーデバイス基板としてのダイヤモンド Proerty (relative to Si) Si GaAs SiC Ga Diamod
研究成果報告書
 10m 2m Ge Si BaF2 ZnSZnSe Sb-Ge-Sn-S IIR-SF1 1 2 Tungsten SilicideWSi WSi () IIR-SF 1 Sb-Ge-Sn-S 0.85~11μm2.710μm 253 C Al Al 220μm He-Cd laser 1 Exposure Photoresist WSi (a) 500 nm Development RIE WSi
10m 2m Ge Si BaF2 ZnSZnSe Sb-Ge-Sn-S IIR-SF1 1 2 Tungsten SilicideWSi WSi () IIR-SF 1 Sb-Ge-Sn-S 0.85~11μm2.710μm 253 C Al Al 220μm He-Cd laser 1 Exposure Photoresist WSi (a) 500 nm Development RIE WSi
電子回路I_4.ppt
 電子回路 Ⅰ 第 4 回 電子回路 Ⅰ 5 1 講義内容 1. 半導体素子 ( ダイオードとトランジスタ ) 2. 基本回路 3. 増幅回路 電界効果トランジスタ (FET) 基本構造 基本動作動作原理 静特性 電子回路 Ⅰ 5 2 半導体素子 ( ダイオードとトランジスタ ) ダイオード (2 端子素子 ) トランジスタ (3 端子素子 ) バイポーラトランジスタ (Biolar) 電界効果トランジスタ
電子回路 Ⅰ 第 4 回 電子回路 Ⅰ 5 1 講義内容 1. 半導体素子 ( ダイオードとトランジスタ ) 2. 基本回路 3. 増幅回路 電界効果トランジスタ (FET) 基本構造 基本動作動作原理 静特性 電子回路 Ⅰ 5 2 半導体素子 ( ダイオードとトランジスタ ) ダイオード (2 端子素子 ) トランジスタ (3 端子素子 ) バイポーラトランジスタ (Biolar) 電界効果トランジスタ
窒化アルミニウム単結晶基板の開発
 エレクトロニクス 窒化アルミニウム単結晶基板の開発 佐 藤 一 成 * 荒 川 聡 谷 崎 圭 祐 宮 永 倫 正 櫻 田 隆 山 本 喜 之 中 幡 英 章 Development of Aluminum Nitride Single Crystl Sustrtes y Issei Stoh, Stoshi Arkw, Keisuke Tnizki, Michims Miyng, Tkshi Skurd,
エレクトロニクス 窒化アルミニウム単結晶基板の開発 佐 藤 一 成 * 荒 川 聡 谷 崎 圭 祐 宮 永 倫 正 櫻 田 隆 山 本 喜 之 中 幡 英 章 Development of Aluminum Nitride Single Crystl Sustrtes y Issei Stoh, Stoshi Arkw, Keisuke Tnizki, Michims Miyng, Tkshi Skurd,
hetero
 ヘテロ接合型太陽電池の原理 構造 製造プロセス及び研究開発 / 技術動向 ( その 1) 平成 29 年 11 月 APT 代表 村田正義 ヘテロ接合型太陽電池の原理 構造 あ ( 出典 )https://www.panasonic.com/jp/corporate/technology-design/technology/hit.html ヘテロ接合型太陽電池セルの歴史 1980 年に当時の三洋電機
ヘテロ接合型太陽電池の原理 構造 製造プロセス及び研究開発 / 技術動向 ( その 1) 平成 29 年 11 月 APT 代表 村田正義 ヘテロ接合型太陽電池の原理 構造 あ ( 出典 )https://www.panasonic.com/jp/corporate/technology-design/technology/hit.html ヘテロ接合型太陽電池セルの歴史 1980 年に当時の三洋電機
PowerPoint プレゼンテーション
 研究分野紹介 化合物薄膜太陽電池 太陽光発電研究センター 化合物薄膜チーム 柴田肇 太陽電池の分類 シリコン系 結晶系 薄膜系 単結晶 多結晶 太陽電池 化合物系 有機系 単結晶系 GaAs InP 系多結晶系 CIGS, CZTS, CdTe 色素増感太陽電池有機薄膜 CIGS = CuIn 1-x Ga x Se 2 CZTS = Cu 2 ZnSnS 4-x Se x 化合物薄膜太陽電池 化合物薄膜太陽電池とは何か?
研究分野紹介 化合物薄膜太陽電池 太陽光発電研究センター 化合物薄膜チーム 柴田肇 太陽電池の分類 シリコン系 結晶系 薄膜系 単結晶 多結晶 太陽電池 化合物系 有機系 単結晶系 GaAs InP 系多結晶系 CIGS, CZTS, CdTe 色素増感太陽電池有機薄膜 CIGS = CuIn 1-x Ga x Se 2 CZTS = Cu 2 ZnSnS 4-x Se x 化合物薄膜太陽電池 化合物薄膜太陽電池とは何か?
化合物半導体デバイス―限りなき可能性を求めて(その2)―
 特別論文 化合物半導体デバイス 限りなき可能性を求めて ( その 2) 林秀樹 Development of Common Platform for ITS Devices II by Hideki Hayashi Many different compound semiconductors can be formed by changing the combination of constituent
特別論文 化合物半導体デバイス 限りなき可能性を求めて ( その 2) 林秀樹 Development of Common Platform for ITS Devices II by Hideki Hayashi Many different compound semiconductors can be formed by changing the combination of constituent
「世界初、高出力半導体レーザーを8分の1の狭スペクトル幅で発振に成功」
 NEWS RELEASE LD を 8 分の 1 以下の狭いスペクトル幅で発振するレーザー共振器の開発に 世界で初めて成功全固体レーザーの出力を向上する励起用 LD 光源の開発に期待 215 年 4 月 15 日 本社 : 浜松市中区砂山町 325-6 代表取締役社長 : 晝馬明 ( ひるまあきら ) 当社は 高出力半導体レーザー ( 以下 LD ) スタック 2 個を ストライプミラーと単一面型
NEWS RELEASE LD を 8 分の 1 以下の狭いスペクトル幅で発振するレーザー共振器の開発に 世界で初めて成功全固体レーザーの出力を向上する励起用 LD 光源の開発に期待 215 年 4 月 15 日 本社 : 浜松市中区砂山町 325-6 代表取締役社長 : 晝馬明 ( ひるまあきら ) 当社は 高出力半導体レーザー ( 以下 LD ) スタック 2 個を ストライプミラーと単一面型
(215) 121 MBE 法による GaN 単結晶基板上への Ⅲ 族窒化物半導体のホモエピタキシャル成長 田邉智之 ( 電気電子工学専攻 ) 渡邉肇之 ( 電気電子工学科 ) 小野基 ( 電気電子工学科 ) 南場康成 ( 電気電子工学専攻 ) 倉井聡 ( 電気電子工学科 ) 田口常正 ( 電気電子
 (215) 121 MBE 法による GaN 単結晶基板上への Ⅲ 族窒化物半導体のホモエピタキシャル成長 田邉智之 ( 電気電子工学専攻 ) 渡邉肇之 ( 電気電子工学科 ) 小野基 ( 電気電子工学科 ) 南場康成 ( 電気電子工学専攻 ) 倉井聡 ( 電気電子工学科 ) 田口常正 ( 電気電子工学科 ) 井上孝行 ( ジャパンエナジー精製技術センター ) 栗田博 ( ジャパンエナジー精製技術センター
(215) 121 MBE 法による GaN 単結晶基板上への Ⅲ 族窒化物半導体のホモエピタキシャル成長 田邉智之 ( 電気電子工学専攻 ) 渡邉肇之 ( 電気電子工学科 ) 小野基 ( 電気電子工学科 ) 南場康成 ( 電気電子工学専攻 ) 倉井聡 ( 電気電子工学科 ) 田口常正 ( 電気電子工学科 ) 井上孝行 ( ジャパンエナジー精製技術センター ) 栗田博 ( ジャパンエナジー精製技術センター
事務連絡
 二酸化炭素排出抑制に資する革新的技術の創出 平成 21 年度採択研究代表者 H23 年度 実績報告 橋詰保 北海道大学量子集積エレクトロニクス研究センター 教授 研究課題 異種接合 GaN 横型トランジスタのインバータ展開 1. 研究実施体制 (1) 北大 グループ 1 研究代表者 : 橋詰保 ( 北海道大学量子集積エレクトロニクス研究センター 教授 ) 2 研究項目 ドライエッチ面を含む Al 2
二酸化炭素排出抑制に資する革新的技術の創出 平成 21 年度採択研究代表者 H23 年度 実績報告 橋詰保 北海道大学量子集積エレクトロニクス研究センター 教授 研究課題 異種接合 GaN 横型トランジスタのインバータ展開 1. 研究実施体制 (1) 北大 グループ 1 研究代表者 : 橋詰保 ( 北海道大学量子集積エレクトロニクス研究センター 教授 ) 2 研究項目 ドライエッチ面を含む Al 2
スライド タイトルなし
 2011. 3. 2 高等研究院 インテックセンター成果報告会 極限を目指した 新しい半導体デバイスの実現 京都大学工学研究科電子工学専攻 木本恒暢 須田淳 光 電子理工学 エネルギー 環境問題や爆発的な情報量増大解決へ 物理限界への挑戦と新機能の創出 自在な光子制御 フォトニック結晶 シリコンナノフォト二クス ワイドバンドギャップ光半導体 極限的な電子制御 ワイドバンドギャップ (SiC) エレクトロニクス
2011. 3. 2 高等研究院 インテックセンター成果報告会 極限を目指した 新しい半導体デバイスの実現 京都大学工学研究科電子工学専攻 木本恒暢 須田淳 光 電子理工学 エネルギー 環境問題や爆発的な情報量増大解決へ 物理限界への挑戦と新機能の創出 自在な光子制御 フォトニック結晶 シリコンナノフォト二クス ワイドバンドギャップ光半導体 極限的な電子制御 ワイドバンドギャップ (SiC) エレクトロニクス
QOBU1011_40.pdf
 印字データ名 QOBU1 0 1 1 (1165) コメント 研究紹介 片山 作成日時 07.10.04 19:33 図 2 (a )センサー素子の外観 (b )センサー基板 色の濃い部分が Pt 形電極 幅 50μm, 間隔 50μm (c ),(d )単層ナノ チューブ薄膜の SEM 像 (c )Al O 基板上, (d )Pt 電極との境 界 熱 CVD 条件 触媒金属 Fe(0.5nm)/Al(5nm)
印字データ名 QOBU1 0 1 1 (1165) コメント 研究紹介 片山 作成日時 07.10.04 19:33 図 2 (a )センサー素子の外観 (b )センサー基板 色の濃い部分が Pt 形電極 幅 50μm, 間隔 50μm (c ),(d )単層ナノ チューブ薄膜の SEM 像 (c )Al O 基板上, (d )Pt 電極との境 界 熱 CVD 条件 触媒金属 Fe(0.5nm)/Al(5nm)
Microsoft Word -
 電池 Fruit Cell 自然系 ( 理科 ) コース高嶋めぐみ佐藤尚子松本絵里子 Ⅰはじめに高校の化学における電池の単元は金属元素のイオン化傾向や酸化還元反応の応用として重要な単元である また 電池は日常においても様々な場面で活用されており 生徒にとっても興味を引きやすい その一方で 通常の電池の構造はブラックボックスとなっており その原理について十分な理解をさせるのが困難な教材である そこで
電池 Fruit Cell 自然系 ( 理科 ) コース高嶋めぐみ佐藤尚子松本絵里子 Ⅰはじめに高校の化学における電池の単元は金属元素のイオン化傾向や酸化還元反応の応用として重要な単元である また 電池は日常においても様々な場面で活用されており 生徒にとっても興味を引きやすい その一方で 通常の電池の構造はブラックボックスとなっており その原理について十分な理解をさせるのが困難な教材である そこで
SiC JFET による高速スイッチング電源
 エレクトロニクス S i C J F E T による高速スイッチング電源 初 川 聡 * 築 野 孝 藤 川 一 洋 志 賀 信 夫 ウリントヤ 和 田 和 千 大 平 孝 High-Speed Switching Power Supply Using SiC RESURF JFETs by Satoshi Hatsukawa, Takashi Tsuno, Kazuhiro Fujikawa, Nobuo
エレクトロニクス S i C J F E T による高速スイッチング電源 初 川 聡 * 築 野 孝 藤 川 一 洋 志 賀 信 夫 ウリントヤ 和 田 和 千 大 平 孝 High-Speed Switching Power Supply Using SiC RESURF JFETs by Satoshi Hatsukawa, Takashi Tsuno, Kazuhiro Fujikawa, Nobuo
研究成果報告書
 MIS HEMT MIS HEMT MIS HEMT AlGaN/GaN MIS ALD AlGaN/GaN MIS-HEMT (1)MIS MIS AlGaN/GaN MIS-HEMT BCl 3 Cl 2 Ti/Al/Mo/Au (15/60/35/50 nm) 850 ºC AlGaN Ni/Au (100/150 nm) 300 ºC Lg=3m Lgd=5 mwg=100 m ALD Al
MIS HEMT MIS HEMT MIS HEMT AlGaN/GaN MIS ALD AlGaN/GaN MIS-HEMT (1)MIS MIS AlGaN/GaN MIS-HEMT BCl 3 Cl 2 Ti/Al/Mo/Au (15/60/35/50 nm) 850 ºC AlGaN Ni/Au (100/150 nm) 300 ºC Lg=3m Lgd=5 mwg=100 m ALD Al
円筒型 SPCP オゾナイザー技術資料 T ( 株 ) 増田研究所 1. 構造株式会社増田研究所は 独自に開発したセラミックの表面に発生させる沿面放電によるプラズマ生成技術を Surface Discharge Induced Plasma Chemical P
 円筒型 SPCP オゾナイザー技術資料 T211-1 211.2.7 ( 株 ) 増田研究所 1. 構造株式会社増田研究所は 独自に開発したセラミックの表面に発生させる沿面放電によるプラズマ生成技術を Surface Discharge Induced Plasma Chemical Process (SPCP) と命名し 小型 ~ 中型のオゾナイザーとして製造 販売を行っている SPCP オゾナイザーは図
円筒型 SPCP オゾナイザー技術資料 T211-1 211.2.7 ( 株 ) 増田研究所 1. 構造株式会社増田研究所は 独自に開発したセラミックの表面に発生させる沿面放電によるプラズマ生成技術を Surface Discharge Induced Plasma Chemical Process (SPCP) と命名し 小型 ~ 中型のオゾナイザーとして製造 販売を行っている SPCP オゾナイザーは図
e - カーボンブラック Pt 触媒 プロトン導電膜 H 2 厚さ = 数 10μm H + O 2 H 2 O 拡散層 触媒層 高分子 電解質 触媒層 拡散層 マイクロポーラス層 マイクロポーラス層 ガス拡散電極バイポーラープレート ガス拡散電極バイポーラープレート 1 1~ 50nm 0.1~1
 Development History and Future Design of Reduction of Pt in Catalyst Layer and Improvement of Reliability for Polymer Electrolyte Fuel Cells 6-43 400-0021 Abstract 1 2008-2008 2015 2 1 1 2 2 10 50 1 5
Development History and Future Design of Reduction of Pt in Catalyst Layer and Improvement of Reliability for Polymer Electrolyte Fuel Cells 6-43 400-0021 Abstract 1 2008-2008 2015 2 1 1 2 2 10 50 1 5
Microsoft PowerPoint - 集積デバイス工学7.ppt
 集積デバイス工学 (7 問題 追加課題 下のトランジスタが O する電圧範囲を求めよただし T, T - とする >6 問題 P 型 MOS トランジスタについて 正孔の実効移動度 μ.7[m/ s], ゲート長.[μm], ゲート幅 [μm] しきい値電圧 -., 単位面積あたりの酸化膜容量
集積デバイス工学 (7 問題 追加課題 下のトランジスタが O する電圧範囲を求めよただし T, T - とする >6 問題 P 型 MOS トランジスタについて 正孔の実効移動度 μ.7[m/ s], ゲート長.[μm], ゲート幅 [μm] しきい値電圧 -., 単位面積あたりの酸化膜容量
Electrical contact characteristics of n-type diamond with Ti, Ni, NiSi2, and Ni3P electrodes
 Electrical contact characteristics of n-type diamond with Ti, Ni, NiSi 2, and Ni 3 P electrodes 杉井 岩井研究室 12M36240 武正敦 1 注目を集めるワイドギャップ半導体 パワーエレクトロニクス ( 半導体の電力変換分野への応用 ) に期待 ワイドギャップ半導体に注目 Properties (relative
Electrical contact characteristics of n-type diamond with Ti, Ni, NiSi 2, and Ni 3 P electrodes 杉井 岩井研究室 12M36240 武正敦 1 注目を集めるワイドギャップ半導体 パワーエレクトロニクス ( 半導体の電力変換分野への応用 ) に期待 ワイドギャップ半導体に注目 Properties (relative
シャープ100年史:第7章
 1986 1991 1 7-01 7-02 7-04 7-03 2 7-06 7-0 3 7-08 7-07 4 7-10 7-09 6 7-11 7-12 オプトデバイスのリードを支えた オンリーワン 応用製品とともに発展してきたオプトデバイス オプトデバイスとは 光学と電子工学を融合した半導体部品で 大量情報の伝達 記憶 変換を素早く 正確にでき 高度情報化社会で大きな役割を果たした 発光素子と受光素子から
1986 1991 1 7-01 7-02 7-04 7-03 2 7-06 7-0 3 7-08 7-07 4 7-10 7-09 6 7-11 7-12 オプトデバイスのリードを支えた オンリーワン 応用製品とともに発展してきたオプトデバイス オプトデバイスとは 光学と電子工学を融合した半導体部品で 大量情報の伝達 記憶 変換を素早く 正確にでき 高度情報化社会で大きな役割を果たした 発光素子と受光素子から
新技術説明会 様式例
 1 殺菌用 深紫外 LED の開発 国立研究開発法人理化学研究所平山量子光素子研究室 主任研究員平山秀樹 出力 深紫外 LED の応用分野 高密度光記録深紫外 DVD 樹脂加工 接着電子部品 UV 接着 3D プリンター 医療機器 殺菌 浄水 空気浄化 DUV 光 浄水 冷蔵庫 エアコン 医療 農業免疫療法 ( アトピー皮膚炎 ); ナローバンド UVB 療法商品作物の病害防止 ( イチゴのうどん粉病など
1 殺菌用 深紫外 LED の開発 国立研究開発法人理化学研究所平山量子光素子研究室 主任研究員平山秀樹 出力 深紫外 LED の応用分野 高密度光記録深紫外 DVD 樹脂加工 接着電子部品 UV 接着 3D プリンター 医療機器 殺菌 浄水 空気浄化 DUV 光 浄水 冷蔵庫 エアコン 医療 農業免疫療法 ( アトピー皮膚炎 ); ナローバンド UVB 療法商品作物の病害防止 ( イチゴのうどん粉病など
PowerPoint プレゼンテーション
 CIGS 太陽電池の研究開発 太陽光発電研究センター 化合物薄膜チーム 柴田肇 1 太陽電池の分類 シリコン系 結晶系 薄膜系 単結晶 多結晶 太陽電池 化合物系 有機系 単結晶系 GaAs InP 系多結晶系 CIGS, CZTS, CdTe 色素増感太陽電池有機薄膜 CIGS = CuIn 1-x Ga x Se 2 CZTS = Cu 2 ZnSnS 4-x Se x 化合物薄膜太陽電池 2
CIGS 太陽電池の研究開発 太陽光発電研究センター 化合物薄膜チーム 柴田肇 1 太陽電池の分類 シリコン系 結晶系 薄膜系 単結晶 多結晶 太陽電池 化合物系 有機系 単結晶系 GaAs InP 系多結晶系 CIGS, CZTS, CdTe 色素増感太陽電池有機薄膜 CIGS = CuIn 1-x Ga x Se 2 CZTS = Cu 2 ZnSnS 4-x Se x 化合物薄膜太陽電池 2
 hν 688 358 979 309 308.123 Hz α α α α α α No.37 に示す Ti Sa レーザーで実現 術移転も成功し 図 9 に示すよ うに 2 時間は連続測定が可能な システムを実現した Advanced S o l i d S t a t e L a s e r s 2016, JTu2A.26 1-3. 今後は光周波 数比計測装置としてさらに改良 を加えていくとともに
hν 688 358 979 309 308.123 Hz α α α α α α No.37 に示す Ti Sa レーザーで実現 術移転も成功し 図 9 に示すよ うに 2 時間は連続測定が可能な システムを実現した Advanced S o l i d S t a t e L a s e r s 2016, JTu2A.26 1-3. 今後は光周波 数比計測装置としてさらに改良 を加えていくとともに
<4D F736F F D2091AA92E895FB964082C982C282A282C45F >
 相対強度 の特性測定方法について 製品の特性は主に光学的な特性面と電気的な特性面で仕様化されております この文書はこれらの特性がどのような方法で数値化されているか すなわち測定方法や単位系などについて解説しております また 弊社は車載用途向けの に関しましてはパッケージの熱抵抗を仕様化しておりますので その測定方法について解説しております 光学的特性 の発光量を表す単位には 2 つの単位があります
相対強度 の特性測定方法について 製品の特性は主に光学的な特性面と電気的な特性面で仕様化されております この文書はこれらの特性がどのような方法で数値化されているか すなわち測定方法や単位系などについて解説しております また 弊社は車載用途向けの に関しましてはパッケージの熱抵抗を仕様化しておりますので その測定方法について解説しております 光学的特性 の発光量を表す単位には 2 つの単位があります
スライド 1
 1 2017/8/3 GaN とほぼ格子整合する 新しい ITO 膜の形成技術 京都工芸繊維大学電気電子工学系 助教 西中浩之 2 発明の概要 ビックスバイト構造 (bcc-ito) 安定相 菱面体晶構造 (rh-ito) 準安定相 現在利用されている ITO は全て ビックスバイト構造もしくは非晶質 菱面体晶構造 (rh-ito) は合成に高圧が必要なため 作製例がほとんどなかった 新技術では この
1 2017/8/3 GaN とほぼ格子整合する 新しい ITO 膜の形成技術 京都工芸繊維大学電気電子工学系 助教 西中浩之 2 発明の概要 ビックスバイト構造 (bcc-ito) 安定相 菱面体晶構造 (rh-ito) 準安定相 現在利用されている ITO は全て ビックスバイト構造もしくは非晶質 菱面体晶構造 (rh-ito) は合成に高圧が必要なため 作製例がほとんどなかった 新技術では この
SONY HAD Sensor に関する SONY と NEC の特許戦争 (1994~2002) SONY の 1975 年の HAD Sensor 特許に対する NEC からの攻撃内容の詳細 NECの1980 年の埋め込みPhotodiode 特許では BASE 領域を完全空乏化することを特許請
 SONY HAD Sensor に関する SONY と NEC の特許戦争 (1994~2002) SONY の 1975 年の HAD Sensor 特許に対する NEC からの攻撃内容の詳細 NECの1980 年の埋め込みPhotodiode 特許では BASE 領域を完全空乏化することを特許請求しているが すでに上記の2 件の萩原 1975 年特許の実施図で完全空乏化が明示されている また その埋め込み層の電位は
SONY HAD Sensor に関する SONY と NEC の特許戦争 (1994~2002) SONY の 1975 年の HAD Sensor 特許に対する NEC からの攻撃内容の詳細 NECの1980 年の埋め込みPhotodiode 特許では BASE 領域を完全空乏化することを特許請求しているが すでに上記の2 件の萩原 1975 年特許の実施図で完全空乏化が明示されている また その埋め込み層の電位は
PowerPoint Presentation
 半導体電子工学 II 神戸大学工学部 電気電子工学科 12/08/'10 半導体電子工学 Ⅱ 1 全体の内容 日付内容 ( 予定 ) 備考 1 10 月 6 日半導体電子工学 I の基礎 ( 復習 ) 11/24/'10 2 10 月 13 日 pn 接合ダイオード (1) 3 10 月 20 日 4 10 月 27 日 5 11 月 10 日 pn 接合ダイオード (2) pn 接合ダイオード (3)
半導体電子工学 II 神戸大学工学部 電気電子工学科 12/08/'10 半導体電子工学 Ⅱ 1 全体の内容 日付内容 ( 予定 ) 備考 1 10 月 6 日半導体電子工学 I の基礎 ( 復習 ) 11/24/'10 2 10 月 13 日 pn 接合ダイオード (1) 3 10 月 20 日 4 10 月 27 日 5 11 月 10 日 pn 接合ダイオード (2) pn 接合ダイオード (3)
<4D F736F F D DC58F498D A C A838A815B83585F C8B8FBB8C758CF591CC2E646F6378>
 同時発表 : 筑波研究学園都市記者会 ( 資料配布 ) 文部科学記者会 ( 資料配布 ) 科学記者会 ( 資料配布 ) 超高輝度 ハイパワー白色光源に適した YAG 単結晶蛍光体を開発 - レーザーヘッドライトなど LED 光源では困難な超高輝度製品への応用に期待 - 配布日時 : 平成 27 年 4 月 13 日 14 時国立研究開発法人物質 材料研究機構株式会社タムラ製作所株式会社光波 概要 1.
同時発表 : 筑波研究学園都市記者会 ( 資料配布 ) 文部科学記者会 ( 資料配布 ) 科学記者会 ( 資料配布 ) 超高輝度 ハイパワー白色光源に適した YAG 単結晶蛍光体を開発 - レーザーヘッドライトなど LED 光源では困難な超高輝度製品への応用に期待 - 配布日時 : 平成 27 年 4 月 13 日 14 時国立研究開発法人物質 材料研究機構株式会社タムラ製作所株式会社光波 概要 1.
AN504 Through-hole IRED/Right Angle Type 特長 パッケージ 製品の特長 φ3.6 サイドビュ - タイプ 無色透明樹脂 光出力 : 5mW TYP. (I F =50mA) 鉛フリーはんだ耐熱対応 RoHS 対応 ピーク発光波長指向半値角素子材質ランク選別はん
 特長 パッケージ 製品の特長 φ3.6 サイドビュ - タイプ 無色透明樹脂 光出力 : 5mW TYP. (I F =50mA) 鉛フリーはんだ耐熱対応 RoHS 対応 ピーク発光波長指向半値角素子材質ランク選別はんだ付け方法 ESD 出荷形態 950nm 60 deg. GaAs 放射強度選別を行い ランクごとに選別 半田ディップ マニュアルはんだ実装工程に対応 はんだ付けについては はんだ付け条件をご参照ください
特長 パッケージ 製品の特長 φ3.6 サイドビュ - タイプ 無色透明樹脂 光出力 : 5mW TYP. (I F =50mA) 鉛フリーはんだ耐熱対応 RoHS 対応 ピーク発光波長指向半値角素子材質ランク選別はんだ付け方法 ESD 出荷形態 950nm 60 deg. GaAs 放射強度選別を行い ランクごとに選別 半田ディップ マニュアルはんだ実装工程に対応 はんだ付けについては はんだ付け条件をご参照ください
平成 30 年 8 月 6 日 報道機関各位 東京工業大学 東北大学 日本工業大学 高出力な全固体電池で超高速充放電を実現全固体電池の実用化に向けて大きな一歩 要点 5V 程度の高電圧を発生する全固体電池で極めて低い界面抵抗を実現 14 ma/cm 2 の高い電流密度での超高速充放電が可能に 界面形
 平成 30 年 8 月 6 日 報道機関各位 東京工業大学 東北大学 日本工業大学 高出力な全固体電池で超高速充放電を実現全固体電池の実用化に向けて大きな一歩 要点 5V 程度の高電圧を発生する全固体電池で極めて低い界面抵抗を実現 14 ma/cm 2 の高い電流密度での超高速充放電が可能に 界面形成直後に固体電解質から電極へのリチウムイオンが自発的に移動 概要 東京工業大学の一杉太郎教授らは 東北大学の河底秀幸助教
平成 30 年 8 月 6 日 報道機関各位 東京工業大学 東北大学 日本工業大学 高出力な全固体電池で超高速充放電を実現全固体電池の実用化に向けて大きな一歩 要点 5V 程度の高電圧を発生する全固体電池で極めて低い界面抵抗を実現 14 ma/cm 2 の高い電流密度での超高速充放電が可能に 界面形成直後に固体電解質から電極へのリチウムイオンが自発的に移動 概要 東京工業大学の一杉太郎教授らは 東北大学の河底秀幸助教
パナソニック技報
 67 Next-generation Power Switching Devices for Automotive Applications: GaN and SiC Tetsuzo Ueda Yoshihiko Kanzawa Satoru Takahashi Kazuyuki Sawada Hiroyuki Umimoto Akira Yamasaki GaNSiCGaNSiGate Injection
67 Next-generation Power Switching Devices for Automotive Applications: GaN and SiC Tetsuzo Ueda Yoshihiko Kanzawa Satoru Takahashi Kazuyuki Sawada Hiroyuki Umimoto Akira Yamasaki GaNSiCGaNSiGate Injection
Microsoft PowerPoint _量子力学短大.pptx
 . エネルギーギャップとrllouゾーン ブリルアン領域,t_8.. 周期ポテンシャル中の電子とエネルギーギャップ 簡単のため 次元に間隔 で原子が並んでいる結晶を考える 右方向に進行している電子の波は 間隔 で規則正しく並んでいる原子が作る格子によって散乱され 左向きに進行する波となる 波長 λ が の時 r の反射条件 式を満たし 両者の波が互いに強め合い 定在波を作る つまり 式 式を満たす波は
. エネルギーギャップとrllouゾーン ブリルアン領域,t_8.. 周期ポテンシャル中の電子とエネルギーギャップ 簡単のため 次元に間隔 で原子が並んでいる結晶を考える 右方向に進行している電子の波は 間隔 で規則正しく並んでいる原子が作る格子によって散乱され 左向きに進行する波となる 波長 λ が の時 r の反射条件 式を満たし 両者の波が互いに強め合い 定在波を作る つまり 式 式を満たす波は
Microsoft PowerPoint - 集積回路工学(5)_ pptm
 集積回路工学 東京工業大学大学院理工学研究科電子物理工学専攻 松澤昭 2009/0/4 集積回路工学 A.Matuzawa (5MOS 論理回路の電気特性とスケーリング則 資料は松澤研のホームページ htt://c.e.titech.ac.j にあります 2009/0/4 集積回路工学 A.Matuzawa 2 インバータ回路 このようなインバータ回路をシミュレーションした 2009/0/4 集積回路工学
集積回路工学 東京工業大学大学院理工学研究科電子物理工学専攻 松澤昭 2009/0/4 集積回路工学 A.Matuzawa (5MOS 論理回路の電気特性とスケーリング則 資料は松澤研のホームページ htt://c.e.titech.ac.j にあります 2009/0/4 集積回路工学 A.Matuzawa 2 インバータ回路 このようなインバータ回路をシミュレーションした 2009/0/4 集積回路工学
Conduction Mechanism at Low Temperature of 2-Dimensional Hole Gas at GaN/AlGaN Heterointerface (低温におけるGaN/AlGaN ヘテロ界面の2 次元正孔ガスの伝導機構)
 2014/03/19 応用物理学会 2014 年春季学術講演会 コンダクタンス法による AlGaN/GaN ヘテロ 接合界面トラップに関する研究 Investigation on interface traps in AlGaN/GaN heterojunction by conductance method 劉璞誠 1, 竇春萌 2, 角嶋邦之 2, 片岡好則 2, 西山彰 2, 杉井信之 2,
2014/03/19 応用物理学会 2014 年春季学術講演会 コンダクタンス法による AlGaN/GaN ヘテロ 接合界面トラップに関する研究 Investigation on interface traps in AlGaN/GaN heterojunction by conductance method 劉璞誠 1, 竇春萌 2, 角嶋邦之 2, 片岡好則 2, 西山彰 2, 杉井信之 2,
1 マイクロワット閾値を持つ シリコンラマンレーザー 大阪府立大学大学院 工学研究科 電子物理工学分野准教授 高橋 和
 1 マイクロワット閾値を持つ シリコンラマンレーザー 大阪府立大学大学院 工学研究科 電子物理工学分野准教授 高橋 和 発明の概要 世界最高 Q 値を達成しているヘテロ構造ナノ共振器を用いて マイクロワット閾値をもつシリコンラマンレーザーを作製した レーザー素子は シリコン (001) 基板に穴をあけるだけで作製でき 素子サイズは 10 ミクロン程度である 従来の結晶方向から 45 度傾けてデバイスを作製
1 マイクロワット閾値を持つ シリコンラマンレーザー 大阪府立大学大学院 工学研究科 電子物理工学分野准教授 高橋 和 発明の概要 世界最高 Q 値を達成しているヘテロ構造ナノ共振器を用いて マイクロワット閾値をもつシリコンラマンレーザーを作製した レーザー素子は シリコン (001) 基板に穴をあけるだけで作製でき 素子サイズは 10 ミクロン程度である 従来の結晶方向から 45 度傾けてデバイスを作製
研究成果報告書
 様式 C-19 科学研究費助成事業 ( 科学研究費補助金 ) 研究成果報告書 平成 24 年 5 月 31 日現在 機関番号 :8241 研究種目 : 若手研究 (B) 研究期間 :2~211 課題番号 :227617 研究課題名 ( 和文 ) 窒化物半導体を用いた深紫外 LED 深紫外 LD の開発 研究課題名 ( 英文 ) Development of deep ultraviolet LED
様式 C-19 科学研究費助成事業 ( 科学研究費補助金 ) 研究成果報告書 平成 24 年 5 月 31 日現在 機関番号 :8241 研究種目 : 若手研究 (B) 研究期間 :2~211 課題番号 :227617 研究課題名 ( 和文 ) 窒化物半導体を用いた深紫外 LED 深紫外 LD の開発 研究課題名 ( 英文 ) Development of deep ultraviolet LED
600 V系スーパージャンクション パワーMOSFET TO-247-4Lパッケージのシミュレーションによる解析
 [17.7 White Paper] 6 V 系スーパージャンクションパワー MOSFET TO-247-4L パッケージのシミュレーションによる解析 MOSFET チップの高速スイッチング性能をより引き出すことができる 4 ピン新パッケージ TO-247-4L 背景 耐圧が 6V 以上の High Voltage(HV) パワー半導体ではオン抵抗と耐圧のトレードオフの改善を行うためスーパージャンクション
[17.7 White Paper] 6 V 系スーパージャンクションパワー MOSFET TO-247-4L パッケージのシミュレーションによる解析 MOSFET チップの高速スイッチング性能をより引き出すことができる 4 ピン新パッケージ TO-247-4L 背景 耐圧が 6V 以上の High Voltage(HV) パワー半導体ではオン抵抗と耐圧のトレードオフの改善を行うためスーパージャンクション
ERATO中村不均一結晶プロジェクト事後評価報告書(案)
 総括責任者 : 中村修二 カリフォルニア大学サンタバーバラ校材料物性工学部/ 教授 研究体制 : 不均一結晶バルクグループ ( カリフォルニア大学サンタバーバラ校 ) 不均一結晶薄膜グループ ( カリフォルニア大学サンタバーバラ校 東京理科大学 ) 不均一結晶評価グループ ( 筑波大学 ) 評価委員 ( あいうえお順 は主査 ): 纐纈明伯 東京農工大学大学院共生科学技術研究院/ 院長 名西憓之 立命館大学理工学部電子情報工学科/
総括責任者 : 中村修二 カリフォルニア大学サンタバーバラ校材料物性工学部/ 教授 研究体制 : 不均一結晶バルクグループ ( カリフォルニア大学サンタバーバラ校 ) 不均一結晶薄膜グループ ( カリフォルニア大学サンタバーバラ校 東京理科大学 ) 不均一結晶評価グループ ( 筑波大学 ) 評価委員 ( あいうえお順 は主査 ): 纐纈明伯 東京農工大学大学院共生科学技術研究院/ 院長 名西憓之 立命館大学理工学部電子情報工学科/
支援財団研究活動助成 生体超分子を利用利用した 3 次元メモリデバイスメモリデバイスの研究 奈良先端科学技術大学院大学物質創成科学研究科小原孝介
 2009.3.10 支援財団研究活動助成 生体超分子を利用利用した 3 次元メモリデバイスメモリデバイスの研究 奈良先端科学技術大学院大学物質創成科学研究科小原孝介 研究背景研究背景研究背景研究背景データデータデータデータの種類種類種類種類データデータデータデータの保存保存保存保存パソコンパソコンパソコンパソコンパソコンパソコンパソコンパソコンデータデータデータデータデータデータデータデータ音楽音楽音楽音楽音楽音楽音楽音楽写真写真写真写真記録媒体記録媒体記録媒体記録媒体フラッシュメモリフラッシュメモリフラッシュメモリフラッシュメモリ動画動画動画動画
2009.3.10 支援財団研究活動助成 生体超分子を利用利用した 3 次元メモリデバイスメモリデバイスの研究 奈良先端科学技術大学院大学物質創成科学研究科小原孝介 研究背景研究背景研究背景研究背景データデータデータデータの種類種類種類種類データデータデータデータの保存保存保存保存パソコンパソコンパソコンパソコンパソコンパソコンパソコンパソコンデータデータデータデータデータデータデータデータ音楽音楽音楽音楽音楽音楽音楽音楽写真写真写真写真記録媒体記録媒体記録媒体記録媒体フラッシュメモリフラッシュメモリフラッシュメモリフラッシュメモリ動画動画動画動画
半導体デバイスの信頼性
 Ⅲ. 1. 光素子の劣化メカニズム 1.1 半導体レーザー (LD) の光学損傷 2.2 受光素子の故障メカニズム 2. 高周波デバイスの劣化メカニズム 2.1 実装後のクラック発生 2.2 H/P FET の熱暴走 2.3 L/N FET の静電気破壊 2.4 AI 配線のエレクトロマイグレーション 12/36 MSRH06-1 光出力 P 光出力 P 1. 光素子の劣化メカニズム 1.1 半導体レーザー
Ⅲ. 1. 光素子の劣化メカニズム 1.1 半導体レーザー (LD) の光学損傷 2.2 受光素子の故障メカニズム 2. 高周波デバイスの劣化メカニズム 2.1 実装後のクラック発生 2.2 H/P FET の熱暴走 2.3 L/N FET の静電気破壊 2.4 AI 配線のエレクトロマイグレーション 12/36 MSRH06-1 光出力 P 光出力 P 1. 光素子の劣化メカニズム 1.1 半導体レーザー
<4D F736F F F696E74202D AC89CA95F18D9089EF975C8D658F F43945A A CC8A4A94AD298F4390B394C5205B8CDD8AB B83685D>
 小型 低消費電力を実現するグリーン MEMS センサの開発 センサネットワーク用 VOC( 揮発性有機化合物 ) 濃度センサの開発 オリンパス株式会社白石直規 発表内容 OUTLINE 1. 背景と目的 2. 開発項目と目標 3. 開発の成果 4. ネットワーク 応用分野 5. まとめ 1. 背景と目的 VOCとは VOC(volatile organic compounds 揮発性有機化合物) とは
小型 低消費電力を実現するグリーン MEMS センサの開発 センサネットワーク用 VOC( 揮発性有機化合物 ) 濃度センサの開発 オリンパス株式会社白石直規 発表内容 OUTLINE 1. 背景と目的 2. 開発項目と目標 3. 開発の成果 4. ネットワーク 応用分野 5. まとめ 1. 背景と目的 VOCとは VOC(volatile organic compounds 揮発性有機化合物) とは
低損失V溝型SiCトレンチMOSFET 4H-SiC V-groove Trench MOSFETs with the Buried p+ regions
 エレクトロニクス 低損失 V 溝型 SiC トレンチ MOSFET 4H-SiC V-groove Trench MOSFETs with the Buried p + regions * 斎藤雄和田圭司日吉透 Yu Saitoh Keiji Wada Toru Hiyoshi 増田健良築野孝御神村泰樹 Takeyoshi Masuda Takashi Tsuno Yasuki Mikamura 我々はワイドバンドギャップ半導体である炭化珪素
エレクトロニクス 低損失 V 溝型 SiC トレンチ MOSFET 4H-SiC V-groove Trench MOSFETs with the Buried p + regions * 斎藤雄和田圭司日吉透 Yu Saitoh Keiji Wada Toru Hiyoshi 増田健良築野孝御神村泰樹 Takeyoshi Masuda Takashi Tsuno Yasuki Mikamura 我々はワイドバンドギャップ半導体である炭化珪素
ポイント 太陽電池用の高性能な酸化チタン極薄膜の詳細な構造が解明できていなかったため 高性能化への指針が不十分であった 非常に微小な領域が観察できる顕微鏡と化学的な結合の状態を調査可能な解析手法を組み合わせることにより 太陽電池応用に有望な酸化チタンの詳細構造を明らかにした 詳細な構造の解明により
 この度 名古屋大学大学院工学研究科の望月健矢大学院生 後藤和泰助教 黒川康良准教授 山本剛久教授 宇佐美徳隆教授らは 太陽電池への応用に有 望な電気的特性を示す酸化チタン注 1) 極薄膜を開発しました さらに その微小領域 の構造を明らかにすることに世界で初めて成功しました 近年 原子層堆積法注 2) を用いて製膜した酸化チタン薄膜は 結晶シリコン注 3) の太 陽電池において 光で生成した電子を収集する材料として優れた特性を示すため
この度 名古屋大学大学院工学研究科の望月健矢大学院生 後藤和泰助教 黒川康良准教授 山本剛久教授 宇佐美徳隆教授らは 太陽電池への応用に有 望な電気的特性を示す酸化チタン注 1) 極薄膜を開発しました さらに その微小領域 の構造を明らかにすることに世界で初めて成功しました 近年 原子層堆積法注 2) を用いて製膜した酸化チタン薄膜は 結晶シリコン注 3) の太 陽電池において 光で生成した電子を収集する材料として優れた特性を示すため
