大口径電子デバイス用エピ基板の開発
|
|
|
- あけなお ちとく
- 5 years ago
- Views:
Transcription
1 GaN/Si 半導体の研究 技術動向 江川孝志名古屋工業大学極微デバイス機能システム研究センター 発表内容 1.MOCVD 法を用いたヘテロエピタキシャル成長 (1) 各種基板上の GaN の比較 Si 基板の利点 (2)Si 基板上の GaN 結晶成長 厚膜化及び高品質化 (3) ピットの発生 (4) 国内外の研究開発動向 2.Si 基板上 AlGaN/GaN HEMT の諸特性 (1) 縦方向及び横方向耐圧の総膜厚依存性 (2) ピットの与える影響 (3) パワーデバイスへの応用 3. まとめ 平成 24 年 7 月 9 日第 13 回窒化物半導体応用研究会
2 GaN パワーデバイス開発の意義 一次エネルギー消費量 ( 国内 ) 4.70 億 t ( 石油換算 ) 電力消費量 2.02 億 t (1.03 兆 kwh) 一人当たりの CO 2 発生量 36% 照明以外 ( パワーデバイス利用 ) 1.70 億 t 7% パワーエレクトロニクス分野での省エネが重要 SiC, GaN bulk, GaN/Si 海外約 25 倍 37kg/ 日 パワーデバイスのマーケット推定 (2030 年 ) 国内デバイス : 約 6900 億円 / 年 海外デバイス : 約 5 兆 5000 億円 / 年 照明 :0.32 億 t (GaN LED) CO 2 削減効果 : デバイスとして既存のSi 半導体に対し70-90% 減日本国内のCO 2 排出量約 13.5 億トンに対し4% 減 (2025 年 ) 6%(2030 年 ) ( 新機能素子研究開発協会 次世代省エネデバイス技術調査報告書 H20 年 3 月電気事業連合会 原子力 エネルギー 図面集 )
3 窒化物 (GaN) 系半導体材料の特徴 材料的特長 : 1. 大きなバンドギャップ :3.4 ev 2. 大きな破壊電界 :2x10 6 V/cm 3. 大きな飽和速度 :2.7x10 7 cm/s 4. ヘテロ構造 (AlGaN/GaN) の作製 5. 大きなシートキャリア密度 (Ns): Ns~1x10 13 cm -2 6.As を含まない (cf. GaAs) 応用分野 : 1. 紫外 青 緑 赤の発光デバイス 1) 白色ランプ : 蛍光灯の代替え ( 水銀無し 省エネ ) 2)DVD 用のレーザー :4 倍の記録密度 2. 高周波 高出力 高温動作の電子デバイス 1) 携帯電話用基地局 2) スイッチング用電源 ( パワーデバイス ) 3. 紫外線 ガスセンサー
4 各種半導体材料の高出力デバイスとしての物性値と性能指数 材料 Eg ev ε μ cm 2 /Vs Ec 10 6 V/cm vs 10 7 cm/s κ W/cmK JFM (Ecvs/π) 2 KFM κ(vs/ε) 1/2 BFM εμec 3 Si BHFM GaAs GaN H-SiC , 50 4H-SiC , 650 μec パワーデバイスとしての性能指数 : バリガ指数 (BFM)=εμEc 3 絶縁破壊電界 (Ec) が大きいワイドバンドギャップ半導体 GaN SiC GaAs Si
5 オン抵抗の比較 高耐圧で低抵抗 GaN が有利 応用物理 大橋弘道 第 73 巻 第 12 号 p 年
6 GaN 系半導体の特徴 Si,GaAs との比較 電気 / ハイブリッド自動車用インバータ衝突防止用レーダー (77 GHz) 移動体通信地上基地局 地上ディジタル放送中継局 電力変換回路小型化 9W/cm 3 ( インバータ ) 広帯域無線ネットシステム GaN HEMT on Si 無線基地局 家電用インバータ 鉄道用インバータ 大容量衛星通信システム ( 進行波管の代替 ) サービス機器 携帯端末 PC
7 各種基板の比較 大口径化 コスト 高出力化総合評価 GaN/Si GaN/SiC GaN/ サファイア GaN/GaN SiC 各種基板の比較 Si 基板が有利既存のプロセスラインの利用 ( 新たな設備投資が不要 )
8 Thermal and Lattice Mismatch
9 コスト面から見た既存 Si 半導体 競合技術との比較 プロセスのコスト 結晶成長のコスト 基板のコスト SiC デバイス SiC:1,500~1,600 GaN:1,200 GaN/GaN デバイス GaN/ サファイアテ ハ イス Si デバイス 低コスト化 サファイア :480 円 /cm 2 Si :80 円 /cm 2 以下 SiC:1,600 円 /cm 2 以上 低コスト化 GaN :40,000 円 /cm 2 以上 GaN/Si デバイス Si :80 円 /cm 2 以下 Panasonic の資料を一部修正 デバイス化した際のコストを考えたときに 最も影響が大きいのは基板コスト 基板に Si を用いることは 圧倒的なコスト競争力を持つこととなる SiC デバイスの場合 SiC 基板の大口径化とともに Si と競争できる低コスト化を実現することが必要 GaN デバイスの場合 GaN 基板の実用化の目処がたっておらず Si と競争できる低コスト化を実現することは困難 サファイア基板は 放熱性に問題がある Si 基板は 既存のデバイスプロセスラインの活用が可能となることなど 基板そのもののコスト競争力を有する 既存の Si デバイス製造ラインを活用することで デバイスメーカの膨大な設備投資が不要となる
10 GaN/Si 大電力用パワーデバイスによる小型化 軽量化 現在 普及している Si パワー MOSFET10 個分を 1 チップで実現 1.8 cm 1.6 cm 1.8 cm 2cm 1 個の GaN/Si パワーデバイス 小型化 軽量化 Si パワー MOSFET:10 個分 パワー半導体が拓く新市場セミナー 電波新聞社主催 2011 年 2 月 3 日
11 海外での GaN/Si の研究開発動向 EU MORGaN プロジェクト 11ヶ国 24 企業 機関による共同研究 AIXTRON, MicroGaN, Gooch&Housego,THALES,SWEREAなど 研究費 9.2 million(2009より33 年間 ) 狙い : 厳しい環境で使用可能な GaNセンサ RFトランシ スタの開発 LAST POWER プロジェクト 42ヶ月間 欧州多国間 14 企業参加 STMcroelectronicsが中心となり 先進的なSiC 及びGaN/Siのコスト効率と信頼性の統合を開発, NEULAND プロジェクトドイツの企業 6 社 (Aixtronなど) が参加研究費 4.2 million(2010より3 年間 )GaN/SiやSiCなどを使い エネルギー効率が高く 低コストのパワーデバイスを開発 G 2 REC STMicroelectroncsが中心 Sitronics, Novasicなど4 社 2 大学参加 6インチSi 上に耐圧 600VのSBDを開発 2007 年より4 年計画で 15 million STMicroelectronics 社狙い : 低損失 GaNダイオード (2013 年の製品化を狙う ) Freescale 社 CNRS-CREHAとの共同研究狙い : 高出力 GaN/Si MOSHEMT( ハ イアホールによる縦型デバイス ) IMEC 2012 年までにGaN/Siの8インチ化を計画 (Applied Material, Dow Corning, Samsung) アメリカ TRIQUINT 社 BAE Systems, IQE-RF Corp., Lockheed Martin; II-VI Inc. との共同研究研究費 ( Phase III) $31.7 million.(2009より2 年間 ) 狙い:48V 駆動でのテ ハ イス信頼性 寿命の向上 Northrop Grumman 社 University of California Santa Barbara, Arizona State University and Pennsylvania State University 研究費 (PhaseⅠ) $12.4 million 狙い: 高耐圧で500GHz 駆動可能なGaNデバイスの開発 Nitronex 社 GaN/Si 技術を活用したHEMT 構造トランシ スタを販売 (2007~) Efficient Power Conversion 社 GaN/Si (6インチ) 技術を使って40~200V 耐圧のハ ワートランシ スタを開発し 販売開始 (2010~) International Rectifier 社 GaN/Siを使い ハ ワー MOSFETを量産中 売上 10 億ト ル規模 Cree 社 GaN/Siのヘテロエピタキシャル技術 パワーデバイス シンガポール A-Starプロジェクト GaN/Siに関して Nanyang Technological University, Standard Chartered( ク ローハ ルファント リー ) 8インチのGaN/Siパワーデバイス (4 月より立ち上げ ) 台湾 TSMC 社 GaN/Siパワーデバイスファンドリーサービス計画 UMC 社 GaN/Siパワーデバイスファンドリーサービス計画中国 CRSタイムス エレクトリック社他 ハ ワー半導体世界 6 位のカナダのDynex Power 社を買収 国策としてGaN 研究に多額の資金を投入
12 4 インチ対応 MOCVD 装置 Horizontal MOCVD system (Nippon Sanso, SR-4000) Source gas Group III : TMG, TMA Group V : NH 3 Stainless steel reactor Fused quartz flow channel Nitrogen gas Group III + carrier gas Group V + carrier gas Substrate Dopant : SiH 4 Carrier gas H 2, N 2 Growth temperature ºC アンモニアとTMAの気相反応の制御が重要!! Laminar flow region Diffusion region Resistive heater (Temperature 1100 )
13 Surface morphology of n-gan on Si 従来技術 GaN デバイス層 低温成長 AlN 緩衝層 Si 基板 温度 AlN/AlGaN 高温成長中間層サーマル GaN/Si クリーニング 成長 低温成長緩衝層 ( 従来技術 ) GaAs/Si, GaN/ サファイア 高温成長中間層技術 GaN デバイス層 GaN/AlN 歪超格子高温成長 AlGaN/AlN 中間層 Si 基板 GaN デバイス層表面の劣化 時間 Ga によるメルトバックエッチングの抑制
14 エピ層膜厚と反りの関係 反りの形状 GaN GaN GaN 圧縮歪 2 AlN Si 基板 1 多層膜緩衝層 (AlN/GaN SLS) Si 基板 応力緩和 下に凸 成長層に引張り歪 反りの増加 クラック ( 割れ ) の発生 厚膜化 引張り歪 ( 熱膨張係数差 ) 圧縮歪 ( 格子定数差 ) 格子定数 : Si > GaN > AlN 熱膨張係数 : Si < GaN < AlN 厚膜化の考え方素子層となる GaN に圧縮応力 ( 応 力のカウンターバランス ) を与える SLS 導入による歪緩和
15 Bowing vs. total thickness of epilayer 160 pair 200 pair 50 pair i-gan 2 μm 100 pair GaN / AlN 7 μm Silicon Counter-balance of thermal and lattice mismatches by SLS Total thickness:9.0 μm Crack free
16 現状の Si 基板上エピ - 大口径化と厚膜化 - 大口径化 厚膜化 膜厚 :10 μm エピ ( 周辺約 10 mm クラック有 )
17 Cross-sectional TEM of AlGaN/AlN/GaN HEMT on Si i-algan i-algan i-gan AlN:1 nm i-gan GaN/AlN SLS AlN GaN 20 nm HT-AlGaN/AlN AlGaN Silicon AlN Si SiN
18 2-terminal breakdown voltage of i-gan vs. total thickness Vertical direction Horizontal direction Improvement of V B with the increase of total thickness V B = μm S. L. Selvaraj et al., IEEE EDL., Vol. 30, No. 6, p. 587, 2009
19 Surface morphology High breakdown voltage Low breakdown voltage Nomarski SEM AFM
20 Cross-sectional TEM and SEM by FIB SLS 4 μm Meltback etching due to reaction of Ga to Si substrate S. L. Selvaraj et al., Appl. Phys. Express 2, (2009)
21 Leakage current pass V G = -5 V: ピンチオフ I Drain Pit density:~0 I Buf I Gate I Sub Pit density: 2,500 cm -2 エピ厚 :2.4 μm, Lg/Wg = 1.5/15 μm gm=190 ms/mm, I D =625 ma/mm, Vth=-2.0 V Pit density: 12,500 cm -2 Pit density: 34,000 cm -2
22 HEMT とピットの関係 Mesa G S D
23 CL intensity as a function of distance from pit Pit density: ~ 0 cm -2 Pit density: ~ 1x10 3 cm -2 S. L. Selvaraj et. al., Appl. Phys. Letts (98)
24 Device characteristics as a function of distance from pit Pit density: 1x10 3 cm -2 ピットの無い試料 : I DSmax = 516 ma/mm, V th = -2.1 V, BV off = 300 V
25 電流コラプス : 市販エピとの比較 V ds OFF 100 V,..,600 V V gs 0.5V 0 V 0 V -6 V R ON (before) 10s 10s R ON (after) time 本研究 電流コラプスの抑制 TWHM2011, T. Deguchi et al.
26 オン抵抗と耐圧の関係 オン抵抗 面積 (mω-cm 2 ) Si SJMOSFET GaN HEMT on SiC GaN HEMT on Sapphire GaN HEMT on Si GaN HEMT on Si ( 名工大 ) Philips 東芝サンケン IR NTU Si 限界 本研究 UCSB MIT 基板除去 古河電工 ( フィールドプレート ) UCSB Univ. of South Carolina パナソニック 4H-SiC 限界 GaN 限界 FBI, Germany 耐圧 (V)
27 まとめ 1. 高温成長 AlGaN/AlN 中間層と歪超格子を用いた Si 基板上 AlGaN/GaN HEMT 構造において (1) 厚膜化 :9μm (2) 横方向 2 端子耐圧 :1813 V (10 μm ギャップ ) (3) 縦方向 :2.3 MV/cm (4) 移動度 :3215 cm 2 /Vs( 室温 ) (5) 三端子オフ耐圧 :1402 V (6)R on A:7.7 mωcm 2 (7) 電流コラプスの抑制 2. Si 基板上 AlGaN/GaN HEMT 構造は パワーデバイスとして有望 謝辞 : 本研究の一部は 科学技術振興調整費 ( 先導的研究等の推進 ) 有機金属気相成長技術 ( 大陽日酸 ) 寄附研究部門 知的クラスター創成事業及び民間との共同研究等により行われたものです
第 1 回窒化物半導体応用研究会平成 20 年 2 月 8 日 講演内容 1. 弊社の概要紹介 2. 弊社における窒化物半導体事業への展開 3. 知的クラスター創生事業での取り組み Si 基板上 HEMT 用 GaN 系エピ結晶結晶成長成長技術技術開発
 第 1 回窒化物半導体応用研究会 平成 20 年 2 月 8 日 GaN 結晶成長技術の開発 半導体事業部 伊藤統夫 第 1 回窒化物半導体応用研究会平成 20 年 2 月 8 日 講演内容 1. 弊社の概要紹介 2. 弊社における窒化物半導体事業への展開 3. 知的クラスター創生事業での取り組み Si 基板上 HEMT 用 GaN 系エピ結晶結晶成長成長技術技術開発 弊社社名変更について 2006
第 1 回窒化物半導体応用研究会 平成 20 年 2 月 8 日 GaN 結晶成長技術の開発 半導体事業部 伊藤統夫 第 1 回窒化物半導体応用研究会平成 20 年 2 月 8 日 講演内容 1. 弊社の概要紹介 2. 弊社における窒化物半導体事業への展開 3. 知的クラスター創生事業での取り組み Si 基板上 HEMT 用 GaN 系エピ結晶結晶成長成長技術技術開発 弊社社名変更について 2006
GaNの特長とパワーデバイス応用に向けての課題 GaNパワーデバイスの低コスト化技術 大面積 Si 上 MOCVD 結晶成長技術 Si 上大電流 AlGaN/GaNパワー HFET GaN パワーデバイスのノーマリオフ動作 伝導度変調を用いたAlGaN/GaNトランジスタ - Gate Inject
 高耐圧 GaN パワーデバイス開発 松下電器産業 ( 株 ) 半導体社半導体デバイス研究センター 上田哲三 GaNの特長とパワーデバイス応用に向けての課題 GaNパワーデバイスの低コスト化技術 大面積 Si 上 MOCVD 結晶成長技術 Si 上大電流 AlGaN/GaNパワー HFET GaN パワーデバイスのノーマリオフ動作 伝導度変調を用いたAlGaN/GaNトランジスタ - Gate Injection
高耐圧 GaN パワーデバイス開発 松下電器産業 ( 株 ) 半導体社半導体デバイス研究センター 上田哲三 GaNの特長とパワーデバイス応用に向けての課題 GaNパワーデバイスの低コスト化技術 大面積 Si 上 MOCVD 結晶成長技術 Si 上大電流 AlGaN/GaNパワー HFET GaN パワーデバイスのノーマリオフ動作 伝導度変調を用いたAlGaN/GaNトランジスタ - Gate Injection
untitled
 213 74 AlGaN/GaN Influence of metal material on capacitance for Schottky-gated AlGaN/GaN 1, 2, 1, 2, 2, 2, 2, 2, 2, 2, 1, 1 1 AlGaN/GaN デバイス ① GaNの優れた物性値 ② AlGaN/GaN HEMT構造 ワイドバンドギャップ半導体 (3.4eV) 絶縁破壊電界が大きい
213 74 AlGaN/GaN Influence of metal material on capacitance for Schottky-gated AlGaN/GaN 1, 2, 1, 2, 2, 2, 2, 2, 2, 2, 1, 1 1 AlGaN/GaN デバイス ① GaNの優れた物性値 ② AlGaN/GaN HEMT構造 ワイドバンドギャップ半導体 (3.4eV) 絶縁破壊電界が大きい
PowerPoint プレゼンテーション
 第 12 回窒化物半導体応用研究会 2011 年 11 月 10 日 ノーマリオフ型 HFET の高性能化 前田就彦 日本電信電話株式会社 NTT フォトニクス研究所 243-0198 神奈川県厚木市森の里若宮 3-1 E-mail: maeda.narihiko@lab.ntt.co.jp 内容 (1) 電力応用におけるノーマリオフ型デバイス (2) / HFETにおけるノーマリオフ化 - デバイス構造のこれまでの展開
第 12 回窒化物半導体応用研究会 2011 年 11 月 10 日 ノーマリオフ型 HFET の高性能化 前田就彦 日本電信電話株式会社 NTT フォトニクス研究所 243-0198 神奈川県厚木市森の里若宮 3-1 E-mail: maeda.narihiko@lab.ntt.co.jp 内容 (1) 電力応用におけるノーマリオフ型デバイス (2) / HFETにおけるノーマリオフ化 - デバイス構造のこれまでの展開
untitled
 20101221JST (SiC - Buried Gate Static Induction Transistor: SiC-BGSIT) SOURCE GATE N source layer p + n p + n p + n p+ n drift layer n + substrate DRAIN SiC-BGSIT (mωcm 2 ) 200 100 40 10 4 1 Si limit
20101221JST (SiC - Buried Gate Static Induction Transistor: SiC-BGSIT) SOURCE GATE N source layer p + n p + n p + n p+ n drift layer n + substrate DRAIN SiC-BGSIT (mωcm 2 ) 200 100 40 10 4 1 Si limit
PowerPoint プレゼンテーション
 加工 Si 基板上への 非極性 GaN 結晶成長 1) 名古屋大学工学研究科 赤崎記念研究センター 2) 愛知工業大学工学研究科 1) 本田善央 1) 谷川智之 1) 鈴木希幸 1) 山口雅史 2) 澤木宣彦 豊田講堂時計台 赤崎研究センター auditorium Akasaki research center 常圧 MOVPE 減圧 MOVPE (2inch) HVPE MOVPE #3 MOVPE
加工 Si 基板上への 非極性 GaN 結晶成長 1) 名古屋大学工学研究科 赤崎記念研究センター 2) 愛知工業大学工学研究科 1) 本田善央 1) 谷川智之 1) 鈴木希幸 1) 山口雅史 2) 澤木宣彦 豊田講堂時計台 赤崎研究センター auditorium Akasaki research center 常圧 MOVPE 減圧 MOVPE (2inch) HVPE MOVPE #3 MOVPE
Microsoft Word - プレリリース参考資料_ver8青柳(最終版)
 別紙 : 参考資料 従来の深紫外 LED に比べ 1/5 以下の低コストでの製造を可能に 新縦型深紫外 LED Ref-V DUV LED の開発に成功 立命館大学総合科学技術研究機構の黒瀬範子研究員並びに青柳克信上席研究員は従来 の 1/5 以下のコストで製造を可能にする新しいタイプの縦型深紫外 LED(Ref-V DUV LED) の開発に成功した 1. コスト1/5 以下の深紫外 LED 1)
別紙 : 参考資料 従来の深紫外 LED に比べ 1/5 以下の低コストでの製造を可能に 新縦型深紫外 LED Ref-V DUV LED の開発に成功 立命館大学総合科学技術研究機構の黒瀬範子研究員並びに青柳克信上席研究員は従来 の 1/5 以下のコストで製造を可能にする新しいタイプの縦型深紫外 LED(Ref-V DUV LED) の開発に成功した 1. コスト1/5 以下の深紫外 LED 1)
窒化アルミニウムによる 高効率フィールドエミッションを実現 ディスプレイパネル実用レベルのフィールドエミッション特性
 Copyright NTT Basic Research Laboratories, NTT Corporation. All rights reserved. ダイヤモンド 高周波電力デバイスの開発とマイクロ波 ミリ波帯電力増幅器への応用 (614314) 研究代表者嘉数誠 (1) NTT 物性科学基礎研究所 研究分担者植田研二 (2) 小林康之 中川匡夫 NTT 物性科学基礎研究所 NTT 未来ねっと研究所
Copyright NTT Basic Research Laboratories, NTT Corporation. All rights reserved. ダイヤモンド 高周波電力デバイスの開発とマイクロ波 ミリ波帯電力増幅器への応用 (614314) 研究代表者嘉数誠 (1) NTT 物性科学基礎研究所 研究分担者植田研二 (2) 小林康之 中川匡夫 NTT 物性科学基礎研究所 NTT 未来ねっと研究所
<4D F736F F F696E74202D208FE393635F928289BB95A894BC93B191CC8CA48B8689EF5F47614E F815B835E5F88F38DFC97702E707074>
 21 年 6 月 24 日第 8 回窒化物半導体応用研究会 GaN 系電子デバイスの現状とその可能性 GaN パワーデバイスのインバータ応用 パナソニック株式会社 セミコンダクター社半導体デバイス研究センター 上田哲三 講演内容 GaNインバータによる省エネルギー化 GaNパワーデバイス技術 低コストSi 基板上 GaN 結晶成長 ノーマリオフ化 : Gate Injection Transistor
21 年 6 月 24 日第 8 回窒化物半導体応用研究会 GaN 系電子デバイスの現状とその可能性 GaN パワーデバイスのインバータ応用 パナソニック株式会社 セミコンダクター社半導体デバイス研究センター 上田哲三 講演内容 GaNインバータによる省エネルギー化 GaNパワーデバイス技術 低コストSi 基板上 GaN 結晶成長 ノーマリオフ化 : Gate Injection Transistor
AlGaN/GaN HFETにおける 仮想ゲート型電流コラプスのSPICE回路モデル
 AlGaN/GaN HFET 電流コラプスおよびサイドゲート効果に関する研究 徳島大学大学院先端技術科学教育部システム創生工学専攻電気電子創生工学コース大野 敖研究室木尾勇介 1 AlGaN/GaN HFET 研究背景 高絶縁破壊電界 高周波 高出力デバイス 基地局などで実用化 通信機器の発達 スマートフォン タブレットなど LTE LTE エンベロープトラッキング 低消費電力化 電源電圧を信号に応じて変更
AlGaN/GaN HFET 電流コラプスおよびサイドゲート効果に関する研究 徳島大学大学院先端技術科学教育部システム創生工学専攻電気電子創生工学コース大野 敖研究室木尾勇介 1 AlGaN/GaN HFET 研究背景 高絶縁破壊電界 高周波 高出力デバイス 基地局などで実用化 通信機器の発達 スマートフォン タブレットなど LTE LTE エンベロープトラッキング 低消費電力化 電源電圧を信号に応じて変更
untitled
 2013 74 Tokyo Institute of Technology AlGaN/GaN C Annealing me Dependent Contact Resistance of C Electrodes on AlGaN/GaN, Tokyo Tech.FRC, Tokyo Tech. IGSSE, Toshiba, Y. Matsukawa, M. Okamoto, K. Kakushima,
2013 74 Tokyo Institute of Technology AlGaN/GaN C Annealing me Dependent Contact Resistance of C Electrodes on AlGaN/GaN, Tokyo Tech.FRC, Tokyo Tech. IGSSE, Toshiba, Y. Matsukawa, M. Okamoto, K. Kakushima,
<4D F736F F F696E74202D2091E F BB95A894BC93B191CC899E97708CA48B8689EF E9197BF>
 1 豊田合成の GaN 系 LED の開発と製品化 豊田合成株式会社オプト E 事業部柴田直樹 Outline 2 A. TG LED チップの歴史と特性の紹介 PC タブレット向けチップ 照明向けチップ B. TG の結晶成長技術について AlN バッファ層上 GaN 層成長メカニズム C. TG の最新 LED チップの紹介 GaN 基板上 LED 非極性 m 面 GaN LED A-1. 省エネ
1 豊田合成の GaN 系 LED の開発と製品化 豊田合成株式会社オプト E 事業部柴田直樹 Outline 2 A. TG LED チップの歴史と特性の紹介 PC タブレット向けチップ 照明向けチップ B. TG の結晶成長技術について AlN バッファ層上 GaN 層成長メカニズム C. TG の最新 LED チップの紹介 GaN 基板上 LED 非極性 m 面 GaN LED A-1. 省エネ
低転位GaN 基板上の低抵抗・高耐圧GaNダイオード
 エレクトロニクス 低転位 G a N 基板上の低抵抗 高耐圧 G a N ダイオード 住 吉 和 英 * 岡 田 政 也 上 野 昌 紀 木 山 誠 中 村 孝 夫 Low On-Resistance and High Breakdown Voltage GaN SBD on Low Dislocation Density GaN Substrates by Kazuhide Sumiyoshi,
エレクトロニクス 低転位 G a N 基板上の低抵抗 高耐圧 G a N ダイオード 住 吉 和 英 * 岡 田 政 也 上 野 昌 紀 木 山 誠 中 村 孝 夫 Low On-Resistance and High Breakdown Voltage GaN SBD on Low Dislocation Density GaN Substrates by Kazuhide Sumiyoshi,
Microsoft PowerPoint - 9.菅谷.pptx
 超多積層量子ドット太陽電池と トンネル効果 菅谷武芳 革新デバイスチーム 量子ドット太陽電池 電子 バンド3:伝導帯 E23 E13 E12 正孔 バンド2:中間バンド 量子ドット超格子 ミニバンド 量子ドットの井戸型 ポテンシャル バンド1:価電子帯 量子ドット太陽電池のバンド図 量子ドット超格子太陽電池 理論上 変換効率60%以上 集光 A. Luque et al., Phys. Rev. Lett.
超多積層量子ドット太陽電池と トンネル効果 菅谷武芳 革新デバイスチーム 量子ドット太陽電池 電子 バンド3:伝導帯 E23 E13 E12 正孔 バンド2:中間バンド 量子ドット超格子 ミニバンド 量子ドットの井戸型 ポテンシャル バンド1:価電子帯 量子ドット太陽電池のバンド図 量子ドット超格子太陽電池 理論上 変換効率60%以上 集光 A. Luque et al., Phys. Rev. Lett.
スライド タイトルなし
 2011. 3. 2 高等研究院 インテックセンター成果報告会 極限を目指した 新しい半導体デバイスの実現 京都大学工学研究科電子工学専攻 木本恒暢 須田淳 光 電子理工学 エネルギー 環境問題や爆発的な情報量増大解決へ 物理限界への挑戦と新機能の創出 自在な光子制御 フォトニック結晶 シリコンナノフォト二クス ワイドバンドギャップ光半導体 極限的な電子制御 ワイドバンドギャップ (SiC) エレクトロニクス
2011. 3. 2 高等研究院 インテックセンター成果報告会 極限を目指した 新しい半導体デバイスの実現 京都大学工学研究科電子工学専攻 木本恒暢 須田淳 光 電子理工学 エネルギー 環境問題や爆発的な情報量増大解決へ 物理限界への挑戦と新機能の創出 自在な光子制御 フォトニック結晶 シリコンナノフォト二クス ワイドバンドギャップ光半導体 極限的な電子制御 ワイドバンドギャップ (SiC) エレクトロニクス
Microsoft PowerPoint 修論発表_細田.ppt
 0.0.0 ( 月 ) 修士論文発表 Carrier trasort modelig i diamods ( ダイヤモンドにおけるキャリヤ輸送モデリング ) 物理電子システム創造専攻岩井研究室 M688 細田倫央 Tokyo Istitute of Techology パワーデバイス基板としてのダイヤモンド Proerty (relative to Si) Si GaAs SiC Ga Diamod
0.0.0 ( 月 ) 修士論文発表 Carrier trasort modelig i diamods ( ダイヤモンドにおけるキャリヤ輸送モデリング ) 物理電子システム創造専攻岩井研究室 M688 細田倫央 Tokyo Istitute of Techology パワーデバイス基板としてのダイヤモンド Proerty (relative to Si) Si GaAs SiC Ga Diamod
Microsoft PowerPoint - H30パワエレ-3回.pptx
 パワーエレクトロニクス 第三回パワー半導体デバイス 平成 30 年 4 月 25 日 授業の予定 シラバスより パワーエレクトロニクス緒論 パワーエレクトロニクスにおける基礎理論 パワー半導体デバイス (2 回 ) 整流回路 (2 回 ) 整流回路の交流側特性と他励式インバータ 交流電力制御とサイクロコンバータ 直流チョッパ DC-DC コンバータと共振形コンバータ 自励式インバータ (2 回 )
パワーエレクトロニクス 第三回パワー半導体デバイス 平成 30 年 4 月 25 日 授業の予定 シラバスより パワーエレクトロニクス緒論 パワーエレクトロニクスにおける基礎理論 パワー半導体デバイス (2 回 ) 整流回路 (2 回 ) 整流回路の交流側特性と他励式インバータ 交流電力制御とサイクロコンバータ 直流チョッパ DC-DC コンバータと共振形コンバータ 自励式インバータ (2 回 )
Slide 1
 SPring-8 利用推進協議会第 4 回次世代先端デバイス研究会 / 第 13 回 SPring-8 先端利用技術ワークショップ 2017.3.21 AP 品川京急第 2 ビル 先進パワーデバイスにおける 新規ゲート絶縁膜開発と 放射光利用 MOS 界面評価事例 大阪大学大学院工学研究科 渡部平司 転載不可 大阪大学大学院工学研究科渡部研究室 1/60 概要 ワイドバンドギャップ半導体パワーデバイス
SPring-8 利用推進協議会第 4 回次世代先端デバイス研究会 / 第 13 回 SPring-8 先端利用技術ワークショップ 2017.3.21 AP 品川京急第 2 ビル 先進パワーデバイスにおける 新規ゲート絶縁膜開発と 放射光利用 MOS 界面評価事例 大阪大学大学院工学研究科 渡部平司 転載不可 大阪大学大学院工学研究科渡部研究室 1/60 概要 ワイドバンドギャップ半導体パワーデバイス
Conduction Mechanism at Low Temperature of 2-Dimensional Hole Gas at GaN/AlGaN Heterointerface (低温におけるGaN/AlGaN ヘテロ界面の2 次元正孔ガスの伝導機構)
 2014/03/19 応用物理学会 2014 年春季学術講演会 コンダクタンス法による AlGaN/GaN ヘテロ 接合界面トラップに関する研究 Investigation on interface traps in AlGaN/GaN heterojunction by conductance method 劉璞誠 1, 竇春萌 2, 角嶋邦之 2, 片岡好則 2, 西山彰 2, 杉井信之 2,
2014/03/19 応用物理学会 2014 年春季学術講演会 コンダクタンス法による AlGaN/GaN ヘテロ 接合界面トラップに関する研究 Investigation on interface traps in AlGaN/GaN heterojunction by conductance method 劉璞誠 1, 竇春萌 2, 角嶋邦之 2, 片岡好則 2, 西山彰 2, 杉井信之 2,
PowerPoint プレゼンテーション
 半極性バルク GaN 基板上への LED の開発 実用レベルの発光効率と面内偏光の実現 船戸充講師, 川上養一助教授, 上田雅也 (D1) 京都大学 工学研究科 電子工学専攻 成川幸男, 小杉卓生, 高橋正良, 向井孝志日亜化学工業株式会社 謝辞 : 京都ナノテク事業創造クラスター 背 景 III 族窒化物半導体 :AlN,GaN,InN 紫外域 (AlN) から可視域 (GaN) を通って赤外域
半極性バルク GaN 基板上への LED の開発 実用レベルの発光効率と面内偏光の実現 船戸充講師, 川上養一助教授, 上田雅也 (D1) 京都大学 工学研究科 電子工学専攻 成川幸男, 小杉卓生, 高橋正良, 向井孝志日亜化学工業株式会社 謝辞 : 京都ナノテク事業創造クラスター 背 景 III 族窒化物半導体 :AlN,GaN,InN 紫外域 (AlN) から可視域 (GaN) を通って赤外域
Microsystem Integration & Packaging Laboratory
 2015/01/26 MemsONE 技術交流会 解析事例紹介 東京大学実装工学分野研究室奥村拳 Microsystem Integration and Packaging Laboratory 1 事例紹介 1. 解析の背景高出力半導体レーザの高放熱構造 2. 熱伝導解析解析モデルの概要 3. チップサイズの熱抵抗への影響 4. 接合材料の熱抵抗への影響 5. ヒートシンク材料の熱抵抗への影響 Microsystem
2015/01/26 MemsONE 技術交流会 解析事例紹介 東京大学実装工学分野研究室奥村拳 Microsystem Integration and Packaging Laboratory 1 事例紹介 1. 解析の背景高出力半導体レーザの高放熱構造 2. 熱伝導解析解析モデルの概要 3. チップサイズの熱抵抗への影響 4. 接合材料の熱抵抗への影響 5. ヒートシンク材料の熱抵抗への影響 Microsystem
untitled
 /Si FET /Si FET Improvement of tunnel FET performance using narrow bandgap semiconductor silicide Improvement /Si hetero-structure of tunnel FET performance source electrode using narrow bandgap semiconductor
/Si FET /Si FET Improvement of tunnel FET performance using narrow bandgap semiconductor silicide Improvement /Si hetero-structure of tunnel FET performance source electrode using narrow bandgap semiconductor
開発の社会的背景 パワーデバイスは 電気機器の電力制御に不可欠な半導体デバイスであり インバーターの普及に伴い省エネルギー技術の基盤となっている 最近では高電圧 大電流動作が技術的に可能になり ハイブリッド自動車のモーター駆動にも使われるなど急速に普及し 市場規模は 2 兆円に及ぶといわれる パワー
 ダイヤモンドパワーデバイスの高速 高温動作を実証 - 次世代半導体材料としての優位性を確認 - 平成 22 年 9 月 8 日独立行政法人産業技術総合研究所国立大学法人大阪大学 ポイント ダイヤモンドダイオードを用いたパワーデバイス用整流素子の動作を世界で初めて確認 高速かつ低損失の動作を確認でき 将来の実用化に期待 将来のパワーデバイスとして省エネルギー効果に期待 概要 独立行政法人産業技術総合研究所
ダイヤモンドパワーデバイスの高速 高温動作を実証 - 次世代半導体材料としての優位性を確認 - 平成 22 年 9 月 8 日独立行政法人産業技術総合研究所国立大学法人大阪大学 ポイント ダイヤモンドダイオードを用いたパワーデバイス用整流素子の動作を世界で初めて確認 高速かつ低損失の動作を確認でき 将来の実用化に期待 将来のパワーデバイスとして省エネルギー効果に期待 概要 独立行政法人産業技術総合研究所
スライド 1
 2014 年 9 月 17 日 ( 水 ) 第 75 回応用物理学会秋季学術講演会 TiC 電極,TiSi 2 電極と SiC 基板の Schottky ダイオード特性評価 Schottky diode characteristics of TiC and TiSi 2 electrodes on SiC substrates 東工大フロンティア研 1, 東工大総理工 2, 鈴木智之 1, 岡本真里
2014 年 9 月 17 日 ( 水 ) 第 75 回応用物理学会秋季学術講演会 TiC 電極,TiSi 2 電極と SiC 基板の Schottky ダイオード特性評価 Schottky diode characteristics of TiC and TiSi 2 electrodes on SiC substrates 東工大フロンティア研 1, 東工大総理工 2, 鈴木智之 1, 岡本真里
 hν 688 358 979 309 308.123 Hz α α α α α α No.37 に示す Ti Sa レーザーで実現 術移転も成功し 図 9 に示すよ うに 2 時間は連続測定が可能な システムを実現した Advanced S o l i d S t a t e L a s e r s 2016, JTu2A.26 1-3. 今後は光周波 数比計測装置としてさらに改良 を加えていくとともに
hν 688 358 979 309 308.123 Hz α α α α α α No.37 に示す Ti Sa レーザーで実現 術移転も成功し 図 9 に示すよ うに 2 時間は連続測定が可能な システムを実現した Advanced S o l i d S t a t e L a s e r s 2016, JTu2A.26 1-3. 今後は光周波 数比計測装置としてさらに改良 を加えていくとともに
untitled
 Tokyo Institute of Technology high-k/ In.53 Ga.47 As MOS - Defect Analysis of high-k/in.53 G a.47 As MOS Capacitor using capacitance voltage method,,, Darius Zade,,, Parhat Ahmet,,,,,, ~InGaAs high-k ~
Tokyo Institute of Technology high-k/ In.53 Ga.47 As MOS - Defect Analysis of high-k/in.53 G a.47 As MOS Capacitor using capacitance voltage method,,, Darius Zade,,, Parhat Ahmet,,,,,, ~InGaAs high-k ~
Microsoft PowerPoint - semi_ppt07.ppt [互換モード]
![Microsoft PowerPoint - semi_ppt07.ppt [互換モード] Microsoft PowerPoint - semi_ppt07.ppt [互換モード]](/thumbs/94/122068205.jpg) 1 MOSFETの動作原理 しきい電圧 (V TH ) と制御 E 型とD 型 0 次近似によるドレイン電流解析 2 電子のエネルギーバンド図での考察 理想 MOS 構造の仮定 : シリコンと金属の仕事関数が等しい 界面を含む酸化膜中に余分な電荷がない 金属 (M) 酸化膜 (O) シリコン (S) 電子エ金属 酸化膜 シリコン (M) (O) (S) フラットバンド ネルギー熱平衡で 伝導帯 E
1 MOSFETの動作原理 しきい電圧 (V TH ) と制御 E 型とD 型 0 次近似によるドレイン電流解析 2 電子のエネルギーバンド図での考察 理想 MOS 構造の仮定 : シリコンと金属の仕事関数が等しい 界面を含む酸化膜中に余分な電荷がない 金属 (M) 酸化膜 (O) シリコン (S) 電子エ金属 酸化膜 シリコン (M) (O) (S) フラットバンド ネルギー熱平衡で 伝導帯 E
Electrical contact characteristics of n-type diamond with Ti, Ni, NiSi2, and Ni3P electrodes
 Electrical contact characteristics of n-type diamond with Ti, Ni, NiSi 2, and Ni 3 P electrodes 杉井 岩井研究室 12M36240 武正敦 1 注目を集めるワイドギャップ半導体 パワーエレクトロニクス ( 半導体の電力変換分野への応用 ) に期待 ワイドギャップ半導体に注目 Properties (relative
Electrical contact characteristics of n-type diamond with Ti, Ni, NiSi 2, and Ni 3 P electrodes 杉井 岩井研究室 12M36240 武正敦 1 注目を集めるワイドギャップ半導体 パワーエレクトロニクス ( 半導体の電力変換分野への応用 ) に期待 ワイドギャップ半導体に注目 Properties (relative
報道発表資料 2000 年 2 月 17 日 独立行政法人理化学研究所 北海道大学 新しい結晶成長プロセスによる 低欠陥 高品質の GaN 結晶薄膜基板作製に成功 理化学研究所 ( 小林俊一理事長 ) は 北海道大学との共同研究により 従来よりも低欠陥 高品質の窒化ガリウム (GaN) 結晶薄膜基板
 報道発表資料 2000 年 2 月 17 日 独立行政法人理化学研究所 北海道大学 新しい結晶成長プロセスによる 低欠陥 高品質の GaN 結晶薄膜基板作製に成功 理化学研究所 ( 小林俊一理事長 ) は 北海道大学との共同研究により 従来よりも低欠陥 高品質の窒化ガリウム (GaN) 結晶薄膜基板を製作することに成功しました 新しい手法は 当研究所半導体工学研究室の青柳克信主任研究員と 北大電子科学研究所の田中悟助教授らのグループで開発
報道発表資料 2000 年 2 月 17 日 独立行政法人理化学研究所 北海道大学 新しい結晶成長プロセスによる 低欠陥 高品質の GaN 結晶薄膜基板作製に成功 理化学研究所 ( 小林俊一理事長 ) は 北海道大学との共同研究により 従来よりも低欠陥 高品質の窒化ガリウム (GaN) 結晶薄膜基板を製作することに成功しました 新しい手法は 当研究所半導体工学研究室の青柳克信主任研究員と 北大電子科学研究所の田中悟助教授らのグループで開発
Microsoft PowerPoint - semi_ppt07.ppt
 半導体工学第 9 回目 / OKM 1 MOSFET の動作原理 しきい電圧 (V( TH) と制御 E 型と D 型 0 次近似によるドレイン電流解析 半導体工学第 9 回目 / OKM 2 電子のエネルギーバンド図での考察 金属 (M) 酸化膜 (O) シリコン (S) 熱平衡でフラットバンド 伝導帯 E c 電子エネルギ シリコンと金属の仕事関数が等しい 界面を含む酸化膜中に余分な電荷がない
半導体工学第 9 回目 / OKM 1 MOSFET の動作原理 しきい電圧 (V( TH) と制御 E 型と D 型 0 次近似によるドレイン電流解析 半導体工学第 9 回目 / OKM 2 電子のエネルギーバンド図での考察 金属 (M) 酸化膜 (O) シリコン (S) 熱平衡でフラットバンド 伝導帯 E c 電子エネルギ シリコンと金属の仕事関数が等しい 界面を含む酸化膜中に余分な電荷がない
XP233P1501TR-j.pdf
 P-channel MOSFET -3V, -1.5A JTR114-1 特長オン抵抗 駆動電圧環境への配慮 : RDS(on)=.19Ω@VGS =-1V : -4.5V : EU RoHS 指令対応 鉛フリー 用途 スイッチング用 内部接続図 端子配列 SOT-23(TO-236) Drain Gate Source 製品名 PRODUCT NAME PACKAGE ORDER UNIT * SOT-23(TO-236)
P-channel MOSFET -3V, -1.5A JTR114-1 特長オン抵抗 駆動電圧環境への配慮 : RDS(on)=.19Ω@VGS =-1V : -4.5V : EU RoHS 指令対応 鉛フリー 用途 スイッチング用 内部接続図 端子配列 SOT-23(TO-236) Drain Gate Source 製品名 PRODUCT NAME PACKAGE ORDER UNIT * SOT-23(TO-236)
1.06μm帯高出力高寿命InGaAs歪量子井戸レーザ
 rjtenmy@ipc.shizuoka.ac.jp ZnO RPE-MOCVD UV- ZnO MQW LED/PD & Energy harvesting LED ( ) PV & ZnO... 1970 1980 1990 2000 2010 SAW NTT ZnO LN, LT IC PbInAu/PbBi Nb PIN/FET LD/HBT 0.98-1.06m InGaAs QW-LD
rjtenmy@ipc.shizuoka.ac.jp ZnO RPE-MOCVD UV- ZnO MQW LED/PD & Energy harvesting LED ( ) PV & ZnO... 1970 1980 1990 2000 2010 SAW NTT ZnO LN, LT IC PbInAu/PbBi Nb PIN/FET LD/HBT 0.98-1.06m InGaAs QW-LD
SiC 高チャネル移動度トランジスタ
 エレクトロニクス SiC 高チャネル移動度トランジスタ 日吉透 * 増田健良 和田圭司 原田真 築野孝 並川靖生 SiC MOSFET with High Channel Mobility by Toru Hiyoshi, Takeyoshi Masuda, Keiji Wada, Shin Harada, Takashi Tsuno and Yasuo Namikawa SiC (silicon
エレクトロニクス SiC 高チャネル移動度トランジスタ 日吉透 * 増田健良 和田圭司 原田真 築野孝 並川靖生 SiC MOSFET with High Channel Mobility by Toru Hiyoshi, Takeyoshi Masuda, Keiji Wada, Shin Harada, Takashi Tsuno and Yasuo Namikawa SiC (silicon
Microsoft PowerPoint - 14.菅谷修正.pptx
 InGaAs/系量子ドット太陽電池の作製 革新デバイスチーム 菅谷武芳 電子 バンド3:伝導帯 E3 E3 E 正孔 バンド:中間バンド 量子ドット超格子 ミニバンド 量子ドットの井戸型 ポテンシャル バンド:価電子帯 量子ドット太陽電池のバンド図 6%を超える理想的な量子ドット太陽 電池実現には E3として1 9eVが必要 量子ドット超格子太陽電池 理論上 変換効率6%以上 集光 を採用 MBE
InGaAs/系量子ドット太陽電池の作製 革新デバイスチーム 菅谷武芳 電子 バンド3:伝導帯 E3 E3 E 正孔 バンド:中間バンド 量子ドット超格子 ミニバンド 量子ドットの井戸型 ポテンシャル バンド:価電子帯 量子ドット太陽電池のバンド図 6%を超える理想的な量子ドット太陽 電池実現には E3として1 9eVが必要 量子ドット超格子太陽電池 理論上 変換効率6%以上 集光 を採用 MBE
2004/4/16 (Power Technology) O 2 ( ) (Information Technology) ( ) Gas (4H) GaN andgap (ev) Electron mobility (cm 2 /Vs)
 ontents semicon.kuee.kyoto-u.ac.jp P 5.47 ev 1.12 ev Ge 0.66 ev Sn 0.08 ev DVD LSI, 3.20 ev GaN 3.42 ev ZnO 2004/4/16 (Power Technology) O 2 ( ) (Information Technology) ( ) Gas (4H) GaN andgap (ev) 1.12
ontents semicon.kuee.kyoto-u.ac.jp P 5.47 ev 1.12 ev Ge 0.66 ev Sn 0.08 ev DVD LSI, 3.20 ev GaN 3.42 ev ZnO 2004/4/16 (Power Technology) O 2 ( ) (Information Technology) ( ) Gas (4H) GaN andgap (ev) 1.12
事務連絡
 二酸化炭素排出抑制に資する革新的技術の創出 平成 21 年度採択研究代表者 H23 年度 実績報告 橋詰保 北海道大学量子集積エレクトロニクス研究センター 教授 研究課題 異種接合 GaN 横型トランジスタのインバータ展開 1. 研究実施体制 (1) 北大 グループ 1 研究代表者 : 橋詰保 ( 北海道大学量子集積エレクトロニクス研究センター 教授 ) 2 研究項目 ドライエッチ面を含む Al 2
二酸化炭素排出抑制に資する革新的技術の創出 平成 21 年度採択研究代表者 H23 年度 実績報告 橋詰保 北海道大学量子集積エレクトロニクス研究センター 教授 研究課題 異種接合 GaN 横型トランジスタのインバータ展開 1. 研究実施体制 (1) 北大 グループ 1 研究代表者 : 橋詰保 ( 北海道大学量子集積エレクトロニクス研究センター 教授 ) 2 研究項目 ドライエッチ面を含む Al 2
AlN 基板を用いた高Al 組成AlGaN HEMTの開発
 エレクトロニクス Drain Current I D [ma] 9 8 7 6 5 4 3 2 2 4 6 8 12 14 1618 2 Drain Voltage V DS [V] A l N 基板を用いた高 A l 組成 A l G a N H E M T の開発 秋 田 勝 史 * 橋 本 信 山 本 喜 之 矢 船 憲 成 徳 田 博 邦 葛 原 正 明 岩 谷 素 顕 天 野 浩 Development
エレクトロニクス Drain Current I D [ma] 9 8 7 6 5 4 3 2 2 4 6 8 12 14 1618 2 Drain Voltage V DS [V] A l N 基板を用いた高 A l 組成 A l G a N H E M T の開発 秋 田 勝 史 * 橋 本 信 山 本 喜 之 矢 船 憲 成 徳 田 博 邦 葛 原 正 明 岩 谷 素 顕 天 野 浩 Development
Microsoft PowerPoint - 集積回路工学(5)_ pptm
 集積回路工学 東京工業大学大学院理工学研究科電子物理工学専攻 松澤昭 2009/0/4 集積回路工学 A.Matuzawa (5MOS 論理回路の電気特性とスケーリング則 資料は松澤研のホームページ htt://c.e.titech.ac.j にあります 2009/0/4 集積回路工学 A.Matuzawa 2 インバータ回路 このようなインバータ回路をシミュレーションした 2009/0/4 集積回路工学
集積回路工学 東京工業大学大学院理工学研究科電子物理工学専攻 松澤昭 2009/0/4 集積回路工学 A.Matuzawa (5MOS 論理回路の電気特性とスケーリング則 資料は松澤研のホームページ htt://c.e.titech.ac.j にあります 2009/0/4 集積回路工学 A.Matuzawa 2 インバータ回路 このようなインバータ回路をシミュレーションした 2009/0/4 集積回路工学
MOSFET HiSIM HiSIM2 1
 MOSFET 2007 11 19 HiSIM HiSIM2 1 p/n Junction Shockley - - on-quasi-static - - - Y- HiSIM2 2 Wilson E f E c E g E v Bandgap: E g Fermi Level: E f HiSIM2 3 a Si 1s 2s 2p 3s 3p HiSIM2 4 Fermi-Dirac Distribution
MOSFET 2007 11 19 HiSIM HiSIM2 1 p/n Junction Shockley - - on-quasi-static - - - Y- HiSIM2 2 Wilson E f E c E g E v Bandgap: E g Fermi Level: E f HiSIM2 3 a Si 1s 2s 2p 3s 3p HiSIM2 4 Fermi-Dirac Distribution
Figure 1. Center and Edge comparison of a HEMT epi measured by PCOR-SIMS SM 図 1 は直径 150mm の Si ウェハ上に成長させた GaN HEMT 構造全体の PCOR-SIMS による深さプ ロファイルを示しています
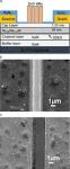 PCOR-SIMS による Si 基板上 GaN HEMT エピ構造の解析 Temel H. Buyuklimanli (temel@eag.com), Charles W. Magee, Ozgur Celik, Wei Ou, Andrew Klump, Wei Zhao, Yun Qi and Jeffrey Serfass 810 Kifer Road, Sunnyvale, CA 94086
PCOR-SIMS による Si 基板上 GaN HEMT エピ構造の解析 Temel H. Buyuklimanli (temel@eag.com), Charles W. Magee, Ozgur Celik, Wei Ou, Andrew Klump, Wei Zhao, Yun Qi and Jeffrey Serfass 810 Kifer Road, Sunnyvale, CA 94086
PowerPoint Presentation
 半導体電子工学 II 神戸大学工学部電気電子工学科 小川真人 09/01/21 半導体電子工学 II 日付内容 ( 予定 ) 備考 1 10 月 1 日半導体電子工学 I の基礎 ( 復習 ) 2 10 月 8 日半導体電子工学 I の基礎 ( 復習 ) 3 10 月 15 日 pn 接合ダイオード (1) 4 10 月 22 日 pn 接合ダイオード (2) 5 10 月 29 日 pn 接合ダイオード
半導体電子工学 II 神戸大学工学部電気電子工学科 小川真人 09/01/21 半導体電子工学 II 日付内容 ( 予定 ) 備考 1 10 月 1 日半導体電子工学 I の基礎 ( 復習 ) 2 10 月 8 日半導体電子工学 I の基礎 ( 復習 ) 3 10 月 15 日 pn 接合ダイオード (1) 4 10 月 22 日 pn 接合ダイオード (2) 5 10 月 29 日 pn 接合ダイオード
スライド 1
 2015 年 2 月 17 日 ( 火 ) 学士卒業論文発表会 TiC 及び TiSi 2 電極と SiC ショットキーダイオードの電気特性評価 (Electrical Characteristics of SiC Schottky Diodes with TiC and TiSi 2 Electrodes) Iwai and Kakushima Laboratory Tomoyuki Suzuki
2015 年 2 月 17 日 ( 火 ) 学士卒業論文発表会 TiC 及び TiSi 2 電極と SiC ショットキーダイオードの電気特性評価 (Electrical Characteristics of SiC Schottky Diodes with TiC and TiSi 2 Electrodes) Iwai and Kakushima Laboratory Tomoyuki Suzuki
PowerPoint プレゼンテーション
 1 次世代パワーデバイスの 自動車への応用について 2012.7.9 トヨタ自動車 ( 株 ) 第 3 電子開発部 長尾勝 本日の内容 2 1. 自動車を取り巻く環境 2. 自動車用パワーエレクトロニクス 3. 次世代パワーデバイスと自動車 今後の自動車産業 ~ 自動車用エレクトロニクス開発 ~ 3 究極 201X 年 2010 年 20XX 年 ゼロエミッション 大気並の排気 環境 代替エネルギーへの対応
1 次世代パワーデバイスの 自動車への応用について 2012.7.9 トヨタ自動車 ( 株 ) 第 3 電子開発部 長尾勝 本日の内容 2 1. 自動車を取り巻く環境 2. 自動車用パワーエレクトロニクス 3. 次世代パワーデバイスと自動車 今後の自動車産業 ~ 自動車用エレクトロニクス開発 ~ 3 究極 201X 年 2010 年 20XX 年 ゼロエミッション 大気並の排気 環境 代替エネルギーへの対応
パナソニック技報
 67 Next-generation Power Switching Devices for Automotive Applications: GaN and SiC Tetsuzo Ueda Yoshihiko Kanzawa Satoru Takahashi Kazuyuki Sawada Hiroyuki Umimoto Akira Yamasaki GaNSiCGaNSiGate Injection
67 Next-generation Power Switching Devices for Automotive Applications: GaN and SiC Tetsuzo Ueda Yoshihiko Kanzawa Satoru Takahashi Kazuyuki Sawada Hiroyuki Umimoto Akira Yamasaki GaNSiCGaNSiGate Injection
PowerPoint Presentation
 半導体電子工学 II 神戸大学工学部 電気電子工学科 12/08/'10 半導体電子工学 Ⅱ 1 全体の内容 日付内容 ( 予定 ) 備考 1 10 月 6 日半導体電子工学 I の基礎 ( 復習 ) 11/24/'10 2 10 月 13 日 pn 接合ダイオード (1) 3 10 月 20 日 4 10 月 27 日 5 11 月 10 日 pn 接合ダイオード (2) pn 接合ダイオード (3)
半導体電子工学 II 神戸大学工学部 電気電子工学科 12/08/'10 半導体電子工学 Ⅱ 1 全体の内容 日付内容 ( 予定 ) 備考 1 10 月 6 日半導体電子工学 I の基礎 ( 復習 ) 11/24/'10 2 10 月 13 日 pn 接合ダイオード (1) 3 10 月 20 日 4 10 月 27 日 5 11 月 10 日 pn 接合ダイオード (2) pn 接合ダイオード (3)
研究成果報告書
 MIS HEMT MIS HEMT MIS HEMT AlGaN/GaN MIS ALD AlGaN/GaN MIS-HEMT (1)MIS MIS AlGaN/GaN MIS-HEMT BCl 3 Cl 2 Ti/Al/Mo/Au (15/60/35/50 nm) 850 ºC AlGaN Ni/Au (100/150 nm) 300 ºC Lg=3m Lgd=5 mwg=100 m ALD Al
MIS HEMT MIS HEMT MIS HEMT AlGaN/GaN MIS ALD AlGaN/GaN MIS-HEMT (1)MIS MIS AlGaN/GaN MIS-HEMT BCl 3 Cl 2 Ti/Al/Mo/Au (15/60/35/50 nm) 850 ºC AlGaN Ni/Au (100/150 nm) 300 ºC Lg=3m Lgd=5 mwg=100 m ALD Al
スライド タイトルなし
 2012. 7. 9 窒化物半導体応用研究会 SiC パワー半導体の 研究開発動向 京都大学工学研究科電子工学専攻 木本恒暢 概要 1. SiCパワー半導体 2. SiCダイオードの進展 3. SiCスイッチングデバイスの進展 4. SiC 半導体の開発動向 5. まとめ 2 Rated Current (A) パワーデバイス パワーデバイス DC AC AC DC DC DC( 電圧変換 ) AC
2012. 7. 9 窒化物半導体応用研究会 SiC パワー半導体の 研究開発動向 京都大学工学研究科電子工学専攻 木本恒暢 概要 1. SiCパワー半導体 2. SiCダイオードの進展 3. SiCスイッチングデバイスの進展 4. SiC 半導体の開発動向 5. まとめ 2 Rated Current (A) パワーデバイス パワーデバイス DC AC AC DC DC DC( 電圧変換 ) AC
低損失V溝型SiCトレンチMOSFET 4H-SiC V-groove Trench MOSFETs with the Buried p+ regions
 エレクトロニクス 低損失 V 溝型 SiC トレンチ MOSFET 4H-SiC V-groove Trench MOSFETs with the Buried p + regions * 斎藤雄和田圭司日吉透 Yu Saitoh Keiji Wada Toru Hiyoshi 増田健良築野孝御神村泰樹 Takeyoshi Masuda Takashi Tsuno Yasuki Mikamura 我々はワイドバンドギャップ半導体である炭化珪素
エレクトロニクス 低損失 V 溝型 SiC トレンチ MOSFET 4H-SiC V-groove Trench MOSFETs with the Buried p + regions * 斎藤雄和田圭司日吉透 Yu Saitoh Keiji Wada Toru Hiyoshi 増田健良築野孝御神村泰樹 Takeyoshi Masuda Takashi Tsuno Yasuki Mikamura 我々はワイドバンドギャップ半導体である炭化珪素
スライド 1
 Matsuura Laboratory SiC SiC 13 2004 10 21 22 H-SiC ( C-SiC HOY Matsuura Laboratory n E C E D ( E F E T Matsuura Laboratory Matsuura Laboratory DLTS Osaka Electro-Communication University Unoped n 3C-SiC
Matsuura Laboratory SiC SiC 13 2004 10 21 22 H-SiC ( C-SiC HOY Matsuura Laboratory n E C E D ( E F E T Matsuura Laboratory Matsuura Laboratory DLTS Osaka Electro-Communication University Unoped n 3C-SiC
XP231P0201TR-j.pdf
 Pchannel MOSFET 3V,.2A JTR11381 特長オン抵抗 駆動電圧環境への配慮 : RDS(on)=5Ω@VGS =4.5V : 2.5V : EU RoHS 指令対応 鉛フリー 用途 スイッチング用 内部接続図 端子配列 SOT23(TO236) Drain Gate Source 製品名 PRODUCT NAME PACKAGE ORDER UNIT * SOT23(TO236)
Pchannel MOSFET 3V,.2A JTR11381 特長オン抵抗 駆動電圧環境への配慮 : RDS(on)=5Ω@VGS =4.5V : 2.5V : EU RoHS 指令対応 鉛フリー 用途 スイッチング用 内部接続図 端子配列 SOT23(TO236) Drain Gate Source 製品名 PRODUCT NAME PACKAGE ORDER UNIT * SOT23(TO236)
[NE ハンドブックシリーズ] パワー半導体
![[NE ハンドブックシリーズ] パワー半導体 [NE ハンドブックシリーズ] パワー半導体](/thumbs/94/120143912.jpg) NE Handbook Power Device NE ハンドブックシリーズパワー半導体 6 第 1 章パワー半導体の基礎 6 パワー半導体 9 パワー MOSFET 10 SJ パワー MOSFET 11 IGBT 12 Si の性能限界 13 次世代パワー半導体 17 SiC 基板 19 GaN 基板 21 SiC と GaN 22 第 2 章次世代パワー半導体の開発動向 22 SiC 製 SBD
NE Handbook Power Device NE ハンドブックシリーズパワー半導体 6 第 1 章パワー半導体の基礎 6 パワー半導体 9 パワー MOSFET 10 SJ パワー MOSFET 11 IGBT 12 Si の性能限界 13 次世代パワー半導体 17 SiC 基板 19 GaN 基板 21 SiC と GaN 22 第 2 章次世代パワー半導体の開発動向 22 SiC 製 SBD
内 容 1. パワーデバイスの基礎 1) パワーデバイスの仕事 2) 次世代パワーデバイス開発の位置づけ 2.SiC パワーデバイスの最新技術と課題 1) なぜ SiC が注目されているのか 2) 高温動作ができると何がいいのか 3)SiC-MOSFET の課題 4)SiC トレンチ MOSFET
 SiC GaN パワー半導体の最新技術 課題 ならびにデバイス評価技術の重要性 2016 年 7 月 12 日 筑波大学数理物質系物理工学域 教授岩室憲幸 1 内 容 1. パワーデバイスの基礎 1) パワーデバイスの仕事 2) 次世代パワーデバイス開発の位置づけ 2.SiC パワーデバイスの最新技術と課題 1) なぜ SiC が注目されているのか 2) 高温動作ができると何がいいのか 3)SiC-MOSFET
SiC GaN パワー半導体の最新技術 課題 ならびにデバイス評価技術の重要性 2016 年 7 月 12 日 筑波大学数理物質系物理工学域 教授岩室憲幸 1 内 容 1. パワーデバイスの基礎 1) パワーデバイスの仕事 2) 次世代パワーデバイス開発の位置づけ 2.SiC パワーデバイスの最新技術と課題 1) なぜ SiC が注目されているのか 2) 高温動作ができると何がいいのか 3)SiC-MOSFET
スライド 1
 パワーデバイスの故障解析 あらゆるサイズ 形状のダイオード MOS FET IGBT 等のパワーデバイスに対し最適な前処理を行い 裏面 IR-OBIRCH 解析や裏面発光解析により不良箇所を特定し観察いたします 解析の前処理 - 裏面研磨 - 平面研磨 各種サンプル形態に対応します Si チップサイズ :200um~15mm 角 ヒートシンク チップ封止樹脂パッケージ状態の裏面研磨 開封済みチップの裏面研磨
パワーデバイスの故障解析 あらゆるサイズ 形状のダイオード MOS FET IGBT 等のパワーデバイスに対し最適な前処理を行い 裏面 IR-OBIRCH 解析や裏面発光解析により不良箇所を特定し観察いたします 解析の前処理 - 裏面研磨 - 平面研磨 各種サンプル形態に対応します Si チップサイズ :200um~15mm 角 ヒートシンク チップ封止樹脂パッケージ状態の裏面研磨 開封済みチップの裏面研磨
1-2 原子層制御量子ナノ構造のコヒーレント量子効果 Coherent Quantum Effects in Quantum Nano-structure with Atomic Layer Precision Mutsuo Ogura, Research Director of CREST Pho
 1-2 原子層制御量子ナノ構造のコヒーレント量子効果 Coherent Quantum Effects in Quantum Nano-structure with Atomic Layer Precision Mutsuo Ogura, Research Director of CREST Photonics Research Institute, AIST TBAs) AlGaAs/GaAs TBAs)
1-2 原子層制御量子ナノ構造のコヒーレント量子効果 Coherent Quantum Effects in Quantum Nano-structure with Atomic Layer Precision Mutsuo Ogura, Research Director of CREST Photonics Research Institute, AIST TBAs) AlGaAs/GaAs TBAs)
600 V系スーパージャンクション パワーMOSFET TO-247-4Lパッケージのシミュレーションによる解析
 [17.7 White Paper] 6 V 系スーパージャンクションパワー MOSFET TO-247-4L パッケージのシミュレーションによる解析 MOSFET チップの高速スイッチング性能をより引き出すことができる 4 ピン新パッケージ TO-247-4L 背景 耐圧が 6V 以上の High Voltage(HV) パワー半導体ではオン抵抗と耐圧のトレードオフの改善を行うためスーパージャンクション
[17.7 White Paper] 6 V 系スーパージャンクションパワー MOSFET TO-247-4L パッケージのシミュレーションによる解析 MOSFET チップの高速スイッチング性能をより引き出すことができる 4 ピン新パッケージ TO-247-4L 背景 耐圧が 6V 以上の High Voltage(HV) パワー半導体ではオン抵抗と耐圧のトレードオフの改善を行うためスーパージャンクション
研究成果報告書
 ① ア ニ ー ル 温 度 の 違 い に よ る ナ ノ 構 造 制御 論文④ ⑤関連 シード層として Ti を用い Ag/Ti 薄膜を MgO(001)基板上に室温蒸着させた後にアニ ール処理を施す その際 アニール条件 温 度 時間 を変えた場合の基板上に形成され る Ag ナノ構造の変化について調べた Fig.1 の薄膜表面の原子間力顕微鏡 AFM 像に見られるように (a)ti シード層
① ア ニ ー ル 温 度 の 違 い に よ る ナ ノ 構 造 制御 論文④ ⑤関連 シード層として Ti を用い Ag/Ti 薄膜を MgO(001)基板上に室温蒸着させた後にアニ ール処理を施す その際 アニール条件 温 度 時間 を変えた場合の基板上に形成され る Ag ナノ構造の変化について調べた Fig.1 の薄膜表面の原子間力顕微鏡 AFM 像に見られるように (a)ti シード層
この講義のねらい ナノ 量子効果デバイス 前澤宏一 本講義は 超高速 超高周波デバイスの基盤となる化合物半導体 へテロ接合とそれを用いたデバイスに関して学ぶ 特に高電子移動度トランジスタ (HEMT) やヘテロバイポーラトランジスタ (HBT) などの超高速素子や これらを基礎とした将来デバイスであ
 この講義のねらい ナノ 量子効果デバイス 前澤宏一 本講義は 超高速 超高周波デバイスの基盤となる化合物半導体 へテロ接合とそれを用いたデバイスに関して学ぶ 特に高電子移動度トランジスタ (HEMT) やヘテロバイポーラトランジスタ (HBT) などの超高速素子や これらを基礎とした将来デバイスである 量子効果 ナノデバイスとその応用について学ぶ 2 年 量子力学 1,2 電子物性工学 1 半導体デバイス
この講義のねらい ナノ 量子効果デバイス 前澤宏一 本講義は 超高速 超高周波デバイスの基盤となる化合物半導体 へテロ接合とそれを用いたデバイスに関して学ぶ 特に高電子移動度トランジスタ (HEMT) やヘテロバイポーラトランジスタ (HBT) などの超高速素子や これらを基礎とした将来デバイスである 量子効果 ナノデバイスとその応用について学ぶ 2 年 量子力学 1,2 電子物性工学 1 半導体デバイス
研究の背景 世界のエネルギー消費量は年々増加傾向にあり, 地球規模のエネルギー不足が懸念さ れています このため, 発電により生み出したエネルギー ( 電力 ) の利用の更なる高効 率化が求められており, その鍵は電力制御を担っているパワーデバイス ( 6) が握っ ています 現在主流である Si(
 News Release 平成 30 年 4 月 27 日 各報道機関文教担当記者 殿 水蒸気とニッケルを用いた非プラズマプロセスによるダイヤモンドの高速 異方性エッチング技術を開発 金沢大学理工研究域電子情報通信学系の德田規夫准教授, 大学院自然科学研究科電子情報科学専攻博士後期課程の長井雅嗣氏らの研究グループ ( 薄膜電子工学研究室 ) は, 国立研究開発法人産業技術総合研究所先進パワーエレクトロニクス研究センターダイヤモンドデバイスチームの牧野俊晴研究チーム長,
News Release 平成 30 年 4 月 27 日 各報道機関文教担当記者 殿 水蒸気とニッケルを用いた非プラズマプロセスによるダイヤモンドの高速 異方性エッチング技術を開発 金沢大学理工研究域電子情報通信学系の德田規夫准教授, 大学院自然科学研究科電子情報科学専攻博士後期課程の長井雅嗣氏らの研究グループ ( 薄膜電子工学研究室 ) は, 国立研究開発法人産業技術総合研究所先進パワーエレクトロニクス研究センターダイヤモンドデバイスチームの牧野俊晴研究チーム長,
資料 GHz 以上の人体のばく露評価について 平田晃正 名古屋工業大学 生体電磁環境に関する検討会報告書 ( 案 ) 先進的な無線システムに関する電波防護について 解説資料からの抜粋
 資料 32-3 6GHz 以上の人体のばく露評価について 平田晃正 名古屋工業大学 生体電磁環境に関する検討会報告書 ( 案 ) 先進的な無線システムに関する電波防護について 解説資料からの抜粋 1. 局所 SAR と入射電力密度とのギャップ 2 我が国では 6 GHz から 300 GHz までの周波数において 電波放射源より 10 cm 未満における指針値はない 高い周波数帯については 電波の体内部への浸透が減って体表の吸収となるため
資料 32-3 6GHz 以上の人体のばく露評価について 平田晃正 名古屋工業大学 生体電磁環境に関する検討会報告書 ( 案 ) 先進的な無線システムに関する電波防護について 解説資料からの抜粋 1. 局所 SAR と入射電力密度とのギャップ 2 我が国では 6 GHz から 300 GHz までの周波数において 電波放射源より 10 cm 未満における指針値はない 高い周波数帯については 電波の体内部への浸透が減って体表の吸収となるため
...J......1803.QX
 5 7 9 11 13 15 17 19 21 23 45-1111 48-2314 1 I II 100,000 80,000 60,000 40,000 20,000 0 272,437 80,348 82,207 81,393 82,293 83,696 84,028 82,232 248,983 80,411 4,615 4,757 248,434 248,688 76,708 6,299
5 7 9 11 13 15 17 19 21 23 45-1111 48-2314 1 I II 100,000 80,000 60,000 40,000 20,000 0 272,437 80,348 82,207 81,393 82,293 83,696 84,028 82,232 248,983 80,411 4,615 4,757 248,434 248,688 76,708 6,299
スライド 1
 1 2017/8/3 GaN とほぼ格子整合する 新しい ITO 膜の形成技術 京都工芸繊維大学電気電子工学系 助教 西中浩之 2 発明の概要 ビックスバイト構造 (bcc-ito) 安定相 菱面体晶構造 (rh-ito) 準安定相 現在利用されている ITO は全て ビックスバイト構造もしくは非晶質 菱面体晶構造 (rh-ito) は合成に高圧が必要なため 作製例がほとんどなかった 新技術では この
1 2017/8/3 GaN とほぼ格子整合する 新しい ITO 膜の形成技術 京都工芸繊維大学電気電子工学系 助教 西中浩之 2 発明の概要 ビックスバイト構造 (bcc-ito) 安定相 菱面体晶構造 (rh-ito) 準安定相 現在利用されている ITO は全て ビックスバイト構造もしくは非晶質 菱面体晶構造 (rh-ito) は合成に高圧が必要なため 作製例がほとんどなかった 新技術では この
<4D F736F F F696E74202D2081A18E9197BF94D48D86352D E968CE3955D89BF C835B83938E9197BF81698CF68A4A81414E45444F95AA293
 パワーエレクトロニクスインバータ基盤技術開発プロジェクト ( 事後評価 ) 第 1 回分科会資料 5-2(1) IT イノベーションプログラム / エネルギーイノベーションプログラム パワーエレクトロニクスインバータ基盤技術開発 ( 事後評価 ) (2006 年度 ~2008 年度 3 年間 ) プロジェクトの概要 ( 公開 ) NEDO 技術開発機構電子 情報技術開発部三菱電機 新機能素子研究開発協会
パワーエレクトロニクスインバータ基盤技術開発プロジェクト ( 事後評価 ) 第 1 回分科会資料 5-2(1) IT イノベーションプログラム / エネルギーイノベーションプログラム パワーエレクトロニクスインバータ基盤技術開発 ( 事後評価 ) (2006 年度 ~2008 年度 3 年間 ) プロジェクトの概要 ( 公開 ) NEDO 技術開発機構電子 情報技術開発部三菱電機 新機能素子研究開発協会
( ) : 1997
 ( ) 2008 2 17 : 1997 CMOS FET AD-DA All Rights Reserved (c) Yoichi OKABE 2000-present. [ HTML ] [ PDF ] [ ] [ Web ] [ ] [ HTML ] [ PDF ] 1 1 4 1.1..................................... 4 1.2..................................
( ) 2008 2 17 : 1997 CMOS FET AD-DA All Rights Reserved (c) Yoichi OKABE 2000-present. [ HTML ] [ PDF ] [ ] [ Web ] [ ] [ HTML ] [ PDF ] 1 1 4 1.1..................................... 4 1.2..................................
PowerPoint プレゼンテーション
 第 61 回応用物理学会 青山学院大学相模原キャンパス 春季学術講演会 2014 年 3 月 18 日 ( 火曜日 ) La 2 O 3 /InGaAs 界面ラフネスに及ぼす ALD プロセスの影響 Impact of ALD process on La 2 O 3 /InGaAs interface roughness 大嶺洋 1,Dariush Hassan Zadeh 1, 角嶋邦之 2, 片岡好則
第 61 回応用物理学会 青山学院大学相模原キャンパス 春季学術講演会 2014 年 3 月 18 日 ( 火曜日 ) La 2 O 3 /InGaAs 界面ラフネスに及ぼす ALD プロセスの影響 Impact of ALD process on La 2 O 3 /InGaAs interface roughness 大嶺洋 1,Dariush Hassan Zadeh 1, 角嶋邦之 2, 片岡好則
化合物半導体デバイス―限りなき可能性を求めて(その2)―
 特別論文 化合物半導体デバイス 限りなき可能性を求めて ( その 2) 林秀樹 Development of Common Platform for ITS Devices II by Hideki Hayashi Many different compound semiconductors can be formed by changing the combination of constituent
特別論文 化合物半導体デバイス 限りなき可能性を求めて ( その 2) 林秀樹 Development of Common Platform for ITS Devices II by Hideki Hayashi Many different compound semiconductors can be formed by changing the combination of constituent
IGBT モジュール「V シリーズ」の系列化
 特集IGBT モジュール V シリーズ の系列化 New Lineup of V-Series IGBT Modules 高橋孝太 Kouta Takahashi 吉渡新一 Shinichi Yoshiwatari 関野裕介 Yusuke Sekino 富士電機では, 最新世代の Ⅴシリーズ IGBT を用いた製品の系列化を進めている Ⅴシリーズ IGBT モジュールは, チップ損失の低減とパッケージ放熱性の改善により,IGBT
特集IGBT モジュール V シリーズ の系列化 New Lineup of V-Series IGBT Modules 高橋孝太 Kouta Takahashi 吉渡新一 Shinichi Yoshiwatari 関野裕介 Yusuke Sekino 富士電機では, 最新世代の Ⅴシリーズ IGBT を用いた製品の系列化を進めている Ⅴシリーズ IGBT モジュールは, チップ損失の低減とパッケージ放熱性の改善により,IGBT
PowerPoint プレゼンテーション
 Drain Voltage (mv) 4 2 0-2 -4 0.0 0.2 0.4 0.6 0.8 1.0 Gate Voltage (V) Vds [V] 0.2 0.1 0.0-0.1-0.2-10 -8-6 -4-2 0 Vgs [V] 10 1000 1000 1000 1000 (LSI) Fe Catalyst Fe Catalyst Carbon nanotube 1~2 nm
Drain Voltage (mv) 4 2 0-2 -4 0.0 0.2 0.4 0.6 0.8 1.0 Gate Voltage (V) Vds [V] 0.2 0.1 0.0-0.1-0.2-10 -8-6 -4-2 0 Vgs [V] 10 1000 1000 1000 1000 (LSI) Fe Catalyst Fe Catalyst Carbon nanotube 1~2 nm
暫定資料 東芝フォトカプラ GaAlAs LED + フォト IC TLP250 TLP250 汎用インバータ エアコン用インバータ パワー MOS FET のゲートドライブ IGBT のゲートドライブ 単位 : mm TLP250 は GaAlAs 赤外発光ダイオードと 高利得 高速の集積回路受光
 暫定資料 東芝フォトカプラ GaAlAs LED + フォト IC 汎用インバータ エアコン用インバータ パワー MOS FET のゲートドライブ IGBT のゲートドライブ 単位 : mm は GaAlAs 赤外発光ダイオードと 高利得 高速の集積回路受光チップを組み合せた 8PIN DIP のフォトカプラです は IGBT およびパワー MOS FET のゲート駆動用に適しています 入力しきい値電流
暫定資料 東芝フォトカプラ GaAlAs LED + フォト IC 汎用インバータ エアコン用インバータ パワー MOS FET のゲートドライブ IGBT のゲートドライブ 単位 : mm は GaAlAs 赤外発光ダイオードと 高利得 高速の集積回路受光チップを組み合せた 8PIN DIP のフォトカプラです は IGBT およびパワー MOS FET のゲート駆動用に適しています 入力しきい値電流
AN504 Through-hole IRED/Right Angle Type 特長 パッケージ 製品の特長 φ3.6 サイドビュ - タイプ 無色透明樹脂 光出力 : 5mW TYP. (I F =50mA) 鉛フリーはんだ耐熱対応 RoHS 対応 ピーク発光波長指向半値角素子材質ランク選別はん
 特長 パッケージ 製品の特長 φ3.6 サイドビュ - タイプ 無色透明樹脂 光出力 : 5mW TYP. (I F =50mA) 鉛フリーはんだ耐熱対応 RoHS 対応 ピーク発光波長指向半値角素子材質ランク選別はんだ付け方法 ESD 出荷形態 950nm 60 deg. GaAs 放射強度選別を行い ランクごとに選別 半田ディップ マニュアルはんだ実装工程に対応 はんだ付けについては はんだ付け条件をご参照ください
特長 パッケージ 製品の特長 φ3.6 サイドビュ - タイプ 無色透明樹脂 光出力 : 5mW TYP. (I F =50mA) 鉛フリーはんだ耐熱対応 RoHS 対応 ピーク発光波長指向半値角素子材質ランク選別はんだ付け方法 ESD 出荷形態 950nm 60 deg. GaAs 放射強度選別を行い ランクごとに選別 半田ディップ マニュアルはんだ実装工程に対応 はんだ付けについては はんだ付け条件をご参照ください
サーマルプリントヘッド
 サーマルプリントヘッドモジュール サーマルプリントヘッド CONTENTS ロームの基本技術 P. 14 サーマルプリントヘッドセレクションガイド P. 15 ファクシミリ用 Aシリーズ P. 16 モバイルプリンタ用 Bシリーズ P. 16 アミューズメント ATM 用 C CGシリーズ P. 17 POS 端末用 D DGシリーズ P. 18 チケット 計量器用 DC92 DC72シリーズ P.
サーマルプリントヘッドモジュール サーマルプリントヘッド CONTENTS ロームの基本技術 P. 14 サーマルプリントヘッドセレクションガイド P. 15 ファクシミリ用 Aシリーズ P. 16 モバイルプリンタ用 Bシリーズ P. 16 アミューズメント ATM 用 C CGシリーズ P. 17 POS 端末用 D DGシリーズ P. 18 チケット 計量器用 DC92 DC72シリーズ P.
研究成果報告書
 10m 2m Ge Si BaF2 ZnSZnSe Sb-Ge-Sn-S IIR-SF1 1 2 Tungsten SilicideWSi WSi () IIR-SF 1 Sb-Ge-Sn-S 0.85~11μm2.710μm 253 C Al Al 220μm He-Cd laser 1 Exposure Photoresist WSi (a) 500 nm Development RIE WSi
10m 2m Ge Si BaF2 ZnSZnSe Sb-Ge-Sn-S IIR-SF1 1 2 Tungsten SilicideWSi WSi () IIR-SF 1 Sb-Ge-Sn-S 0.85~11μm2.710μm 253 C Al Al 220μm He-Cd laser 1 Exposure Photoresist WSi (a) 500 nm Development RIE WSi
37. 7, 3] 65 縺 縺 縺 ィ
![37. 7, 3] 65 縺 縺 縺 ィ 37. 7, 3] 65 縺 縺 縺 ィ](/thumbs/51/27402331.jpg) 3379 3. 753 7, 3 86 タ7 9 9989769 438 4 縺4775697 799 タ 99897 ィャ 998 67547 4957 ィ チ チ59 5. 967357 PACS numbers: 67.9.+z, 73.4.Hm (455589 599. 6953583, 4579 998 3.) 654577495. 5545495 (34).. 6357475 ィ 59754475
3379 3. 753 7, 3 86 タ7 9 9989769 438 4 縺4775697 799 タ 99897 ィャ 998 67547 4957 ィ チ チ59 5. 967357 PACS numbers: 67.9.+z, 73.4.Hm (455589 599. 6953583, 4579 998 3.) 654577495. 5545495 (34).. 6357475 ィ 59754475
Micro Fans & Blowers Innovation in Motion マイクロファン & ブロワー 有限会社シーエス技研 PTB 事業部東京オフィス 千葉県市原市辰巳台西
 www.pelonistechnologies.com Innovation in Motion マイクロファン & ブロワー 有限会社シーエス技研 PTB 事業部東京オフィス 290-0004 千葉県市原市辰巳台西 4-13-1-9-1 104-0041 東京都中央区新富 1-5-5-406 Tel:0436-98-2341 Fax:0436-98-2336 Tel:03-3206-6832 Fax:03-3206-6829
www.pelonistechnologies.com Innovation in Motion マイクロファン & ブロワー 有限会社シーエス技研 PTB 事業部東京オフィス 290-0004 千葉県市原市辰巳台西 4-13-1-9-1 104-0041 東京都中央区新富 1-5-5-406 Tel:0436-98-2341 Fax:0436-98-2336 Tel:03-3206-6832 Fax:03-3206-6829
Acrobat Distiller, Job 2
 2 3 4 5 Eg φm s M f 2 qv ( q qφ ) = qφ qχ + + qφ 0 0 = 6 p p ( Ei E f ) kt = n e i Q SC = qn W A n p ( E f Ei ) kt = n e i 7 8 2 d φ( x) qn = A 2 dx ε ε 0 s φ qn s 2ε ε A ( x) = ( x W ) 2 0 E s A 2 EOX
2 3 4 5 Eg φm s M f 2 qv ( q qφ ) = qφ qχ + + qφ 0 0 = 6 p p ( Ei E f ) kt = n e i Q SC = qn W A n p ( E f Ei ) kt = n e i 7 8 2 d φ( x) qn = A 2 dx ε ε 0 s φ qn s 2ε ε A ( x) = ( x W ) 2 0 E s A 2 EOX
低転位GaN 基板上縦型トランジスタの開発
 エレクトロニクス 低転位 GaN 基板上縦型トランジスタの開発 岡 田 政 也 * 斎 藤 雄 横 山 満 徳 中 田 健 八重樫 誠 司 片 山 浩 二 上 野 昌 紀 木 山 誠 勝 山 造 中 村 孝 夫 Development of Vertical Heterojunction Field-Effect Transistors on Low Dislocation Density GaN
エレクトロニクス 低転位 GaN 基板上縦型トランジスタの開発 岡 田 政 也 * 斎 藤 雄 横 山 満 徳 中 田 健 八重樫 誠 司 片 山 浩 二 上 野 昌 紀 木 山 誠 勝 山 造 中 村 孝 夫 Development of Vertical Heterojunction Field-Effect Transistors on Low Dislocation Density GaN
NJM78L00S 3 端子正定電圧電源 概要 NJM78L00S は Io=100mA の 3 端子正定電圧電源です 既存の NJM78L00 と比較し 出力電圧精度の向上 動作温度範囲の拡大 セラミックコンデンサ対応および 3.3V の出力電圧もラインアップしました 外形図 特長 出力電流 10
 端子正定電圧電源 概要 は Io=mA の 端子正定電圧電源です 既存の NJM78L と比較し 出力電圧精度の向上 動作温度範囲の拡大 セラミックコンデンサ対応および.V の出力電圧もラインアップしました 外形図 特長 出力電流 ma max. 出力電圧精度 V O ±.% 高リップルリジェクション セラミックコンデンサ対応 過電流保護機能内蔵 サーマルシャットダウン回路内蔵 電圧ランク V,.V,
端子正定電圧電源 概要 は Io=mA の 端子正定電圧電源です 既存の NJM78L と比較し 出力電圧精度の向上 動作温度範囲の拡大 セラミックコンデンサ対応および.V の出力電圧もラインアップしました 外形図 特長 出力電流 ma max. 出力電圧精度 V O ±.% 高リップルリジェクション セラミックコンデンサ対応 過電流保護機能内蔵 サーマルシャットダウン回路内蔵 電圧ランク V,.V,
DMシリーズセンダスト (Fe-Si-Al) コイルの許容両端電圧 :V D はんだ処理部最大外径 :D( 縦方向 ),( 横方向 ) 最大幅 : リード全長 :=± はんだ処理境界 :=.MAX コイル品番 HDM24AQDVE 定格電流インダクタンス (khz ) 最大直流抵抗巻線仕様外形寸法
 DM シリーズ 主な用途 スイッチング電源出力平滑用チョーク DC-DC コンバータ用チョーク ノイズ対策用ノーマルモードチョーク 力率改善回路用チョーク 特長 周波数特性 温度特性に優れています フェライトに比べて 飽和磁束密度が高いため 直流重畳特性が良く 小形化できます コアの電流重畳特性 () 9 8 コアの電流重畳特性 (2) 9 8 Percent permebility [%] 7 6
DM シリーズ 主な用途 スイッチング電源出力平滑用チョーク DC-DC コンバータ用チョーク ノイズ対策用ノーマルモードチョーク 力率改善回路用チョーク 特長 周波数特性 温度特性に優れています フェライトに比べて 飽和磁束密度が高いため 直流重畳特性が良く 小形化できます コアの電流重畳特性 () 9 8 コアの電流重畳特性 (2) 9 8 Percent permebility [%] 7 6
2006122 2/13
 2006122 HEMT IT 1/13 2006122 2/13 2006122 3/13 2006122 4/13 2006122 5/13 2006122 Dingle 9 GaAs 6/13 2006122 7/13 2006122 8/13 2006122 9/13 2006122 10/13 2006122 4 11/13 2006122 GaAs MOSFET HEMT HEMT MBE
2006122 HEMT IT 1/13 2006122 2/13 2006122 3/13 2006122 4/13 2006122 5/13 2006122 Dingle 9 GaAs 6/13 2006122 7/13 2006122 8/13 2006122 9/13 2006122 10/13 2006122 4 11/13 2006122 GaAs MOSFET HEMT HEMT MBE
<4D F736F F F696E74202D F C51946E91E58A DB8DE290E690B62E707074>
 相変化ランダムアクセスメモリ素子 (PRAM) の結晶化過程を用いた 多値記録素子 研究者 : 群馬大学大学院工学研究科 教授保坂純男 内容 1. 研究背景とアプローチ 2. PRAM の原理と課題 3. 低消費電力化 4. 結晶化過程の多値記録 5. 実験結果とまとめ 背景 メモリの特性 FeRAM MRAM PRAM DRAM フラッシュ 不揮発性 書き込み時間 80ns 30ns 50ns 100ms
相変化ランダムアクセスメモリ素子 (PRAM) の結晶化過程を用いた 多値記録素子 研究者 : 群馬大学大学院工学研究科 教授保坂純男 内容 1. 研究背景とアプローチ 2. PRAM の原理と課題 3. 低消費電力化 4. 結晶化過程の多値記録 5. 実験結果とまとめ 背景 メモリの特性 FeRAM MRAM PRAM DRAM フラッシュ 不揮発性 書き込み時間 80ns 30ns 50ns 100ms
fma20.PDF
 PZT TSC Measurement for Degraded and Damaged PZT Thin Films Capacitors Prepared by Sputtering. FeRAM MFIS : XRD, TEM : XRF, EDS, EPMA, SIMS : SPM, NDM? DLTS DLTS (TSC) (TSC) fatigue,, ( ) (1) (2) J T TSC
PZT TSC Measurement for Degraded and Damaged PZT Thin Films Capacitors Prepared by Sputtering. FeRAM MFIS : XRD, TEM : XRF, EDS, EPMA, SIMS : SPM, NDM? DLTS DLTS (TSC) (TSC) fatigue,, ( ) (1) (2) J T TSC
支援財団研究活動助成 生体超分子を利用利用した 3 次元メモリデバイスメモリデバイスの研究 奈良先端科学技術大学院大学物質創成科学研究科小原孝介
 2009.3.10 支援財団研究活動助成 生体超分子を利用利用した 3 次元メモリデバイスメモリデバイスの研究 奈良先端科学技術大学院大学物質創成科学研究科小原孝介 研究背景研究背景研究背景研究背景データデータデータデータの種類種類種類種類データデータデータデータの保存保存保存保存パソコンパソコンパソコンパソコンパソコンパソコンパソコンパソコンデータデータデータデータデータデータデータデータ音楽音楽音楽音楽音楽音楽音楽音楽写真写真写真写真記録媒体記録媒体記録媒体記録媒体フラッシュメモリフラッシュメモリフラッシュメモリフラッシュメモリ動画動画動画動画
2009.3.10 支援財団研究活動助成 生体超分子を利用利用した 3 次元メモリデバイスメモリデバイスの研究 奈良先端科学技術大学院大学物質創成科学研究科小原孝介 研究背景研究背景研究背景研究背景データデータデータデータの種類種類種類種類データデータデータデータの保存保存保存保存パソコンパソコンパソコンパソコンパソコンパソコンパソコンパソコンデータデータデータデータデータデータデータデータ音楽音楽音楽音楽音楽音楽音楽音楽写真写真写真写真記録媒体記録媒体記録媒体記録媒体フラッシュメモリフラッシュメモリフラッシュメモリフラッシュメモリ動画動画動画動画
TITAN マルチコンタクト プローブ TITAN マルチコンタクト プローブは MPI の独自の TITAN RF プロービング技術をさらに発展させた RF/ マイクロ波デバイス特性評価用プローブです 最大 15 コンタクトまでのプロービングが可能で 各コンタクトは RF ロジック バイパス電源の
 TITAN マルチコンタクト プローブ TITAN マルチコンタクト プローブは MPI の独自の TITAN RF プロービング技術をさらに発展させた RF/ マイクロ波デバイス特性評価用プローブです 最大 5 コンタクトまでのプロービングが可能で 各コンタクトは RF ロジック バイパス電源の中から選択可能です TITAN プローブのもつ優れたインピーダンス整合 電気特性 チップの視認性 長寿命をすべて兼ね備えています
TITAN マルチコンタクト プローブ TITAN マルチコンタクト プローブは MPI の独自の TITAN RF プロービング技術をさらに発展させた RF/ マイクロ波デバイス特性評価用プローブです 最大 5 コンタクトまでのプロービングが可能で 各コンタクトは RF ロジック バイパス電源の中から選択可能です TITAN プローブのもつ優れたインピーダンス整合 電気特性 チップの視認性 長寿命をすべて兼ね備えています
2θχ/φ scan λ= å Al 2 (11-20) Intensity (a. u.) ZnO(<1nm)/MgO(0.8nm)/Al 2 MgO(0.8nm)/Al 2 WZ-MgO(10-10) a=3.085å MgZnO(10-10) a=3.101å
 MgO/c-Al 2 界面構造解析 課題番号 2005B0434 利用ビームライン BL13XU 東北大学金属材料研究所博士課程後期 3 年の過程 2 年嶺岸耕 1. 背景 ZnO は直接遷移型のワイドギャップ半導体で バンドギャップは室温で 3.37eV 光の波長に換算すると 368nm と紫外域にあることから貸し領域で透明である この性質を利用して紫外域での発光素子としての応用に関する研究 [1-3]
MgO/c-Al 2 界面構造解析 課題番号 2005B0434 利用ビームライン BL13XU 東北大学金属材料研究所博士課程後期 3 年の過程 2 年嶺岸耕 1. 背景 ZnO は直接遷移型のワイドギャップ半導体で バンドギャップは室温で 3.37eV 光の波長に換算すると 368nm と紫外域にあることから貸し領域で透明である この性質を利用して紫外域での発光素子としての応用に関する研究 [1-3]
修士論文
 SAW 14 2 M3622 i 1 1 1-1 1 1-2 2 1-3 2 2 3 2-1 3 2-2 5 2-3 7 2-3-1 7 2-3-2 2-3-3 SAW 12 3 13 3-1 13 3-2 14 4 SAW 19 4-1 19 4-2 21 4-2-1 21 4-2-2 22 4-3 24 4-4 35 5 SAW 36 5-1 Wedge 36 5-1-1 SAW 36 5-1-2
SAW 14 2 M3622 i 1 1 1-1 1 1-2 2 1-3 2 2 3 2-1 3 2-2 5 2-3 7 2-3-1 7 2-3-2 2-3-3 SAW 12 3 13 3-1 13 3-2 14 4 SAW 19 4-1 19 4-2 21 4-2-1 21 4-2-2 22 4-3 24 4-4 35 5 SAW 36 5-1 Wedge 36 5-1-1 SAW 36 5-1-2
<4D F736F F F696E74202D AC89CA95F18D9089EF975C8D658F F43945A A CC8A4A94AD298F4390B394C5205B8CDD8AB B83685D>
 小型 低消費電力を実現するグリーン MEMS センサの開発 センサネットワーク用 VOC( 揮発性有機化合物 ) 濃度センサの開発 オリンパス株式会社白石直規 発表内容 OUTLINE 1. 背景と目的 2. 開発項目と目標 3. 開発の成果 4. ネットワーク 応用分野 5. まとめ 1. 背景と目的 VOCとは VOC(volatile organic compounds 揮発性有機化合物) とは
小型 低消費電力を実現するグリーン MEMS センサの開発 センサネットワーク用 VOC( 揮発性有機化合物 ) 濃度センサの開発 オリンパス株式会社白石直規 発表内容 OUTLINE 1. 背景と目的 2. 開発項目と目標 3. 開発の成果 4. ネットワーク 応用分野 5. まとめ 1. 背景と目的 VOCとは VOC(volatile organic compounds 揮発性有機化合物) とは
Microsoft Word - sp8m4-j.doc
 4V 駆動タイプ Nch+Pch MOS FET 構造シリコン N チャネル / P チャネル MOS 型電界効果トランジスタ 外形寸法図 (Unit : mm) SOP8 5..4.75 (8) (5) 特長 ) 新ライン採用により 従来品よりオン抵抗大幅低減 2) ゲート保護ダイオード内蔵 3) 小型面実装パッケージ (SOP8) で省スペース pin mark () (4).27 3.9 6..2.4Min.
4V 駆動タイプ Nch+Pch MOS FET 構造シリコン N チャネル / P チャネル MOS 型電界効果トランジスタ 外形寸法図 (Unit : mm) SOP8 5..4.75 (8) (5) 特長 ) 新ライン採用により 従来品よりオン抵抗大幅低減 2) ゲート保護ダイオード内蔵 3) 小型面実装パッケージ (SOP8) で省スペース pin mark () (4).27 3.9 6..2.4Min.
TLP521-1,TLP521-2,TLP521-4 東芝フォトカプラ赤外 LED + フォトトランジスタ TLP521-1,TLP521-2,TLP521-4 電子計算機の I / O インタフェース システム機器や計測器のノイズカット 各種コントローラ 複写機 自動販売機 電位が異なる回路間の信
 東芝フォトカプラ赤外 LED + フォトトランジスタ 電子計算機の I / O インタフェース システム機器や計測器のノイズカット 各種コントローラ 複写機 自動販売機 電位が異なる回路間の信号伝達 単位 : mm TLP521 シリーズは GaAs 赤外 LED とシリコンフォトトランジスタを組 み合わせた高密度実装タイプのフォトカプラです TLP521 1 DIP 4 ピン 1 回路 TLP521
東芝フォトカプラ赤外 LED + フォトトランジスタ 電子計算機の I / O インタフェース システム機器や計測器のノイズカット 各種コントローラ 複写機 自動販売機 電位が異なる回路間の信号伝達 単位 : mm TLP521 シリーズは GaAs 赤外 LED とシリコンフォトトランジスタを組 み合わせた高密度実装タイプのフォトカプラです TLP521 1 DIP 4 ピン 1 回路 TLP521
Microsoft PowerPoint - 応物シンポジウム201003ナノワイヤ21.ppt
 シリコンナノワイヤ pfet における正孔移動度 平本俊郎陳杰智, 更屋拓哉東京大学生産技術研究所 hiramoto@nano.iis.u-tokyo.ac.jp 1. ナノワイヤトランジスタの位置付け 2. ナノワイヤ FET の移動度測定 3. ナノワイヤ nfet と pfet の移動度 4. まとめ 本研究の一部は,NEDO のプロジェクト ナノエレクトロニクス半導体材利用 新構造なの電子デバイス技術開発
シリコンナノワイヤ pfet における正孔移動度 平本俊郎陳杰智, 更屋拓哉東京大学生産技術研究所 hiramoto@nano.iis.u-tokyo.ac.jp 1. ナノワイヤトランジスタの位置付け 2. ナノワイヤ FET の移動度測定 3. ナノワイヤ nfet と pfet の移動度 4. まとめ 本研究の一部は,NEDO のプロジェクト ナノエレクトロニクス半導体材利用 新構造なの電子デバイス技術開発
AN15880A
 DATA SHEET 品種名 パッケージコード QFH064-P-1414H 発行年月 : 2008 年 12 月 1 目次 概要.. 3 特長.. 3 用途.. 3 外形.. 3 構造...... 3 応用回路例.. 4 ブロック図.... 5 端子.. 6 絶対最大定格.. 8 動作電源電圧範囲.. 8 電気的特性. 9 電気的特性 ( 設計参考値 )... 10 技術資料.. 11 入出力部の回路図および端子機能の
DATA SHEET 品種名 パッケージコード QFH064-P-1414H 発行年月 : 2008 年 12 月 1 目次 概要.. 3 特長.. 3 用途.. 3 外形.. 3 構造...... 3 応用回路例.. 4 ブロック図.... 5 端子.. 6 絶対最大定格.. 8 動作電源電圧範囲.. 8 電気的特性. 9 電気的特性 ( 設計参考値 )... 10 技術資料.. 11 入出力部の回路図および端子機能の
NJG1815K75 SPDT スイッチ GaAs MMIC 概要 NJG1815K75 は無線 LAN システムに最適な 1 ビットコントロール SPDT スイッチです 本製品は 1.8V の低切替電圧に対応し 高帯域 6GHz での低損入損失と高アイソレーション特性を特長とします また 保護素子
 SPDT スイッチ GaAs MMIC 概要 は無線 LAN システムに最適な 1 ビットコントロール SPDT スイッチです 本製品は 1. の低切替電圧に対応し 高帯域 6GHz での低損入損失と高アイソレーション特性を特長とします また 保護素子を内蔵することにより高い ESD 耐圧を有します は RF ポートの DC カットキャパシタを内蔵しています また 超小型 薄型 DFN6-75 パッケージの採用により実装面積の削減に貢献します
SPDT スイッチ GaAs MMIC 概要 は無線 LAN システムに最適な 1 ビットコントロール SPDT スイッチです 本製品は 1. の低切替電圧に対応し 高帯域 6GHz での低損入損失と高アイソレーション特性を特長とします また 保護素子を内蔵することにより高い ESD 耐圧を有します は RF ポートの DC カットキャパシタを内蔵しています また 超小型 薄型 DFN6-75 パッケージの採用により実装面積の削減に貢献します
C-2 NiS A, NSRRC B, SL C, D, E, F A, B, Yen-Fa Liao B, Ku-Ding Tsuei B, C, C, D, D, E, F, A NiS 260 K V 2 O 3 MIT [1] MIT MIT NiS MIT NiS Ni 3 S 2 Ni
![C-2 NiS A, NSRRC B, SL C, D, E, F A, B, Yen-Fa Liao B, Ku-Ding Tsuei B, C, C, D, D, E, F, A NiS 260 K V 2 O 3 MIT [1] MIT MIT NiS MIT NiS Ni 3 S 2 Ni C-2 NiS A, NSRRC B, SL C, D, E, F A, B, Yen-Fa Liao B, Ku-Ding Tsuei B, C, C, D, D, E, F, A NiS 260 K V 2 O 3 MIT [1] MIT MIT NiS MIT NiS Ni 3 S 2 Ni](/thumbs/89/99121913.jpg) M (emu/g) C 2, 8, 9, 10 C-1 Fe 3 O 4 A, SL B, NSRRC C, D, E, F A, B, B, C, Yen-Fa Liao C, Ku-Ding Tsuei C, D, D, E, F, A Fe 3 O 4 120K MIT V 2 O 3 MIT Cu-doped Fe3O4 NCs MIT [1] Fe 3 O 4 MIT Cu V 2 O 3
M (emu/g) C 2, 8, 9, 10 C-1 Fe 3 O 4 A, SL B, NSRRC C, D, E, F A, B, B, C, Yen-Fa Liao C, Ku-Ding Tsuei C, D, D, E, F, A Fe 3 O 4 120K MIT V 2 O 3 MIT Cu-doped Fe3O4 NCs MIT [1] Fe 3 O 4 MIT Cu V 2 O 3
S帯600W, X帯200Wを実現したレーダー送信機用GaN HEMT
 情報通信 S 帯 600W, X 帯 200W を実現したレーダー送信機用 GaN HEMT S-Band 600 W GaN HEMT and X-Band 200 W GaN HEMT for Radar Applications 宮澤 * 直行 西原信 宇佐美邦博 Naoyuki Miyazawa Makoto Nishihara Kunihiro Usami 青嶋真山本高史 Makoto Aojima
情報通信 S 帯 600W, X 帯 200W を実現したレーダー送信機用 GaN HEMT S-Band 600 W GaN HEMT and X-Band 200 W GaN HEMT for Radar Applications 宮澤 * 直行 西原信 宇佐美邦博 Naoyuki Miyazawa Makoto Nishihara Kunihiro Usami 青嶋真山本高史 Makoto Aojima
資料2-8 ドシメトリに関する研究動向
 資料 2-8 ドシメトリに関する研究動向 名古屋工業大学平田晃正 平成 26 年 7 月 14 日 ガイドラインにおける評価指標とドシメトリ 低周波 中間周波 体内誘導電界 / 準静近似による解析 総務省防護指針 (10-100kHz) ICNIRPガイドライン (2010.100 khz, 刺激作用は10MHzまで ) IEEE 高周波 比吸収率 (SAR) 電力密度 /Full-wave による解析
資料 2-8 ドシメトリに関する研究動向 名古屋工業大学平田晃正 平成 26 年 7 月 14 日 ガイドラインにおける評価指標とドシメトリ 低周波 中間周波 体内誘導電界 / 準静近似による解析 総務省防護指針 (10-100kHz) ICNIRPガイドライン (2010.100 khz, 刺激作用は10MHzまで ) IEEE 高周波 比吸収率 (SAR) 電力密度 /Full-wave による解析
SiC JFET による高速スイッチング電源
 エレクトロニクス S i C J F E T による高速スイッチング電源 初 川 聡 * 築 野 孝 藤 川 一 洋 志 賀 信 夫 ウリントヤ 和 田 和 千 大 平 孝 High-Speed Switching Power Supply Using SiC RESURF JFETs by Satoshi Hatsukawa, Takashi Tsuno, Kazuhiro Fujikawa, Nobuo
エレクトロニクス S i C J F E T による高速スイッチング電源 初 川 聡 * 築 野 孝 藤 川 一 洋 志 賀 信 夫 ウリントヤ 和 田 和 千 大 平 孝 High-Speed Switching Power Supply Using SiC RESURF JFETs by Satoshi Hatsukawa, Takashi Tsuno, Kazuhiro Fujikawa, Nobuo
事例8_ホール素子
 省エネルギーその 7- ホール素子 ホール IC 1. 調査の目的エアコンの室内機と室外機には空調を行うための FAN 用のモータが搭載されている モータには DC ブラシレスモータと AC モータ ( 誘導モータ ) とがある DC ブラシレスモータを搭載したエアコンはインバータエアコンと呼ばれ 電力の周波数を変えてモータの回転数を制御できることから 非インバータエアコン (AC モータを搭載 )
省エネルギーその 7- ホール素子 ホール IC 1. 調査の目的エアコンの室内機と室外機には空調を行うための FAN 用のモータが搭載されている モータには DC ブラシレスモータと AC モータ ( 誘導モータ ) とがある DC ブラシレスモータを搭載したエアコンはインバータエアコンと呼ばれ 電力の周波数を変えてモータの回転数を制御できることから 非インバータエアコン (AC モータを搭載 )
NJG1660HA8 SPDT スイッチ GaAs MMIC 概要 NJG1660HA8 は WiMAX やデータ通信カードをはじめとする通信機器の高周波信号切り替え等の用途に最適な大電力 SPDT スイッチです 8GHz までの広周波数帯域をカバーし 高パワーハンドリング 低損失 高アイソレーショ
 SPDT スイッチ GaAs MMIC 概要 は WiMAX やデータ通信カードをはじめとする通信機器の高周波信号切り替え等の用途に最適な大電力 SPDT スイッチです 8GHz までの広周波数帯域をカバーし 高パワーハンドリング 低損失 高アイソレーションを特徴とします また 保護素子を内蔵する事により高い ESD 耐圧を有しています USB-A8 パッケージを採用する事で小型 薄型化を実現し 低背化や高密度表面実装が必要な小型通信機器などへの応用が可能です
SPDT スイッチ GaAs MMIC 概要 は WiMAX やデータ通信カードをはじめとする通信機器の高周波信号切り替え等の用途に最適な大電力 SPDT スイッチです 8GHz までの広周波数帯域をカバーし 高パワーハンドリング 低損失 高アイソレーションを特徴とします また 保護素子を内蔵する事により高い ESD 耐圧を有しています USB-A8 パッケージを採用する事で小型 薄型化を実現し 低背化や高密度表面実装が必要な小型通信機器などへの応用が可能です
スライド 1
 Codes Technologies 2 1 日本で販売されております蛍光灯の種類は沢山ありますので お客様のご要望のものをご提供いたします LED 蛍光灯をご購入前にご確認下さい 節電タイプの LED 蛍光灯は 中国 台湾または韓国製品です.LED は日亜または CREE ですが製造は 中国 韓国 台湾メーカーです 節電タイプ LED 蛍光灯は通常の蛍光灯より若干青く光ります 右下の画像をご覧下さい左が
Codes Technologies 2 1 日本で販売されております蛍光灯の種類は沢山ありますので お客様のご要望のものをご提供いたします LED 蛍光灯をご購入前にご確認下さい 節電タイプの LED 蛍光灯は 中国 台湾または韓国製品です.LED は日亜または CREE ですが製造は 中国 韓国 台湾メーカーです 節電タイプ LED 蛍光灯は通常の蛍光灯より若干青く光ります 右下の画像をご覧下さい左が
 学位論文題目 Title 氏名 Author 専攻分野 Degree 学位授与の日付 Date of Degree Resource Type 報告番号 Report Number URL Kobe University Repository : Thesis 有機強誘電体薄膜の構造 配向制御および焦電デバイス応用に関する研究 黒田, 雄介 博士 ( 工学 ) 2013-03-25 Thesis or
学位論文題目 Title 氏名 Author 専攻分野 Degree 学位授与の日付 Date of Degree Resource Type 報告番号 Report Number URL Kobe University Repository : Thesis 有機強誘電体薄膜の構造 配向制御および焦電デバイス応用に関する研究 黒田, 雄介 博士 ( 工学 ) 2013-03-25 Thesis or
記者発表資料
 2012 年 6 月 4 日 報道機関各位 東北大学流体科学研究所原子分子材料科学高等研究機構 高密度 均一量子ナノ円盤アレイ構造による高効率 量子ドット太陽電池の実現 ( シリコン量子ドット太陽電池において世界最高変換効率 12.6% を達成 ) < 概要 > 東北大学 流体科学研究所および原子分子材料科学高等研究機構 寒川教授グループはこの度 新しい鉄微粒子含有蛋白質 ( リステリアフェリティン
2012 年 6 月 4 日 報道機関各位 東北大学流体科学研究所原子分子材料科学高等研究機構 高密度 均一量子ナノ円盤アレイ構造による高効率 量子ドット太陽電池の実現 ( シリコン量子ドット太陽電池において世界最高変換効率 12.6% を達成 ) < 概要 > 東北大学 流体科学研究所および原子分子材料科学高等研究機構 寒川教授グループはこの度 新しい鉄微粒子含有蛋白質 ( リステリアフェリティン
圧電型加速度センサ Piezoelectric Acceleration sensor 特長 Features 圧電素子に圧電型セラミックを用いた加速度センサは 小型堅牢 高感度で広帯域を特長としております 従って 低い周波数の振動加速度から衝突の様な高い加速度の測定まで 各分野で 幅広く使用されて
 圧電型加速度センサ 小型タイプ φ3.5 5.85 2.5(H)mm 加速度 MAX100,000m/s 2 高温タイプ MAX250 小型 3 軸タイプ 8 7 5.5(H)mm Super miniature type φ3.5 5.85 2.5(H)mm 100,000m/s 2 High temperature resistance type MAX250 and Triaxial type
圧電型加速度センサ 小型タイプ φ3.5 5.85 2.5(H)mm 加速度 MAX100,000m/s 2 高温タイプ MAX250 小型 3 軸タイプ 8 7 5.5(H)mm Super miniature type φ3.5 5.85 2.5(H)mm 100,000m/s 2 High temperature resistance type MAX250 and Triaxial type
