Slide 1
|
|
|
- たしろう こやぎ
- 5 years ago
- Views:
Transcription
1 SPring-8 利用推進協議会第 4 回次世代先端デバイス研究会 / 第 13 回 SPring-8 先端利用技術ワークショップ AP 品川京急第 2 ビル 先進パワーデバイスにおける 新規ゲート絶縁膜開発と 放射光利用 MOS 界面評価事例 大阪大学大学院工学研究科 渡部平司 転載不可 大阪大学大学院工学研究科渡部研究室 1/60
2 概要 ワイドバンドギャップ半導体パワーデバイス SiC パワーデバイス開発 - 熱酸化膜界面の構造欠陥評価 - SiO 2 /SiC 界面エネルギーバンド構造 - 窒化界面の評価と今後の課題 GaN-MOS デバイス開発 - AlGaN/GaN MOS-HFET 用堆積絶縁膜 - GaN 表面の熱酸化過程評価 - 極薄 GaO x 界面層による MOS 界面特性改善 まとめ 大阪大学大学院工学研究科渡部研究室 2/60
3 概要 ワイドバンドギャップ半導体パワーデバイス SiC パワーデバイス開発 - 熱酸化膜界面の構造欠陥評価 - SiO 2 /SiC 界面エネルギーバンド構造 - 窒化界面の評価と今後の課題 GaN-MOS デバイス開発 - AlGaN/GaN MOS-HFET 用堆積絶縁膜 - GaN 表面の熱酸化過程評価 - 極薄 GaO x 界面層による MOS 界面特性改善 まとめ 大阪大学大学院工学研究科渡部研究室 3/60
4 発電 変電 送電 研究背景 DC 1500V AC AC AC 100, 200V DC AC AC パワーデバイス : 電力変換 低損失 高温動作 LSI: 情報処理 高速動作 低消費電力 AC 100V DC 10~20V DC 3.3~12V 大阪大学大学院工学研究科渡部研究室 4/60
5 電力変換装置の例 ~ インバータ ~ インバータエアコン 室温 ON-OFF 制御設定温度インバータ制御時間 電気自動車 ハイブリッドカー 電圧 電圧 電圧 発電機エンジン 周波数変換 整流 AC DC インハ ータ DC AC モーター インバータ バッテリー DC~200V 大阪大学大学院工学研究科渡部研究室 5/60
6 インバータを構成するパワー半導体素子 整流素子とスイッチング素子から構成 スイッチング素子 ( トランジスタ ) 整流素子 ( ダイオード ) バッテリー モーター シリコンだと極限環境下で使用不可 & 材料物性で決まる性能限界に到達 大阪大学大学院工学研究科渡部研究室 6/60
7 シリコンカーバイド (SiC) の結晶構造 結晶構造 4H 6H 3C バンドギャップ (ev) 電子移動度 (cm 2 /Vs) 絶縁破壊電界 (MV/cm) 飽和ドリフト速度 (cm/s) 比誘電率 熱伝導率 (W/cmK) ウェハ供給 ( エピ成長含む ) と物性の観点から 4H が主流 C 原子 Si 原子 大阪大学大学院工学研究科渡部研究室 7/60
8 Si と SiC の物性比較 電子移動度 バンドギャップ Si 熱伝導率 SiC 高温安定動作 & 高冷却効率 (Si: 175 C, SiC: 300 C) 冷却機構小型化 熱源 ( エンシ ン モーター ) の近くに設置可能 低損失化 飽和ドリフト速度 絶縁破壊電界 高耐圧 (Siの10 倍 ) 大電流 さらに Si との類似点として 熱酸化による SiO 2 形成 ドーピングによる p/n 制御 大阪大学大学院工学研究科渡部研究室 8/60
9 SiC による低損失化 ~ 縦型 MOSFET~ DMOS トランジスタ Si ゲート ソース 絶縁膜 ソース p + n + n + p + p p Si と同耐圧で オン抵抗が 1/1000 電流 ドレイン n - -Si n + -Si 厚さ 1/10 キャリア濃度 100 倍 SiC ゲート ソース 絶縁膜 ソース p + n + n + p + p ドレイン p n - -SiC n + -SiC 大阪大学大学院工学研究科渡部研究室 9/60
10 概要 ワイドバンドギャップ半導体パワーデバイス SiC パワーデバイス開発 - 熱酸化膜界面の構造欠陥評価 - SiO 2 /SiC 界面エネルギーバンド構造 - 窒化界面の評価と今後の課題 GaN-MOS デバイス開発 - AlGaN/GaN MOS-HFET 用堆積絶縁膜 - GaN 表面の熱酸化過程評価 - 極薄 GaO x 界面層による MOS 界面特性改善 まとめ 大阪大学大学院工学研究科渡部研究室 10/60
11 熱酸化 SiC-MOS デバイスの課題 SiC-MOSFET source O 2 p SiC n + gate Metal SiO 2 n - I on n + source n + drain 熱酸化 p CO x SiO 2 SiC Normally-off スイッチングデバイス 熱酸化による SiO 2 ゲート絶縁膜形成 反転層チャネル移動度の劣化 ゲート絶縁膜信頼性劣化 ゲートリーク電流増大 ((000-1) C 面 ) 閾値低下と閾値変動の問題 界面欠陥 物理的要因 界面遷移層 炭素不純物 エピ層中結晶欠陥 MOS 界面のラフネス伝導帯オフセット減少 大阪大学大学院工学研究科渡部研究室 11/60
12 Peak mobility 熱酸化 SiO 2 ゲート絶縁膜の問題 Z-contrast image T.L. Biggerstaff et al., Appl. Phys. Lett. 95, (2009). Transition layer width Thick transition layer (~nm) C-rich layer (~20%) Correlation with mobility degradation in SiC-MOSFET EELS mapping Abrupt 4H-SiC/SiO 2 interface (MEIS) X. Zhun et al., Appl. Phys. Lett. 97, (2010). 大阪大学大学院工学研究科渡部研究室 12/60
13 放射光実験施設 (SPring-8 BL23SU) Ring 日本原子力研究開発機構吉越章隆博士 SPM 室 放射光 XPS LEED/SPM 複合分析 超音速分子線 ( 反応ガス ) 照射 真空アニール L/L 室 表面クリーニング室 反応分析室 大阪大学大学院工学研究科渡部研究室 13/60
14 光電子分光法による SiO 2 /Si 界面先行研究 Si2p 高分解能測定 スピン分離 (2p 3/2, 2p 1/2 ) サブオキサイド分離 (Si 1+ ~Si 3+ ) F. J. Himpsel et al., Phys. Rev. B38, 6084 (1988). SiO 2 /Si 界面の急峻性評価 原子層毎酸化反応 K. Ohishi and T. Hattori, Jpn. J. Appl. Phys. 33, L675 (1994). Si 2p spectra raw data intermediate state (Si 1+, Si 2+, Si 3+ ) B.G subtraction deconvolution (2p 3/2 ) 2p 3/2 + 2p 1/2 SiO 2 SiO 2 /Si 大阪大学大学院工学研究科渡部研究室 14/60
15 Intensity (arb. unit) Intensity (arb. unit) 熱酸化 SiO 2 /4H-SiC 界面の放射光 XPS 分析 H. Watanabe et al., Appl. Phys. Lett. 99, (2011). ウエット洗浄 4H-SiC(0001) Si (~30min) ( 例えば 10 分酸化 3.5nm( 電気特性評価 )) (a) Si 2p dry oxidation 30 min 10 min 3 min 1 min after cleaning Si-C bond (Si 2p 3/2 ) (b) Si 2p 3/2 SiC SiO 2 Si 1+ Si 3+ Si 2+ 1 min ox Binding Energy (ev) Binding Energy (ev) SiC-MOS 界面に厚い構造遷移層は存在しない ( 原子レベルで急峻 ) 大阪大学大学院工学研究科渡部研究室 15/60
16 熱酸化 SiO 2 /4H-SiC 界面の放射光 XPS 分析 H. Watanabe et al., Appl. Phys. Lett. 99, (2011). 炭素との結合に注目 ( ) Intensity (arb. unit) C 1s as-oxidized (contaminated) in-situ anneal C-Si bond Intensity (arb. unit) Intensity (arb. unit) Si2p/C1s as-epi thick oxide 1.52 C-C bonds adsorbate (contamination) C 0+ C 1s C-Si bulk Binding Energy (ev) Binding Energy (ev) Binding Energy(eV) 熱酸化 SiO 2 /SiC 界面は主に Si-O 結合で構成されている C-rich 層の存在は確認されない 大阪大学大学院工学研究科渡部研究室 16/60
17 Normalized Intensity 熱酸化 SiO 2 /SiC 界面の急峻性 Si2p 3/2 サブオキサイド成分の熱酸化膜厚依存性 (< 10nm) 3 [I sub-o (Si 1+ +Si 2+ +Si 3+ )] [I SiC (Si-C bulk)] H. Watanabe et al., Appl. Phys. Lett. 99, (2011). Intensity (arb. unit) Si 2p 3/2 SiO 2 : 3.5nm SiO 2 Si 3+ Si 2+ Si 1+ SiC 1 C 3.5 nm 5.7 nm Binding Energy (ev) SiO 2 /Si interface Oxidation Time (min) 大阪大学大学院工学研究科渡部研究室 17/60
18 Capacitance (F) SiC-MOS キャパシタの評価 Fabrication of SiC-MOS capacitor Dry oxidation C) Post oxidation C Gate electrode (Al) Back contact (Al) C-V measurement (@1MHz) Al SiO 2 4H-SiC SiC (Si-face) Al Fixed oxide charge (Q ox ) Flatband voltage (V FB ) shift Al SiO 2 ideal measured Interface state density (D it ) C-V slope (Terman method) SiC V FB Gate Voltage (V) 大阪大学大学院工学研究科渡部研究室 18/60
19 SiO 2 /SiC 界面電気特性の酸化膜厚依存性 SiC-MOSキャパシタのC-V 特性から界面欠陥準位密度 (D it ) と固定電荷 (Q ox ) を算出 8 Al pure-sio 2 (3~80 nm) n-type 4H-SiC Al pure-sio 2 H. Watanabe et al., Appl. Phys. Lett. 99, (2011). Flatband Voltage (V) Al/SiO 2 /SiC capacitor Oxide Thickness (nm) 大阪大学大学院工学研究科渡部研究室 19/60 D it cm -2 V fb Q ox = cm -2 熱酸化の進行に伴い電気特性を劣化させる界面欠陥が蓄積 ( 厚膜で特性劣化が顕著 微量の炭素クラスタが原因?) 10 1 D it ( cm -2 ev E c - E = 0.36 ev)
20 概要 ワイドバンドギャップ半導体パワーデバイス SiC パワーデバイス開発 - 熱酸化膜界面の構造欠陥評価 - SiO 2 /SiC 界面エネルギーバンド構造 - 窒化界面の評価と今後の課題 GaN-MOS デバイス開発 - AlGaN/GaN MOS-HFET 用堆積絶縁膜 - GaN 表面の熱酸化過程評価 - 極薄 GaO x 界面層による MOS 界面特性改善 まとめ 大阪大学大学院工学研究科渡部研究室 20/60
21 C 面に形成した SiC-MOSFET の課題 4H-SiC の結晶構造 4H-SiC 構造 (11-20) Si 面 (0001) C 面上の SiC-MOSFET 高チャネル移動度 ( 50 cm 2 /Vs) T. Kimoto et al., Jpn. J. Appl. Phys. 44, 3 (2005). 最表面に Si 原子 C 面に形成した MOS キャパシタ 2.5 Å SiO 2 Al A e - 最表面に C 原子 2.5A 4H-SiC Al C 面 (000-1) Si 原子 C 原子 <11-20> 酸化膜の信頼性劣化が顕著 T. Hatakeyama et al., Mat. Sci. Forum , 783 (2009). C 面に形成した SiO 2 絶縁膜の信頼性劣化要因の解明が必要 大阪大学大学院工学研究科渡部研究室 21/60
22 エネルギーバンド構造評価手法 SiO 2 /SiC 界面の伝導帯オフセット評価 放射光 XPS 利用 E g SiO 2 4H- SiC E c 3.26 ev h E V.L. バンドギャップ 1 = E g 2 E g E c E v 価電子帯オフセット V.L. h 2 1 Ec Ev E v Energy loss signal (measured) E c =E g - E v ev 2 E g K.E. 2 1 B.E. 0 E v 大阪大学大学院工学研究科渡部研究室 22/60
23 SiO 2 /SiC 界面のエネルギーバンド構造評価 Intensity (arb. unit) SiO 2 (3nm)/4H-SiC O 1sエネルギー損失スペクトル Intensity (arb. unit) C-face Si-face 8.7 ev TOA = Loss Energy (ev) 文献値 (8.9 ~ 9.0 ev) とほぼ一致 Si 面と C 面で違いはない E C (Si 面 : 2.69 ev C 面 : 2.29 ev) C 面の方が E C が 0.4 ev 小さい H. Watanabe et al., Mater. Sci. Forum , 386 (2011) SiC 1-2 2SiC 価電子帯スペクトル 1SiO 2 /SiC (measured) 2.75 ev 1SiO 2 /SiC measured 3.15 ev Si-face C-face Binding Energy (ev) 大阪大学大学院工学研究科渡部研究室 23/60
24 4H-SiC(0001) Si 及び (000-1) C 面のバンド構造 H. Watanabe et al., Mater. Sci. Forum , 386 (2011). Si-face SiO 2 =3 nm SiO 2 =40 nm + HF ev ev C-face SiO SiO 2 =3 nm 2 =40 nm + HF ev ev SiO 2 SiO 2 4H- SiC 4H- SiC SiO 2 SiO 2 4H- SiC 4H- SiC 2.75 ev 2.65 ev 3.15 ev ev ev C 面は Si 面と比較して本質的に伝導帯オフセットが小さい 酸化膜厚増加と共に界面近傍に負の固定電荷が蓄積し バンドオフセットが変調される (C 面で顕著 ) 界面特性向上と MOSFET 閾値低下のトレードオフ 大阪大学大学院工学研究科渡部研究室 24/60
25 概要 ワイドバンドギャップ半導体パワーデバイス SiC パワーデバイス開発 - 熱酸化膜界面の構造欠陥評価 - SiO 2 /SiC 界面エネルギーバンド構造 - 窒化界面の評価と今後の課題 GaN-MOS デバイス開発 - AlGaN/GaN MOS-HFET 用堆積絶縁膜 - GaN 表面の熱酸化過程評価 - 極薄 GaO x 界面層による MOS 界面特性改善 まとめ 大阪大学大学院工学研究科渡部研究室 25/60
26 熱酸化 SiO 2 /SiC 界面特性改善技術 Si+O 2 SiO 2 2SiC+3O 2 2SiO 2 +2CO O 2 O 2 SiO 2 Si O 2 SiO 2 CO x 転位 SiC Si ラフネス 結晶欠陥起因の膜厚不均一 多量の界面欠陥 ( 界面準位, 固定電荷 ) SiC 酸化温度 界面欠陥 Si ダングリングボンド C-C 結合, 格子間炭素, Si-Si 結合, etc 界面欠陥終端化アニール処理 H 2 (~500 C) NO, N 2 O, H 2, NH 3, POCl 3, etc (>1000 C) 大阪大学大学院工学研究科渡部研究室 26/60
27 SiO 2 /SiC 界面の NO 窒化に関する報告 SiO 2 /SiC 界面の窒素量はアニール時間と温度に依存 J. Rozen et al., J. Appl. Phys. 105, (2009). R. Kosugi et al., Appl. Phys. Lett. 99, (2011) C 界面窒素量の増加に対して 移動度の向上は飽和傾向 J. Rozen et al., IEEE Trans Electron Dev. 58, 3808 (2011). H. Yoshioka et al., Mat. Sci. Forum , 418 (2014). J. Appl. Phys. 112, (2012). 大阪大学大学院工学研究科渡部研究室 27/60
28 窒素導入量と界面特性 4H-SiC(0001) w/ n-epilayer (N D = cm 3 ) Ion implantation & activation for MOSFET Thermal oxidation in dry O 2 (1300 C, 60 min) 75 nm NO annealing (1250 C, 90 or 180 min) N 2 annealing (1250 C, 60 min) T. Hosoi et al., ECSCRM2014. h SiO e - 2 etched SiO 2 4H-SiC Gate & contact formation Electrical measurement Etch back by diluted HF ( 3 nm) =686.5 ev, TOA=90 ) Sample Peak FE (cm 2 /Vs) CET (nm) V FB (V) w/o NO NO(90) NO(180) 過剰な窒化は移動度を劣化 E c -E (ev) 大阪大学大学院工学研究科渡部研究室 28/60 D it (cm -2 ev -1 ) NO(90) w/o NO NO(180) C- s method
29 Intensity (arb. unit) Binding Energy (ev) SiO 2 /SiC 窒化界面の評価 SiC 基板信号で結合エネルギーと強度を規格化 Si 2p w/o NO C 1s N 1s 希 HFで除去できず NO(180) SiO 2 etched SiO 2 4H-SiC SiO 2 etched 4H-SiC Binding Energy (ev) T. Hosoi et al., ECSCRM2014. NO(90) Binding Energy (ev) NO アニールにより SiO 2 ピークは低 BE 側にシフト N 量 (N 1s 信号強度 ) は NO アニール時間に依存 ( スペクトル形状 (= 結合状態 ) に変化なし ) N の大部分が希 HF で除去できない界面層 (or 基板 ) 中に存在 大阪大学大学院工学研究科渡部研究室 29/60
30 NO アニール処理と正孔トラップ挙動 酸化膜中のキャリア捕獲挙動に対する NO アニールの影響 J. Rozen et al., J. Appl. Phys. 105, (2009). 電子 n 型 4H-SiC(0001) ドライO 2 酸化 (1300 C, 75 nm) 抑制 NOアニール (1250 C, 90 or 180 分 ) Al 電極蒸着 (Φ:100, 200, 400 m) : 100 khz 促進正孔 大阪大学大学院工学研究科渡部研究室 30/60 C/C OX : 400 m w/o UV w/ UV NO(90) Gate Voltage (V)
31 SiO 2 /Si 界面窒化による正孔トラップ促進 Post-oxidation annealing (POA) in NO (or N 2 O) チャネル移動度向上に限界 cm 2 /Vs 正孔トラップの増加 V th instability Y. Katsu et al., Mat. Sci. Forum 858, 599 (2016). 大阪大学大学院工学研究科渡部研究室 31/60
32 Company A (Oct. 2015) 市販 SiC MOSFET Company B (Nov. 2015) 大阪大学大学院工学研究科渡部研究室 32/60
33 概要 ワイドバンドギャップ半導体パワーデバイス SiC パワーデバイス開発 - 熱酸化膜界面の構造欠陥評価 - SiO 2 /SiC 界面エネルギーバンド構造 - 窒化界面の評価と今後の課題 GaN-MOS デバイス開発 - AlGaN/GaN MOS-HFET 用堆積絶縁膜 - GaN 表面の熱酸化過程評価 - 極薄 GaO x 界面層による MOS 界面特性改善 まとめ 大阪大学大学院工学研究科渡部研究室 33/60
34 GaN パワーデバイスの優位性 Si,GaN の物性値比較 バンドギャップ ( 高温環境動作 ) 二次元電子ガスの利用 AlGaN P SP P SE 電子移動度 Si GaN 熱伝導率 P SP GaN Metal AlGaN GaN 2DEG E C E F 飽和電子速度 ( 小型化 高速動作 ) 絶縁破壊電界強度 ( 高耐圧 ) 高キャリア移動度 GaN: 高周波 高出力パワーデバイスの実現 大阪大学大学院工学研究科渡部研究室 34/60
35 Current AlGaN/GaN MOS-HFET の検討 AlGaN/GaN HEMT: 高周波スイッチング素子携帯電話基地局の送信用増幅器 ショットキーゲート型 HFET リーク電流大 Source gate drain MOS 型 HFET ゲート絶縁膜ドレイン電流大 Source gate drain I-V 特性 ドレイン電流大 i-algan i-gan Sub ドレイン電流小 2DEG 絶縁膜 i-gan Sub ドレイン電流大 リーク小 Gate Voltage ノーマリーオフ & リーク電流小 ( 大電力化 ) 大阪大学大学院工学研究科渡部研究室 35/60
36 MOS-HFET 用堆積ゲート絶縁膜 i-algan i-gan 絶縁膜 i-algan i-gan MOS-HFET の実現 ゲート絶縁膜の膜質絶縁膜 /AlGaN 界面の品質 デバイス特性を決定 ( 閾値電圧変動 駆動力 ) X. Qin et al., J Mater. Sci: Mater Electron 26, 4638 (2015). SiC-MOS: 高温熱酸化 SiO 2 Al 2 O 3 HfO 2 GaN MOS デバイス : 堆積絶縁膜 HfO 2 ( ハフニア ) Al 2 O 3 ( アルミナ ) 界面特性 絶縁膜膜質 絶縁膜界面特性及び膜質の向上が急務 大阪大学大学院工学研究科渡部研究室 36/60
37 AlON ゲート絶縁膜 (SiC-MOS) Al Al 2 O 3 (60 nm) SiO 2 (7 nm) SiC T. Hosoi et al., IEDM (2012) 7.4. パワーデバイス用絶縁膜としては ALD-Al 2 O 3 応用が中心 Al 2 O 3 膜への電子注入 窒素添加による信頼性向上 Capacitance ( F/cm 2 ) Al 2 O 3 /7-nm-SiO 2 (CET*=44 nm) V acc sweep: -10V V acc -10V Gate Voltage (V) GaN-MOS への AlON 応用 閾値電圧安定性向上 界面特性改善 (AlON/AlGaN の相性 ) 大阪大学大学院工学研究科渡部研究室 37/60 Flatband Voltage (V) on 7-nm-SiO 2 Al 2 O 3 (CET=44 nm) 5-20 V V e - injection AlON (CET=42 nm) Accumulation Voltage (V)
38 放射光 XPS SPring-8 BL23SU AlGaN/GaN on Si(111) 基板 HCl 洗浄 (5%) Al 2 O 3 or AlON 成膜反応性スパッタリング (2 nm) Al 2 O 3 : Ar/O 2 混合ガス AlON: N 2 /O 2 混合ガス 熱処理 (N 2, 800 C, 3 min: 膜質改善 ) 放射光 XPS (TOA=90, h =1253 ev) Al 2 O 3 AlGaN GaN AlON AlGaN GaN スペクトル変化から絶縁膜界面の熱安定性 ( 反応層 ) を評価 大阪大学大学院工学研究科渡部研究室 38/60
39 放射光 XPS による絶縁膜反応解析 R. Asahara et al., Appl. Phys. Express 9, (2016). 表面敏感条件 AlGaN 基板からの Ga3d 信号強度で規格化 Al 2 O 3 AlO x AlGaN GaN AlON AlGaN GaN Al 2 O 3 /AlGaN: AlO x 界面反応層の成長を示唆 AlON/AlGaN: 優れた界面安定性を確認 大阪大学大学院工学研究科渡部研究室 39/60
40 断面 TEM 及び AFM 観察 R. Asahara et al., Appl. Phys. Express 9, (2016). 熱処理後 ( 窒素雰囲気, 800 C, 3 分間 ) Al 2 O 3 AlON 5 nm I.L. AFM (1 1 m 2 ) AFM (1 1 m 2 ) AlGaN 5 nm Al 2 O 3 膜の結晶化 表面ラフネス発生 界面反応層 (AlO x ) が形成 非晶質 AlON 膜 平滑な表面形状を維持 急峻な AlON/AlGaN 界面 Al 2 O 3 膜の窒化 (AlON) による結晶化温度上昇 AlGaN 表面への窒素プラズマ照射による安定化 大阪大学大学院工学研究科渡部研究室 40/60
41 Capacitance ( F/cm 2 ) AlGaN/GaN MOS キャパシタの基本特性 <C-V 特性 > 1 V g < V 1 gate MOS 2DEG 絶縁膜 i-algan i-gan Sub 負バイアスによる空乏化 V 1 V 2 Gate Voltage (V) 2 段階の C-V カーブ 2 V 1 < V g < V 2 gate 絶縁膜 i-algan i-gan Sub AlGaN/GaN 界面 3 V th2 < V g gate i-algan i-gan Sub 絶縁膜 /AlGaN 界面 大阪大学大学院工学研究科渡部研究室 41/60
42 Capacitance ( F/cm 2 ) Capacitance ( F/cm 2 ) AlGaN/GaN MOS キャパシタの C-V 特性 Al2 O 3 e - e - Al e - 2 O mv e - e - e - e - AlGaN GaN R. Asahara et al., Appl. Phys. Express 9, (2016). CET=6.8 nm 1kHz 1 1MHz Gate Voltage (V) AlON 大阪大学大学院工学研究科渡部研究室 42/ e - e - AlON AlGaN GaN CET=7.9 nm 90 mv 1kHz 1 1MHz Gate Voltage (V) Al 2 O 3 絶縁膜でも典型的な 2 段階 C-V カーブを取得 (ALD-Al 2 O 3 膜に対する優位性 : 室温酸素ラジカル照射 ) AlON 絶縁膜によるヒステリシスと周波数分散の低減 電荷注入耐性と界面電気特性の向上 (AlON 膜質 & 窒素 / 酸素プラズマ照射効果 ) 2
43 G p / (nf/cm 2 ) 界面準位密度 (D it ) 評価結果 R. Asahara et al., Appl. Phys. Express 9, (2016) < コンダクタンス法 > 0.32 V 0.29 V 0.26 V 0.23 V AlON V g = 0.35 V Frequency (Hz) Al 2 O 3 V g = 0.12 V 0.15 V 0.18 V 0.21 V Al 2 O 3 /AlGaN D it = cm -2 ev -1 Al 2 O 3 AlO x AlGaN GaN AlON/AlGaN D it = cm -2 ev -1 AlON AlGaN GaN 大阪大学大学院工学研究科渡部研究室 43/60
44 概要 ワイドバンドギャップ半導体パワーデバイス SiC パワーデバイス開発 - 熱酸化膜界面の構造欠陥評価 - SiO 2 /SiC 界面エネルギーバンド構造 - 窒化界面の評価と今後の課題 GaN-MOS デバイス開発 - AlGaN/GaN MOS-HFET 用堆積絶縁膜 - GaN 表面の熱酸化過程評価 - 極薄 GaO x 界面層による MOS 界面特性改善 まとめ 大阪大学大学院工学研究科渡部研究室 44/60
45 GaN 縦型パワーデバイスの可能性 Source < 横型デバイス > Gate Metal AlGaN GaN Buffer layer Si sub. Drain Current 2 次元電子ガス 高移動度 2 次元電子ガス 高周波用デバイス < 縦型デバイス > Source Gate Source Metal Insulator p + n + n + p + n - -GaN Current n + -GaN sub. Drain 高耐圧化 / 大電流動作 大電力用デバイス課題 GaN on GaN 基板の高品質化 GaN 上 MOS 構造の作製技術 大阪大学大学院工学研究科渡部研究室 45/60
46 GaN-MOS デバイスの技術課題 GaN-MOS デバイス用堆積絶縁膜 (CVD-Si 3 N 4 &ALD-Al 2 O 3 ) 絶縁膜 /GaN 界面の欠陥 Source Gate Source Metal Insulator p + n + n + p + n - -GaN n + -GaN Drain Insulator GaN 欠陥 [1] R. Nakasaki et al., IEIC Technical Report 99, 19 (1999). [2] K. J. Chen et al., Phys. Status Solidi A 212, 1059 (2015). [3] T. Hashizume et al., Appl. Surf. Sci. 234, 387 (2004). 不均質な自然酸化膜 [1, 2] 表面近傍の窒素空孔 [2, 3] 多数の界面欠陥 デバイス性能の低下 絶縁膜 /GaN 界面の欠陥低減が必要 O Ga N V N Ga O Ga N N Ga Ga N N Ga O Ga N V N Ga 大阪大学大学院工学研究科渡部研究室 46/60
47 熱酸化 Ga 2 O 3 の問題点 Si: 熱酸化 SiO 2 を絶縁膜として良好な MOSFET 動作 GaN: 熱酸化により酸化ガリウム (Ga 2 O 3 ) が形成 表面 & 界面形状 層状酸化 SiO 2 Si Y. Zhou et al., Solid-State Electron. 52, 756 (2008). Ga 2 O 3 GaN Ga 2 O 3 /GaNバンド構造 M. Grodzicki et al., Appl. Surf. Sci. 304, 20 (2014). Ga 2 O 3 GaN 0.35 ev E C 表面 界面 4.9 ev 3.4 ev 2 μm 2 μm 1.15 ev E v 厚膜化 ラフネスの増加 電子に対して低障壁 ΔE C リーク電流の増加 大阪大学大学院工学研究科渡部研究室 47/60
48 GaN 表面の熱酸化過程評価 n-gan/si ( 欠陥密度 ~10 8 cm -2 ) 自立 n-gan ( 欠陥密度 ~10 5 cm -2 ) 自立 n-gan 観察領域 : 1μm 1μm n-gan/si 欠陥 塩酸洗浄 (5%, 10 min) 大気圧 O 2 ガス中で熱酸化 (700~1000 C, 30 min) 分析評価 XPS: 表面酸化過程 Al K α : 1487eV, TOA=90º Ga 2p 3/2 スペクトルを解析 AFM: 表面形状 酸化温度 Ar 300nm 30 min O 2 Ar 300nm 大阪大学大学院工学研究科渡部研究室 48/60
49 GaN/Si 基板表面の熱酸化過程 T. Yamada et al., J. Appl. Phys. 121, (2017). AFM 像 ( 大気圧 O 2 ガス,30 min) w/o 700ºC 800ºC 850ºC 900ºC 欠陥 断面 SEM 像 (1000ºC) 300nm 300nm 300nm 300nm 850ºC w/o 900ºC 1000ºC 800ºC 900ºC 300nm 300nm 300nm 300nm 250 nm 900ºC 1000ºC 酸化膜成長に伴い表面ラフネスが増大 800 以上で欠陥部位から酸化物粒が成長 MOS デバイス応用 大阪大学大学院工学研究科渡部研究室 49/60 300nm 300nm 300nm
50 低転位密度自立 GaN 基板の表面酸化 n-gan/gan ( 欠陥密度 : ~10 5 cm -2 ) 洗浄後 800 C RMS=0.19 nm 0.14 nm 0.62 nm 0 (nm) 4.0 T. Yamada et al., J. Appl. Phys. 121, (2017). 900 C 0 (nm) (nm) 4.0 n-gan/si ( 欠陥密度 : ~10 8 cm -2 ) RMS roughness (nm) n-gan/si w/o Oxidation temperature (ºC) 自立 n-gan 洗浄後 0 (nm) C 0.26 nm 0.31 nm 900 C 3.35 nm 0 (nm) (nm) 20.0 Ga 2 O 3 膜厚 ( 分光エリプソ ) 800 : 1.0 nm 900 : 3.7 nm Ga 2 O 3 界面層の可能性 大阪大学大学院工学研究科渡部研究室 50/60
51 Intensity (arb. units) Intensity (arb. units) O 1s integrated int. GaN 表面酸化過程の XPS 評価 T. Yamada et al., J. Appl. Phys. 121, (2017) 光電子の脱出深さ深い浅い Ga 3d Ga-N 成分 Ga 3d O 1s Ga 2p (1 nm) Binding energy (ev) 1000ºC 900ºC 850ºC 800ºC 750ºC 700ºC w/o w/o Oxidation temperature (ºC) O 1s O 1s O-Ga 成分 Ga 3d 1000ºC 900ºC 850ºC 800ºC 750ºC 700ºC w/o Binding energy (ev) 大阪大学大学院工学研究科渡部研究室 51/60
52 Normalized intensity (a. u.) w/o (b) GaN/GaN ºC 900ºC 850ºC 800ºC 750ºC 700ºC 1000ºC 900ºC 800ºC w/o (a) GaN/Si 1120 Binding energy (ev) 初期酸化過程の評価 BE shift: 0.41 ev BE shift: 0.40 ev T. Yamada et al., J. Appl. Phys. 121, (2017). Ga-O/Ga-N int. ratio (a. u.) GaN/Si GaN/GaN 0.00 w/o Oxidation temperature (ºC) ケミカルシフト量の決定 (Ga-O/Ga-N) 初期酸化の飽和傾向と 900 以上での酸化膜 ( 島状 ) 成長を確認 大阪大学大学院工学研究科渡部研究室 52/60
53 Intensity (a. u.) 放射光 XPS による高感度測定 T. Yamada et al., J. Appl. Phys. 121, (2017). GaN(s) + O 2 (g) Ga 2 O 3 (s) + GaO x (s,g) + NO x (g) NO x SiO 2 層 GaN HCl as-depo 600ºC 700ºC 800ºC 900ºC 1000ºC N-O N-Ga Binding energy (ev) SiO 2 /GaN 界面に NO x 成分が蓄積 395 大阪大学大学院工学研究科渡部研究室 53/60
54 概要 ワイドバンドギャップ半導体パワーデバイス SiC パワーデバイス開発 - 熱酸化膜界面の構造欠陥評価 - SiO 2 /SiC 界面エネルギーバンド構造 - 窒化界面の評価と今後の課題 GaN-MOS デバイス開発 - AlGaN/GaN MOS-HFET 用堆積絶縁膜 - GaN 表面の熱酸化過程評価 - 極薄 GaO x 界面層による MOS 界面特性改善 まとめ 大阪大学大学院工学研究科渡部研究室 54/60
55 GaO x 界面層の挿入による電気特性改善 薄い GaO x 層 熱酸化 SiO 2 成膜 (15nm) 900ºC 熱酸化 (RMS: 0.6 nm) O 2 O 2 O 2 O 2 SiO 2 GaN GaN 界面の平坦性 リーク電流の抑制 2.5um 大阪大学大学院工学研究科渡部研究室 55/60
56 後酸化による SiO 2 /GaO x /GaN 構造形成 TEOS-SiO 2 堆積後の後酸化で極薄 GaO x 界面層を形成 SiO 2 /GaN 構造の酸化 SiO 2 層 GaN GaO x 界面層 (GaO x IL) GaN 表面の直接酸化 GaO x 層 GaN 大阪大学大学院工学研究科渡部研究室 56/60
57 SiO 2 /GaO x /GaN 界面の放射光 XPS 分析 20 nm SiO 2 光電子 2 nm GaN (hν = ev) (BE 較正 : N 1s ピーク位置 ) 大阪大学大学院工学研究科渡部研究室 57/60
58 GaO x 界面層の成長過程評価 ピーク分離解析 Ga-O/Ga-N 強度比の変化 大阪大学大学院工学研究科渡部研究室 58/60
59 SiO 2 /GaO x /GaN キャパシタの電気特性評価 コンダクタンス法による界面準位密度評価 良質な GaO x /GaN 界面特性を確認 ( 酸化層の積極的な利用 ) 大阪大学大学院工学研究科渡部研究室 59/60
60 概要 ワイドバンドギャップ半導体パワーデバイス SiC パワーデバイス開発 - 熱酸化膜界面の構造欠陥評価 - SiO 2 /SiC 界面エネルギーバンド構造 - 窒化界面の評価と今後の課題 GaN-MOS デバイス開発 - AlGaN/GaN MOS-HFET 用堆積絶縁膜 - GaN 表面の熱酸化過程評価 - 極薄 GaO x 界面層による MOS 界面特性改善 まとめ 大阪大学大学院工学研究科渡部研究室 60/60
untitled
 213 74 AlGaN/GaN Influence of metal material on capacitance for Schottky-gated AlGaN/GaN 1, 2, 1, 2, 2, 2, 2, 2, 2, 2, 1, 1 1 AlGaN/GaN デバイス ① GaNの優れた物性値 ② AlGaN/GaN HEMT構造 ワイドバンドギャップ半導体 (3.4eV) 絶縁破壊電界が大きい
213 74 AlGaN/GaN Influence of metal material on capacitance for Schottky-gated AlGaN/GaN 1, 2, 1, 2, 2, 2, 2, 2, 2, 2, 1, 1 1 AlGaN/GaN デバイス ① GaNの優れた物性値 ② AlGaN/GaN HEMT構造 ワイドバンドギャップ半導体 (3.4eV) 絶縁破壊電界が大きい
AlGaN/GaN HFETにおける 仮想ゲート型電流コラプスのSPICE回路モデル
 AlGaN/GaN HFET 電流コラプスおよびサイドゲート効果に関する研究 徳島大学大学院先端技術科学教育部システム創生工学専攻電気電子創生工学コース大野 敖研究室木尾勇介 1 AlGaN/GaN HFET 研究背景 高絶縁破壊電界 高周波 高出力デバイス 基地局などで実用化 通信機器の発達 スマートフォン タブレットなど LTE LTE エンベロープトラッキング 低消費電力化 電源電圧を信号に応じて変更
AlGaN/GaN HFET 電流コラプスおよびサイドゲート効果に関する研究 徳島大学大学院先端技術科学教育部システム創生工学専攻電気電子創生工学コース大野 敖研究室木尾勇介 1 AlGaN/GaN HFET 研究背景 高絶縁破壊電界 高周波 高出力デバイス 基地局などで実用化 通信機器の発達 スマートフォン タブレットなど LTE LTE エンベロープトラッキング 低消費電力化 電源電圧を信号に応じて変更
PowerPoint プレゼンテーション
 第 61 回応用物理学会 青山学院大学相模原キャンパス 春季学術講演会 2014 年 3 月 18 日 ( 火曜日 ) La 2 O 3 /InGaAs 界面ラフネスに及ぼす ALD プロセスの影響 Impact of ALD process on La 2 O 3 /InGaAs interface roughness 大嶺洋 1,Dariush Hassan Zadeh 1, 角嶋邦之 2, 片岡好則
第 61 回応用物理学会 青山学院大学相模原キャンパス 春季学術講演会 2014 年 3 月 18 日 ( 火曜日 ) La 2 O 3 /InGaAs 界面ラフネスに及ぼす ALD プロセスの影響 Impact of ALD process on La 2 O 3 /InGaAs interface roughness 大嶺洋 1,Dariush Hassan Zadeh 1, 角嶋邦之 2, 片岡好則
Conduction Mechanism at Low Temperature of 2-Dimensional Hole Gas at GaN/AlGaN Heterointerface (低温におけるGaN/AlGaN ヘテロ界面の2 次元正孔ガスの伝導機構)
 2014/03/19 応用物理学会 2014 年春季学術講演会 コンダクタンス法による AlGaN/GaN ヘテロ 接合界面トラップに関する研究 Investigation on interface traps in AlGaN/GaN heterojunction by conductance method 劉璞誠 1, 竇春萌 2, 角嶋邦之 2, 片岡好則 2, 西山彰 2, 杉井信之 2,
2014/03/19 応用物理学会 2014 年春季学術講演会 コンダクタンス法による AlGaN/GaN ヘテロ 接合界面トラップに関する研究 Investigation on interface traps in AlGaN/GaN heterojunction by conductance method 劉璞誠 1, 竇春萌 2, 角嶋邦之 2, 片岡好則 2, 西山彰 2, 杉井信之 2,
Microsoft PowerPoint - semi_ppt07.ppt
 半導体工学第 9 回目 / OKM 1 MOSFET の動作原理 しきい電圧 (V( TH) と制御 E 型と D 型 0 次近似によるドレイン電流解析 半導体工学第 9 回目 / OKM 2 電子のエネルギーバンド図での考察 金属 (M) 酸化膜 (O) シリコン (S) 熱平衡でフラットバンド 伝導帯 E c 電子エネルギ シリコンと金属の仕事関数が等しい 界面を含む酸化膜中に余分な電荷がない
半導体工学第 9 回目 / OKM 1 MOSFET の動作原理 しきい電圧 (V( TH) と制御 E 型と D 型 0 次近似によるドレイン電流解析 半導体工学第 9 回目 / OKM 2 電子のエネルギーバンド図での考察 金属 (M) 酸化膜 (O) シリコン (S) 熱平衡でフラットバンド 伝導帯 E c 電子エネルギ シリコンと金属の仕事関数が等しい 界面を含む酸化膜中に余分な電荷がない
PowerPoint プレゼンテーション
 第 12 回窒化物半導体応用研究会 2011 年 11 月 10 日 ノーマリオフ型 HFET の高性能化 前田就彦 日本電信電話株式会社 NTT フォトニクス研究所 243-0198 神奈川県厚木市森の里若宮 3-1 E-mail: maeda.narihiko@lab.ntt.co.jp 内容 (1) 電力応用におけるノーマリオフ型デバイス (2) / HFETにおけるノーマリオフ化 - デバイス構造のこれまでの展開
第 12 回窒化物半導体応用研究会 2011 年 11 月 10 日 ノーマリオフ型 HFET の高性能化 前田就彦 日本電信電話株式会社 NTT フォトニクス研究所 243-0198 神奈川県厚木市森の里若宮 3-1 E-mail: maeda.narihiko@lab.ntt.co.jp 内容 (1) 電力応用におけるノーマリオフ型デバイス (2) / HFETにおけるノーマリオフ化 - デバイス構造のこれまでの展開
Microsoft PowerPoint - semi_ppt07.ppt [互換モード]
![Microsoft PowerPoint - semi_ppt07.ppt [互換モード] Microsoft PowerPoint - semi_ppt07.ppt [互換モード]](/thumbs/94/122068205.jpg) 1 MOSFETの動作原理 しきい電圧 (V TH ) と制御 E 型とD 型 0 次近似によるドレイン電流解析 2 電子のエネルギーバンド図での考察 理想 MOS 構造の仮定 : シリコンと金属の仕事関数が等しい 界面を含む酸化膜中に余分な電荷がない 金属 (M) 酸化膜 (O) シリコン (S) 電子エ金属 酸化膜 シリコン (M) (O) (S) フラットバンド ネルギー熱平衡で 伝導帯 E
1 MOSFETの動作原理 しきい電圧 (V TH ) と制御 E 型とD 型 0 次近似によるドレイン電流解析 2 電子のエネルギーバンド図での考察 理想 MOS 構造の仮定 : シリコンと金属の仕事関数が等しい 界面を含む酸化膜中に余分な電荷がない 金属 (M) 酸化膜 (O) シリコン (S) 電子エ金属 酸化膜 シリコン (M) (O) (S) フラットバンド ネルギー熱平衡で 伝導帯 E
Microsoft PowerPoint 修論発表_細田.ppt
 0.0.0 ( 月 ) 修士論文発表 Carrier trasort modelig i diamods ( ダイヤモンドにおけるキャリヤ輸送モデリング ) 物理電子システム創造専攻岩井研究室 M688 細田倫央 Tokyo Istitute of Techology パワーデバイス基板としてのダイヤモンド Proerty (relative to Si) Si GaAs SiC Ga Diamod
0.0.0 ( 月 ) 修士論文発表 Carrier trasort modelig i diamods ( ダイヤモンドにおけるキャリヤ輸送モデリング ) 物理電子システム創造専攻岩井研究室 M688 細田倫央 Tokyo Istitute of Techology パワーデバイス基板としてのダイヤモンド Proerty (relative to Si) Si GaAs SiC Ga Diamod
untitled
 Tokyo Institute of Technology high-k/ In.53 Ga.47 As MOS - Defect Analysis of high-k/in.53 G a.47 As MOS Capacitor using capacitance voltage method,,, Darius Zade,,, Parhat Ahmet,,,,,, ~InGaAs high-k ~
Tokyo Institute of Technology high-k/ In.53 Ga.47 As MOS - Defect Analysis of high-k/in.53 G a.47 As MOS Capacitor using capacitance voltage method,,, Darius Zade,,, Parhat Ahmet,,,,,, ~InGaAs high-k ~
Microsoft PowerPoint - H30パワエレ-3回.pptx
 パワーエレクトロニクス 第三回パワー半導体デバイス 平成 30 年 4 月 25 日 授業の予定 シラバスより パワーエレクトロニクス緒論 パワーエレクトロニクスにおける基礎理論 パワー半導体デバイス (2 回 ) 整流回路 (2 回 ) 整流回路の交流側特性と他励式インバータ 交流電力制御とサイクロコンバータ 直流チョッパ DC-DC コンバータと共振形コンバータ 自励式インバータ (2 回 )
パワーエレクトロニクス 第三回パワー半導体デバイス 平成 30 年 4 月 25 日 授業の予定 シラバスより パワーエレクトロニクス緒論 パワーエレクトロニクスにおける基礎理論 パワー半導体デバイス (2 回 ) 整流回路 (2 回 ) 整流回路の交流側特性と他励式インバータ 交流電力制御とサイクロコンバータ 直流チョッパ DC-DC コンバータと共振形コンバータ 自励式インバータ (2 回 )
窒化アルミニウムによる 高効率フィールドエミッションを実現 ディスプレイパネル実用レベルのフィールドエミッション特性
 Copyright NTT Basic Research Laboratories, NTT Corporation. All rights reserved. ダイヤモンド 高周波電力デバイスの開発とマイクロ波 ミリ波帯電力増幅器への応用 (614314) 研究代表者嘉数誠 (1) NTT 物性科学基礎研究所 研究分担者植田研二 (2) 小林康之 中川匡夫 NTT 物性科学基礎研究所 NTT 未来ねっと研究所
Copyright NTT Basic Research Laboratories, NTT Corporation. All rights reserved. ダイヤモンド 高周波電力デバイスの開発とマイクロ波 ミリ波帯電力増幅器への応用 (614314) 研究代表者嘉数誠 (1) NTT 物性科学基礎研究所 研究分担者植田研二 (2) 小林康之 中川匡夫 NTT 物性科学基礎研究所 NTT 未来ねっと研究所
untitled
 20101221JST (SiC - Buried Gate Static Induction Transistor: SiC-BGSIT) SOURCE GATE N source layer p + n p + n p + n p+ n drift layer n + substrate DRAIN SiC-BGSIT (mωcm 2 ) 200 100 40 10 4 1 Si limit
20101221JST (SiC - Buried Gate Static Induction Transistor: SiC-BGSIT) SOURCE GATE N source layer p + n p + n p + n p+ n drift layer n + substrate DRAIN SiC-BGSIT (mωcm 2 ) 200 100 40 10 4 1 Si limit
事務連絡
 二酸化炭素排出抑制に資する革新的技術の創出 平成 21 年度採択研究代表者 H23 年度 実績報告 橋詰保 北海道大学量子集積エレクトロニクス研究センター 教授 研究課題 異種接合 GaN 横型トランジスタのインバータ展開 1. 研究実施体制 (1) 北大 グループ 1 研究代表者 : 橋詰保 ( 北海道大学量子集積エレクトロニクス研究センター 教授 ) 2 研究項目 ドライエッチ面を含む Al 2
二酸化炭素排出抑制に資する革新的技術の創出 平成 21 年度採択研究代表者 H23 年度 実績報告 橋詰保 北海道大学量子集積エレクトロニクス研究センター 教授 研究課題 異種接合 GaN 横型トランジスタのインバータ展開 1. 研究実施体制 (1) 北大 グループ 1 研究代表者 : 橋詰保 ( 北海道大学量子集積エレクトロニクス研究センター 教授 ) 2 研究項目 ドライエッチ面を含む Al 2
PowerPoint Presentation
 半導体電子工学 II 神戸大学工学部 電気電子工学科 12/08/'10 半導体電子工学 Ⅱ 1 全体の内容 日付内容 ( 予定 ) 備考 1 10 月 6 日半導体電子工学 I の基礎 ( 復習 ) 11/24/'10 2 10 月 13 日 pn 接合ダイオード (1) 3 10 月 20 日 4 10 月 27 日 5 11 月 10 日 pn 接合ダイオード (2) pn 接合ダイオード (3)
半導体電子工学 II 神戸大学工学部 電気電子工学科 12/08/'10 半導体電子工学 Ⅱ 1 全体の内容 日付内容 ( 予定 ) 備考 1 10 月 6 日半導体電子工学 I の基礎 ( 復習 ) 11/24/'10 2 10 月 13 日 pn 接合ダイオード (1) 3 10 月 20 日 4 10 月 27 日 5 11 月 10 日 pn 接合ダイオード (2) pn 接合ダイオード (3)
研究成果報告書
 様式 C-19 科学研究費補助金研究成果報告書 平成 21 年 6 月 1 日現在 研究種目 : 若手研究 ( スタートアップ ) 研究期間 :27~28 課題番号 :198624 研究課題名 ( 和文 ) InAlAs 酸化膜による III-V-OIMOS 構造の作製および界面準位に関する研究研究課題名 ( 英文 ) III-V-OIMOSstructurebyusingselectivewetoxidationofInAlAs
様式 C-19 科学研究費補助金研究成果報告書 平成 21 年 6 月 1 日現在 研究種目 : 若手研究 ( スタートアップ ) 研究期間 :27~28 課題番号 :198624 研究課題名 ( 和文 ) InAlAs 酸化膜による III-V-OIMOS 構造の作製および界面準位に関する研究研究課題名 ( 英文 ) III-V-OIMOSstructurebyusingselectivewetoxidationofInAlAs
untitled
 2013 74 Tokyo Institute of Technology AlGaN/GaN C Annealing me Dependent Contact Resistance of C Electrodes on AlGaN/GaN, Tokyo Tech.FRC, Tokyo Tech. IGSSE, Toshiba, Y. Matsukawa, M. Okamoto, K. Kakushima,
2013 74 Tokyo Institute of Technology AlGaN/GaN C Annealing me Dependent Contact Resistance of C Electrodes on AlGaN/GaN, Tokyo Tech.FRC, Tokyo Tech. IGSSE, Toshiba, Y. Matsukawa, M. Okamoto, K. Kakushima,
GaNの特長とパワーデバイス応用に向けての課題 GaNパワーデバイスの低コスト化技術 大面積 Si 上 MOCVD 結晶成長技術 Si 上大電流 AlGaN/GaNパワー HFET GaN パワーデバイスのノーマリオフ動作 伝導度変調を用いたAlGaN/GaNトランジスタ - Gate Inject
 高耐圧 GaN パワーデバイス開発 松下電器産業 ( 株 ) 半導体社半導体デバイス研究センター 上田哲三 GaNの特長とパワーデバイス応用に向けての課題 GaNパワーデバイスの低コスト化技術 大面積 Si 上 MOCVD 結晶成長技術 Si 上大電流 AlGaN/GaNパワー HFET GaN パワーデバイスのノーマリオフ動作 伝導度変調を用いたAlGaN/GaNトランジスタ - Gate Injection
高耐圧 GaN パワーデバイス開発 松下電器産業 ( 株 ) 半導体社半導体デバイス研究センター 上田哲三 GaNの特長とパワーデバイス応用に向けての課題 GaNパワーデバイスの低コスト化技術 大面積 Si 上 MOCVD 結晶成長技術 Si 上大電流 AlGaN/GaNパワー HFET GaN パワーデバイスのノーマリオフ動作 伝導度変調を用いたAlGaN/GaNトランジスタ - Gate Injection
スライド 1
 2014 年 9 月 17 日 ( 水 ) 第 75 回応用物理学会秋季学術講演会 TiC 電極,TiSi 2 電極と SiC 基板の Schottky ダイオード特性評価 Schottky diode characteristics of TiC and TiSi 2 electrodes on SiC substrates 東工大フロンティア研 1, 東工大総理工 2, 鈴木智之 1, 岡本真里
2014 年 9 月 17 日 ( 水 ) 第 75 回応用物理学会秋季学術講演会 TiC 電極,TiSi 2 電極と SiC 基板の Schottky ダイオード特性評価 Schottky diode characteristics of TiC and TiSi 2 electrodes on SiC substrates 東工大フロンティア研 1, 東工大総理工 2, 鈴木智之 1, 岡本真里
Microsoft PowerPoint - 14.菅谷修正.pptx
 InGaAs/系量子ドット太陽電池の作製 革新デバイスチーム 菅谷武芳 電子 バンド3:伝導帯 E3 E3 E 正孔 バンド:中間バンド 量子ドット超格子 ミニバンド 量子ドットの井戸型 ポテンシャル バンド:価電子帯 量子ドット太陽電池のバンド図 6%を超える理想的な量子ドット太陽 電池実現には E3として1 9eVが必要 量子ドット超格子太陽電池 理論上 変換効率6%以上 集光 を採用 MBE
InGaAs/系量子ドット太陽電池の作製 革新デバイスチーム 菅谷武芳 電子 バンド3:伝導帯 E3 E3 E 正孔 バンド:中間バンド 量子ドット超格子 ミニバンド 量子ドットの井戸型 ポテンシャル バンド:価電子帯 量子ドット太陽電池のバンド図 6%を超える理想的な量子ドット太陽 電池実現には E3として1 9eVが必要 量子ドット超格子太陽電池 理論上 変換効率6%以上 集光 を採用 MBE
Microsoft PowerPoint - 9.菅谷.pptx
 超多積層量子ドット太陽電池と トンネル効果 菅谷武芳 革新デバイスチーム 量子ドット太陽電池 電子 バンド3:伝導帯 E23 E13 E12 正孔 バンド2:中間バンド 量子ドット超格子 ミニバンド 量子ドットの井戸型 ポテンシャル バンド1:価電子帯 量子ドット太陽電池のバンド図 量子ドット超格子太陽電池 理論上 変換効率60%以上 集光 A. Luque et al., Phys. Rev. Lett.
超多積層量子ドット太陽電池と トンネル効果 菅谷武芳 革新デバイスチーム 量子ドット太陽電池 電子 バンド3:伝導帯 E23 E13 E12 正孔 バンド2:中間バンド 量子ドット超格子 ミニバンド 量子ドットの井戸型 ポテンシャル バンド1:価電子帯 量子ドット太陽電池のバンド図 量子ドット超格子太陽電池 理論上 変換効率60%以上 集光 A. Luque et al., Phys. Rev. Lett.
Electrical contact characteristics of n-type diamond with Ti, Ni, NiSi2, and Ni3P electrodes
 Electrical contact characteristics of n-type diamond with Ti, Ni, NiSi 2, and Ni 3 P electrodes 杉井 岩井研究室 12M36240 武正敦 1 注目を集めるワイドギャップ半導体 パワーエレクトロニクス ( 半導体の電力変換分野への応用 ) に期待 ワイドギャップ半導体に注目 Properties (relative
Electrical contact characteristics of n-type diamond with Ti, Ni, NiSi 2, and Ni 3 P electrodes 杉井 岩井研究室 12M36240 武正敦 1 注目を集めるワイドギャップ半導体 パワーエレクトロニクス ( 半導体の電力変換分野への応用 ) に期待 ワイドギャップ半導体に注目 Properties (relative
SiC 高チャネル移動度トランジスタ
 エレクトロニクス SiC 高チャネル移動度トランジスタ 日吉透 * 増田健良 和田圭司 原田真 築野孝 並川靖生 SiC MOSFET with High Channel Mobility by Toru Hiyoshi, Takeyoshi Masuda, Keiji Wada, Shin Harada, Takashi Tsuno and Yasuo Namikawa SiC (silicon
エレクトロニクス SiC 高チャネル移動度トランジスタ 日吉透 * 増田健良 和田圭司 原田真 築野孝 並川靖生 SiC MOSFET with High Channel Mobility by Toru Hiyoshi, Takeyoshi Masuda, Keiji Wada, Shin Harada, Takashi Tsuno and Yasuo Namikawa SiC (silicon
PowerPoint プレゼンテーション
 加工 Si 基板上への 非極性 GaN 結晶成長 1) 名古屋大学工学研究科 赤崎記念研究センター 2) 愛知工業大学工学研究科 1) 本田善央 1) 谷川智之 1) 鈴木希幸 1) 山口雅史 2) 澤木宣彦 豊田講堂時計台 赤崎研究センター auditorium Akasaki research center 常圧 MOVPE 減圧 MOVPE (2inch) HVPE MOVPE #3 MOVPE
加工 Si 基板上への 非極性 GaN 結晶成長 1) 名古屋大学工学研究科 赤崎記念研究センター 2) 愛知工業大学工学研究科 1) 本田善央 1) 谷川智之 1) 鈴木希幸 1) 山口雅史 2) 澤木宣彦 豊田講堂時計台 赤崎研究センター auditorium Akasaki research center 常圧 MOVPE 減圧 MOVPE (2inch) HVPE MOVPE #3 MOVPE
スライド 1
 2015 年 2 月 17 日 ( 火 ) 学士卒業論文発表会 TiC 及び TiSi 2 電極と SiC ショットキーダイオードの電気特性評価 (Electrical Characteristics of SiC Schottky Diodes with TiC and TiSi 2 Electrodes) Iwai and Kakushima Laboratory Tomoyuki Suzuki
2015 年 2 月 17 日 ( 火 ) 学士卒業論文発表会 TiC 及び TiSi 2 電極と SiC ショットキーダイオードの電気特性評価 (Electrical Characteristics of SiC Schottky Diodes with TiC and TiSi 2 Electrodes) Iwai and Kakushima Laboratory Tomoyuki Suzuki
5 シリコンの熱酸化
 5. シリコンの熱酸化 5.1 熱酸化の目的 Siウェーハは大気中で自然酸化して表面に非常に薄いがSiO 2 の膜で被覆されている Siとその上に生じたSiO 2 膜の密着性は強力である 酸化を高温で行なうと厚い緻密で安定な膜が生じる Siの融点は 1412 であるが SiO 2 の融点は 1732 であり被膜は非常に高い耐熱性をもつ 全ての金属や半導体が密着性の高い緻密な酸化膜により容易に被覆される特性を持つ訳ではなく
5. シリコンの熱酸化 5.1 熱酸化の目的 Siウェーハは大気中で自然酸化して表面に非常に薄いがSiO 2 の膜で被覆されている Siとその上に生じたSiO 2 膜の密着性は強力である 酸化を高温で行なうと厚い緻密で安定な膜が生じる Siの融点は 1412 であるが SiO 2 の融点は 1732 であり被膜は非常に高い耐熱性をもつ 全ての金属や半導体が密着性の高い緻密な酸化膜により容易に被覆される特性を持つ訳ではなく
電子回路I_4.ppt
 電子回路 Ⅰ 第 4 回 電子回路 Ⅰ 5 1 講義内容 1. 半導体素子 ( ダイオードとトランジスタ ) 2. 基本回路 3. 増幅回路 電界効果トランジスタ (FET) 基本構造 基本動作動作原理 静特性 電子回路 Ⅰ 5 2 半導体素子 ( ダイオードとトランジスタ ) ダイオード (2 端子素子 ) トランジスタ (3 端子素子 ) バイポーラトランジスタ (Biolar) 電界効果トランジスタ
電子回路 Ⅰ 第 4 回 電子回路 Ⅰ 5 1 講義内容 1. 半導体素子 ( ダイオードとトランジスタ ) 2. 基本回路 3. 増幅回路 電界効果トランジスタ (FET) 基本構造 基本動作動作原理 静特性 電子回路 Ⅰ 5 2 半導体素子 ( ダイオードとトランジスタ ) ダイオード (2 端子素子 ) トランジスタ (3 端子素子 ) バイポーラトランジスタ (Biolar) 電界効果トランジスタ
研究成果報告書
 MIS HEMT MIS HEMT MIS HEMT AlGaN/GaN MIS ALD AlGaN/GaN MIS-HEMT (1)MIS MIS AlGaN/GaN MIS-HEMT BCl 3 Cl 2 Ti/Al/Mo/Au (15/60/35/50 nm) 850 ºC AlGaN Ni/Au (100/150 nm) 300 ºC Lg=3m Lgd=5 mwg=100 m ALD Al
MIS HEMT MIS HEMT MIS HEMT AlGaN/GaN MIS ALD AlGaN/GaN MIS-HEMT (1)MIS MIS AlGaN/GaN MIS-HEMT BCl 3 Cl 2 Ti/Al/Mo/Au (15/60/35/50 nm) 850 ºC AlGaN Ni/Au (100/150 nm) 300 ºC Lg=3m Lgd=5 mwg=100 m ALD Al
PowerPoint Presentation
 半導体電子工学 II 神戸大学工学部電気電子工学科 小川真人 09/01/21 半導体電子工学 II 日付内容 ( 予定 ) 備考 1 10 月 1 日半導体電子工学 I の基礎 ( 復習 ) 2 10 月 8 日半導体電子工学 I の基礎 ( 復習 ) 3 10 月 15 日 pn 接合ダイオード (1) 4 10 月 22 日 pn 接合ダイオード (2) 5 10 月 29 日 pn 接合ダイオード
半導体電子工学 II 神戸大学工学部電気電子工学科 小川真人 09/01/21 半導体電子工学 II 日付内容 ( 予定 ) 備考 1 10 月 1 日半導体電子工学 I の基礎 ( 復習 ) 2 10 月 8 日半導体電子工学 I の基礎 ( 復習 ) 3 10 月 15 日 pn 接合ダイオード (1) 4 10 月 22 日 pn 接合ダイオード (2) 5 10 月 29 日 pn 接合ダイオード
スライド 1
 硬 X 線光電子分光法による 最先端 LSI および太陽電池の材料評価 明治大学理工学部 小椋厚志 SPring-8 次世代先端デバイス研究会 ( 第 2 回 ) 硬 X 線光電子分光 (HAXPES) によるデバイス評価 2015.3.17 謝辞 共同研究 JASRI 東京エレクトロン 豊田工業大学 兵庫県立大学 日本電子 NIMS 研究費 NEDO JST-CREST 科研費基盤研究 B (24360125)
硬 X 線光電子分光法による 最先端 LSI および太陽電池の材料評価 明治大学理工学部 小椋厚志 SPring-8 次世代先端デバイス研究会 ( 第 2 回 ) 硬 X 線光電子分光 (HAXPES) によるデバイス評価 2015.3.17 謝辞 共同研究 JASRI 東京エレクトロン 豊田工業大学 兵庫県立大学 日本電子 NIMS 研究費 NEDO JST-CREST 科研費基盤研究 B (24360125)
QOBU1011_40.pdf
 印字データ名 QOBU1 0 1 1 (1165) コメント 研究紹介 片山 作成日時 07.10.04 19:33 図 2 (a )センサー素子の外観 (b )センサー基板 色の濃い部分が Pt 形電極 幅 50μm, 間隔 50μm (c ),(d )単層ナノ チューブ薄膜の SEM 像 (c )Al O 基板上, (d )Pt 電極との境 界 熱 CVD 条件 触媒金属 Fe(0.5nm)/Al(5nm)
印字データ名 QOBU1 0 1 1 (1165) コメント 研究紹介 片山 作成日時 07.10.04 19:33 図 2 (a )センサー素子の外観 (b )センサー基板 色の濃い部分が Pt 形電極 幅 50μm, 間隔 50μm (c ),(d )単層ナノ チューブ薄膜の SEM 像 (c )Al O 基板上, (d )Pt 電極との境 界 熱 CVD 条件 触媒金属 Fe(0.5nm)/Al(5nm)
低損失V溝型SiCトレンチMOSFET 4H-SiC V-groove Trench MOSFETs with the Buried p+ regions
 エレクトロニクス 低損失 V 溝型 SiC トレンチ MOSFET 4H-SiC V-groove Trench MOSFETs with the Buried p + regions * 斎藤雄和田圭司日吉透 Yu Saitoh Keiji Wada Toru Hiyoshi 増田健良築野孝御神村泰樹 Takeyoshi Masuda Takashi Tsuno Yasuki Mikamura 我々はワイドバンドギャップ半導体である炭化珪素
エレクトロニクス 低損失 V 溝型 SiC トレンチ MOSFET 4H-SiC V-groove Trench MOSFETs with the Buried p + regions * 斎藤雄和田圭司日吉透 Yu Saitoh Keiji Wada Toru Hiyoshi 増田健良築野孝御神村泰樹 Takeyoshi Masuda Takashi Tsuno Yasuki Mikamura 我々はワイドバンドギャップ半導体である炭化珪素
 hν 688 358 979 309 308.123 Hz α α α α α α No.37 に示す Ti Sa レーザーで実現 術移転も成功し 図 9 に示すよ うに 2 時間は連続測定が可能な システムを実現した Advanced S o l i d S t a t e L a s e r s 2016, JTu2A.26 1-3. 今後は光周波 数比計測装置としてさらに改良 を加えていくとともに
hν 688 358 979 309 308.123 Hz α α α α α α No.37 に示す Ti Sa レーザーで実現 術移転も成功し 図 9 に示すよ うに 2 時間は連続測定が可能な システムを実現した Advanced S o l i d S t a t e L a s e r s 2016, JTu2A.26 1-3. 今後は光周波 数比計測装置としてさらに改良 を加えていくとともに
スライド タイトルなし
 2011. 3. 2 高等研究院 インテックセンター成果報告会 極限を目指した 新しい半導体デバイスの実現 京都大学工学研究科電子工学専攻 木本恒暢 須田淳 光 電子理工学 エネルギー 環境問題や爆発的な情報量増大解決へ 物理限界への挑戦と新機能の創出 自在な光子制御 フォトニック結晶 シリコンナノフォト二クス ワイドバンドギャップ光半導体 極限的な電子制御 ワイドバンドギャップ (SiC) エレクトロニクス
2011. 3. 2 高等研究院 インテックセンター成果報告会 極限を目指した 新しい半導体デバイスの実現 京都大学工学研究科電子工学専攻 木本恒暢 須田淳 光 電子理工学 エネルギー 環境問題や爆発的な情報量増大解決へ 物理限界への挑戦と新機能の創出 自在な光子制御 フォトニック結晶 シリコンナノフォト二クス ワイドバンドギャップ光半導体 極限的な電子制御 ワイドバンドギャップ (SiC) エレクトロニクス
第 1 回窒化物半導体応用研究会平成 20 年 2 月 8 日 講演内容 1. 弊社の概要紹介 2. 弊社における窒化物半導体事業への展開 3. 知的クラスター創生事業での取り組み Si 基板上 HEMT 用 GaN 系エピ結晶結晶成長成長技術技術開発
 第 1 回窒化物半導体応用研究会 平成 20 年 2 月 8 日 GaN 結晶成長技術の開発 半導体事業部 伊藤統夫 第 1 回窒化物半導体応用研究会平成 20 年 2 月 8 日 講演内容 1. 弊社の概要紹介 2. 弊社における窒化物半導体事業への展開 3. 知的クラスター創生事業での取り組み Si 基板上 HEMT 用 GaN 系エピ結晶結晶成長成長技術技術開発 弊社社名変更について 2006
第 1 回窒化物半導体応用研究会 平成 20 年 2 月 8 日 GaN 結晶成長技術の開発 半導体事業部 伊藤統夫 第 1 回窒化物半導体応用研究会平成 20 年 2 月 8 日 講演内容 1. 弊社の概要紹介 2. 弊社における窒化物半導体事業への展開 3. 知的クラスター創生事業での取り組み Si 基板上 HEMT 用 GaN 系エピ結晶結晶成長成長技術技術開発 弊社社名変更について 2006
Microsoft PowerPoint - tft.ppt [互換モード]
![Microsoft PowerPoint - tft.ppt [互換モード] Microsoft PowerPoint - tft.ppt [互換モード]](/thumbs/96/129523894.jpg) 薄膜トランジスター 九州大学大学院 システム情報科学研究科 服部励治 薄膜トランジスターとは? Thin Film Transistor: TFT ソース電極 ゲート電極 ドレイン電極ソース電極ゲートドレイン電極 n poly 電極 a:h n n ガラス基板 p 基板 TFT 共通点 電界効果型トランジスター nmosfet 相違点 誘電膜上に作成される スタガー型を取りうる 薄膜トランジスター
薄膜トランジスター 九州大学大学院 システム情報科学研究科 服部励治 薄膜トランジスターとは? Thin Film Transistor: TFT ソース電極 ゲート電極 ドレイン電極ソース電極ゲートドレイン電極 n poly 電極 a:h n n ガラス基板 p 基板 TFT 共通点 電界効果型トランジスター nmosfet 相違点 誘電膜上に作成される スタガー型を取りうる 薄膜トランジスター
Figure 1. Center and Edge comparison of a HEMT epi measured by PCOR-SIMS SM 図 1 は直径 150mm の Si ウェハ上に成長させた GaN HEMT 構造全体の PCOR-SIMS による深さプ ロファイルを示しています
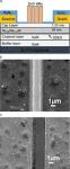 PCOR-SIMS による Si 基板上 GaN HEMT エピ構造の解析 Temel H. Buyuklimanli (temel@eag.com), Charles W. Magee, Ozgur Celik, Wei Ou, Andrew Klump, Wei Zhao, Yun Qi and Jeffrey Serfass 810 Kifer Road, Sunnyvale, CA 94086
PCOR-SIMS による Si 基板上 GaN HEMT エピ構造の解析 Temel H. Buyuklimanli (temel@eag.com), Charles W. Magee, Ozgur Celik, Wei Ou, Andrew Klump, Wei Zhao, Yun Qi and Jeffrey Serfass 810 Kifer Road, Sunnyvale, CA 94086
内 容 1. パワーデバイスの基礎 1) パワーデバイスの仕事 2) 次世代パワーデバイス開発の位置づけ 2.SiC パワーデバイスの最新技術と課題 1) なぜ SiC が注目されているのか 2) 高温動作ができると何がいいのか 3)SiC-MOSFET の課題 4)SiC トレンチ MOSFET
 SiC GaN パワー半導体の最新技術 課題 ならびにデバイス評価技術の重要性 2016 年 7 月 12 日 筑波大学数理物質系物理工学域 教授岩室憲幸 1 内 容 1. パワーデバイスの基礎 1) パワーデバイスの仕事 2) 次世代パワーデバイス開発の位置づけ 2.SiC パワーデバイスの最新技術と課題 1) なぜ SiC が注目されているのか 2) 高温動作ができると何がいいのか 3)SiC-MOSFET
SiC GaN パワー半導体の最新技術 課題 ならびにデバイス評価技術の重要性 2016 年 7 月 12 日 筑波大学数理物質系物理工学域 教授岩室憲幸 1 内 容 1. パワーデバイスの基礎 1) パワーデバイスの仕事 2) 次世代パワーデバイス開発の位置づけ 2.SiC パワーデバイスの最新技術と課題 1) なぜ SiC が注目されているのか 2) 高温動作ができると何がいいのか 3)SiC-MOSFET
1-2 原子層制御量子ナノ構造のコヒーレント量子効果 Coherent Quantum Effects in Quantum Nano-structure with Atomic Layer Precision Mutsuo Ogura, Research Director of CREST Pho
 1-2 原子層制御量子ナノ構造のコヒーレント量子効果 Coherent Quantum Effects in Quantum Nano-structure with Atomic Layer Precision Mutsuo Ogura, Research Director of CREST Photonics Research Institute, AIST TBAs) AlGaAs/GaAs TBAs)
1-2 原子層制御量子ナノ構造のコヒーレント量子効果 Coherent Quantum Effects in Quantum Nano-structure with Atomic Layer Precision Mutsuo Ogura, Research Director of CREST Photonics Research Institute, AIST TBAs) AlGaAs/GaAs TBAs)
Microsoft PowerPoint - 集積デバイス工学5.ppt
 MO プロセスフロー ( 復習 集積デバイス工学 ( の構成要素 ( 抵抗と容量 素子分離 -well 形成 ゲート形成 拡散領域形成 絶縁膜とコンタクト形成 l 配線形成 6 7 センター藤野毅 MO 領域 MO 領域 MO プロセスフロー ( 復習 素子分離 -well 形成 ゲート形成 拡散領域形成 絶縁膜とコンタクト形成 l 配線形成 i 膜 ウエルポリシリコン + 拡散 + 拡散コンタクト
MO プロセスフロー ( 復習 集積デバイス工学 ( の構成要素 ( 抵抗と容量 素子分離 -well 形成 ゲート形成 拡散領域形成 絶縁膜とコンタクト形成 l 配線形成 6 7 センター藤野毅 MO 領域 MO 領域 MO プロセスフロー ( 復習 素子分離 -well 形成 ゲート形成 拡散領域形成 絶縁膜とコンタクト形成 l 配線形成 i 膜 ウエルポリシリコン + 拡散 + 拡散コンタクト
支援財団研究活動助成 生体超分子を利用利用した 3 次元メモリデバイスメモリデバイスの研究 奈良先端科学技術大学院大学物質創成科学研究科小原孝介
 2009.3.10 支援財団研究活動助成 生体超分子を利用利用した 3 次元メモリデバイスメモリデバイスの研究 奈良先端科学技術大学院大学物質創成科学研究科小原孝介 研究背景研究背景研究背景研究背景データデータデータデータの種類種類種類種類データデータデータデータの保存保存保存保存パソコンパソコンパソコンパソコンパソコンパソコンパソコンパソコンデータデータデータデータデータデータデータデータ音楽音楽音楽音楽音楽音楽音楽音楽写真写真写真写真記録媒体記録媒体記録媒体記録媒体フラッシュメモリフラッシュメモリフラッシュメモリフラッシュメモリ動画動画動画動画
2009.3.10 支援財団研究活動助成 生体超分子を利用利用した 3 次元メモリデバイスメモリデバイスの研究 奈良先端科学技術大学院大学物質創成科学研究科小原孝介 研究背景研究背景研究背景研究背景データデータデータデータの種類種類種類種類データデータデータデータの保存保存保存保存パソコンパソコンパソコンパソコンパソコンパソコンパソコンパソコンデータデータデータデータデータデータデータデータ音楽音楽音楽音楽音楽音楽音楽音楽写真写真写真写真記録媒体記録媒体記録媒体記録媒体フラッシュメモリフラッシュメモリフラッシュメモリフラッシュメモリ動画動画動画動画
PowerPoint プレゼンテーション
 グラフェンデバイスの電子状態のナノ分析 吹留博一 1) 永村直佳 ), 3) 篠原稔宏 ) 井出隆之 1) 黒角翔大 ) 豊田智史 ),3) 堀場弘司 ),3) 長汐晃輔 ) 末光真希 1) 鳥海明 ) 尾嶋正治 ),3) 1) 東北大学電気通信研究所 ) 東京大学大学院工学研究科, 3) 東京大学放射光連携機構 ( 今回の発表内容は 011A/B 期 S 課題 ( 堀場 ) の一部 011B 期
グラフェンデバイスの電子状態のナノ分析 吹留博一 1) 永村直佳 ), 3) 篠原稔宏 ) 井出隆之 1) 黒角翔大 ) 豊田智史 ),3) 堀場弘司 ),3) 長汐晃輔 ) 末光真希 1) 鳥海明 ) 尾嶋正治 ),3) 1) 東北大学電気通信研究所 ) 東京大学大学院工学研究科, 3) 東京大学放射光連携機構 ( 今回の発表内容は 011A/B 期 S 課題 ( 堀場 ) の一部 011B 期
<4D F736F F F696E74202D208FE393635F928289BB95A894BC93B191CC8CA48B8689EF5F47614E F815B835E5F88F38DFC97702E707074>
 21 年 6 月 24 日第 8 回窒化物半導体応用研究会 GaN 系電子デバイスの現状とその可能性 GaN パワーデバイスのインバータ応用 パナソニック株式会社 セミコンダクター社半導体デバイス研究センター 上田哲三 講演内容 GaNインバータによる省エネルギー化 GaNパワーデバイス技術 低コストSi 基板上 GaN 結晶成長 ノーマリオフ化 : Gate Injection Transistor
21 年 6 月 24 日第 8 回窒化物半導体応用研究会 GaN 系電子デバイスの現状とその可能性 GaN パワーデバイスのインバータ応用 パナソニック株式会社 セミコンダクター社半導体デバイス研究センター 上田哲三 講演内容 GaNインバータによる省エネルギー化 GaNパワーデバイス技術 低コストSi 基板上 GaN 結晶成長 ノーマリオフ化 : Gate Injection Transistor
Microsoft PowerPoint - 集積回路工学(5)_ pptm
 集積回路工学 東京工業大学大学院理工学研究科電子物理工学専攻 松澤昭 2009/0/4 集積回路工学 A.Matuzawa (5MOS 論理回路の電気特性とスケーリング則 資料は松澤研のホームページ htt://c.e.titech.ac.j にあります 2009/0/4 集積回路工学 A.Matuzawa 2 インバータ回路 このようなインバータ回路をシミュレーションした 2009/0/4 集積回路工学
集積回路工学 東京工業大学大学院理工学研究科電子物理工学専攻 松澤昭 2009/0/4 集積回路工学 A.Matuzawa (5MOS 論理回路の電気特性とスケーリング則 資料は松澤研のホームページ htt://c.e.titech.ac.j にあります 2009/0/4 集積回路工学 A.Matuzawa 2 インバータ回路 このようなインバータ回路をシミュレーションした 2009/0/4 集積回路工学
<4D F736F F F696E74202D2091E F BB95A894BC93B191CC899E97708CA48B8689EF E9197BF>
 1 豊田合成の GaN 系 LED の開発と製品化 豊田合成株式会社オプト E 事業部柴田直樹 Outline 2 A. TG LED チップの歴史と特性の紹介 PC タブレット向けチップ 照明向けチップ B. TG の結晶成長技術について AlN バッファ層上 GaN 層成長メカニズム C. TG の最新 LED チップの紹介 GaN 基板上 LED 非極性 m 面 GaN LED A-1. 省エネ
1 豊田合成の GaN 系 LED の開発と製品化 豊田合成株式会社オプト E 事業部柴田直樹 Outline 2 A. TG LED チップの歴史と特性の紹介 PC タブレット向けチップ 照明向けチップ B. TG の結晶成長技術について AlN バッファ層上 GaN 層成長メカニズム C. TG の最新 LED チップの紹介 GaN 基板上 LED 非極性 m 面 GaN LED A-1. 省エネ
<4D F736F F D2097CA8E718CF889CA F E F E2E646F63>
 量子効果デバイス第 11 回 前澤宏一 トンネル効果とフラッシュメモリ デバイスサイズの縮小縮小とトンネルトンネル効果 Si-CMOS はサイズの縮小を続けることによってその性能を伸ばしてきた チャネル長や ゲート絶縁膜の厚さ ソース ドレイン領域の深さ 電源電圧をあるルール ( これをスケーリング則という ) に従って縮小することで 高速化 低消費電力化が可能となる 集積回路の誕生以来 スケーリング側にしたがって縮小されてきたデバイスサイズは
量子効果デバイス第 11 回 前澤宏一 トンネル効果とフラッシュメモリ デバイスサイズの縮小縮小とトンネルトンネル効果 Si-CMOS はサイズの縮小を続けることによってその性能を伸ばしてきた チャネル長や ゲート絶縁膜の厚さ ソース ドレイン領域の深さ 電源電圧をあるルール ( これをスケーリング則という ) に従って縮小することで 高速化 低消費電力化が可能となる 集積回路の誕生以来 スケーリング側にしたがって縮小されてきたデバイスサイズは
軽量なパワーデバイス 或いは Si 半導体デバイスでは実現できない過酷な環境で動作する耐熱 耐放射線性デバイスの作製材料として期待されている さらに SiC は Si 同様熱酸化により絶縁膜を作製できるため 次世代の MOS(Metal Oxide Semiconductor) 型パワーデバイスの作
 SiC パワーデバイス開発のためのシミュレーション プロジェクト責任者 大沼敏治財団法人電力中央研究所 著 者 大沼 敏治 * 1 宮下 敦巳 * 2 吉川 正人 * 2 土田秀一 * 1 岩沢美佐子 * 3 * 1 財団法人 電力中央研究所 * 2 独立行政法人日本原子力研究開発機構 * 3 独立行政法人海洋研究開発機構 利用施設 : 独立行政法人海洋研究開発機構地球シミュレータ 利用期間 : 平成
SiC パワーデバイス開発のためのシミュレーション プロジェクト責任者 大沼敏治財団法人電力中央研究所 著 者 大沼 敏治 * 1 宮下 敦巳 * 2 吉川 正人 * 2 土田秀一 * 1 岩沢美佐子 * 3 * 1 財団法人 電力中央研究所 * 2 独立行政法人日本原子力研究開発機構 * 3 独立行政法人海洋研究開発機構 利用施設 : 独立行政法人海洋研究開発機構地球シミュレータ 利用期間 : 平成
PowerPoint プレゼンテーション
 2-1 情報デバイス工学特論 第 2 回 MOT の基本特性 最初に半導体の電子状態について復習 2-2 i 結晶 エネルギー 分子の形成 2-3 原子 エネルギー 反結合状態結合状態反結合状態 分子 結合状態 波動関数.4 電子のエネルギー.3.2.1 -.1 -.2 結合エネルギー 反結合状態 2 4 6 8 結合状態 原子間の距離 ボンド長 結晶における電子のエネルギー 2-4 原子間距離大
2-1 情報デバイス工学特論 第 2 回 MOT の基本特性 最初に半導体の電子状態について復習 2-2 i 結晶 エネルギー 分子の形成 2-3 原子 エネルギー 反結合状態結合状態反結合状態 分子 結合状態 波動関数.4 電子のエネルギー.3.2.1 -.1 -.2 結合エネルギー 反結合状態 2 4 6 8 結合状態 原子間の距離 ボンド長 結晶における電子のエネルギー 2-4 原子間距離大
研究の背景 世界のエネルギー消費量は年々増加傾向にあり, 地球規模のエネルギー不足が懸念さ れています このため, 発電により生み出したエネルギー ( 電力 ) の利用の更なる高効 率化が求められており, その鍵は電力制御を担っているパワーデバイス ( 6) が握っ ています 現在主流である Si(
 News Release 平成 30 年 4 月 27 日 各報道機関文教担当記者 殿 水蒸気とニッケルを用いた非プラズマプロセスによるダイヤモンドの高速 異方性エッチング技術を開発 金沢大学理工研究域電子情報通信学系の德田規夫准教授, 大学院自然科学研究科電子情報科学専攻博士後期課程の長井雅嗣氏らの研究グループ ( 薄膜電子工学研究室 ) は, 国立研究開発法人産業技術総合研究所先進パワーエレクトロニクス研究センターダイヤモンドデバイスチームの牧野俊晴研究チーム長,
News Release 平成 30 年 4 月 27 日 各報道機関文教担当記者 殿 水蒸気とニッケルを用いた非プラズマプロセスによるダイヤモンドの高速 異方性エッチング技術を開発 金沢大学理工研究域電子情報通信学系の德田規夫准教授, 大学院自然科学研究科電子情報科学専攻博士後期課程の長井雅嗣氏らの研究グループ ( 薄膜電子工学研究室 ) は, 国立研究開発法人産業技術総合研究所先進パワーエレクトロニクス研究センターダイヤモンドデバイスチームの牧野俊晴研究チーム長,
13 2 9
 13 9 1 1.1 MOS ASIC 1.1..3.4.5.6.7 3 p 3.1 p 3. 4 MOS 4.1 MOS 4. p MOS 4.3 5 CMOS NAND NOR 5.1 5. CMOS 5.3 CMOS NAND 5.4 CMOS NOR 5.5 .1.1 伝導帯 E C 禁制帯 E g E g E v 価電子帯 図.1 半導体のエネルギー帯. 5 4 伝導帯 E C 伝導電子
13 9 1 1.1 MOS ASIC 1.1..3.4.5.6.7 3 p 3.1 p 3. 4 MOS 4.1 MOS 4. p MOS 4.3 5 CMOS NAND NOR 5.1 5. CMOS 5.3 CMOS NAND 5.4 CMOS NOR 5.5 .1.1 伝導帯 E C 禁制帯 E g E g E v 価電子帯 図.1 半導体のエネルギー帯. 5 4 伝導帯 E C 伝導電子
開発の社会的背景 パワーデバイスは 電気機器の電力制御に不可欠な半導体デバイスであり インバーターの普及に伴い省エネルギー技術の基盤となっている 最近では高電圧 大電流動作が技術的に可能になり ハイブリッド自動車のモーター駆動にも使われるなど急速に普及し 市場規模は 2 兆円に及ぶといわれる パワー
 ダイヤモンドパワーデバイスの高速 高温動作を実証 - 次世代半導体材料としての優位性を確認 - 平成 22 年 9 月 8 日独立行政法人産業技術総合研究所国立大学法人大阪大学 ポイント ダイヤモンドダイオードを用いたパワーデバイス用整流素子の動作を世界で初めて確認 高速かつ低損失の動作を確認でき 将来の実用化に期待 将来のパワーデバイスとして省エネルギー効果に期待 概要 独立行政法人産業技術総合研究所
ダイヤモンドパワーデバイスの高速 高温動作を実証 - 次世代半導体材料としての優位性を確認 - 平成 22 年 9 月 8 日独立行政法人産業技術総合研究所国立大学法人大阪大学 ポイント ダイヤモンドダイオードを用いたパワーデバイス用整流素子の動作を世界で初めて確認 高速かつ低損失の動作を確認でき 将来の実用化に期待 将来のパワーデバイスとして省エネルギー効果に期待 概要 独立行政法人産業技術総合研究所
電子回路I_6.ppt
 電子回路 Ⅰ 第 6 回 電子回路 Ⅰ 7 講義内容. 半導体素子 ( ダイオードとトランジスタ ). 基本回路 3. 増幅回路 バイポーラトランジスタの パラメータと小信号等価回路 二端子対回路 パラメータ 小信号等価回路 FET(MOFET) の基本増幅回路と等価回路 MOFET の基本増幅回路 MOFET の小信号等価回路 電子回路 Ⅰ 7 増幅回路の入出力インピーダンス 増幅度 ( 利得 )
電子回路 Ⅰ 第 6 回 電子回路 Ⅰ 7 講義内容. 半導体素子 ( ダイオードとトランジスタ ). 基本回路 3. 増幅回路 バイポーラトランジスタの パラメータと小信号等価回路 二端子対回路 パラメータ 小信号等価回路 FET(MOFET) の基本増幅回路と等価回路 MOFET の基本増幅回路 MOFET の小信号等価回路 電子回路 Ⅰ 7 増幅回路の入出力インピーダンス 増幅度 ( 利得 )
Microsoft PowerPoint - 4.1I-V特性.pptx
 4.1 I-V 特性 MOSFET 特性とモデル 1 物理レベルの設計 第 3 章までに システム~ トランジスタレベルまでの設計の概要を学んだが 製造するためには さらに物理的パラメータ ( 寸法など ) が必要 物理的パラメータの決定には トランジスタの特性を理解する必要がある ゲート内の配線の太さ = 最小加工寸法 物理的パラメータの例 電源配線の太さ = 電源ラインに接続されるゲート数 (
4.1 I-V 特性 MOSFET 特性とモデル 1 物理レベルの設計 第 3 章までに システム~ トランジスタレベルまでの設計の概要を学んだが 製造するためには さらに物理的パラメータ ( 寸法など ) が必要 物理的パラメータの決定には トランジスタの特性を理解する必要がある ゲート内の配線の太さ = 最小加工寸法 物理的パラメータの例 電源配線の太さ = 電源ラインに接続されるゲート数 (
Microsoft PowerPoint - summer_school_for_web_ver2.pptx
 スピン流で観る物理現象 大阪大学大学院理学研究科物理学専攻 新見康洋 スピントロニクスとは スピン エレクトロニクス メモリ産業と深くつなが ている メモリ産業と深くつながっている スピン ハードディスクドライブの読み取りヘッド N 電荷 -e スピンの流れ ピ の流れ スピン流 S 巨大磁気抵抗効果 ((GMR)) from http://en.wikipedia.org/wiki/disk_readand-write_head
スピン流で観る物理現象 大阪大学大学院理学研究科物理学専攻 新見康洋 スピントロニクスとは スピン エレクトロニクス メモリ産業と深くつなが ている メモリ産業と深くつながっている スピン ハードディスクドライブの読み取りヘッド N 電荷 -e スピンの流れ ピ の流れ スピン流 S 巨大磁気抵抗効果 ((GMR)) from http://en.wikipedia.org/wiki/disk_readand-write_head
高耐圧SiC MOSFET
 エレクトロニクス 高耐圧 S i C M O S F E T 木村錬 * 内田光亮 日吉透酒井光彦 和田圭司 御神村泰樹 SiC High Blocking Voltage Transistor by Ren Kimura, Kousuke Uchida, Toru Hiyoshi, Mitsuhiko Sakai, Keiji Wada and Yasuki Mikamura Recently,
エレクトロニクス 高耐圧 S i C M O S F E T 木村錬 * 内田光亮 日吉透酒井光彦 和田圭司 御神村泰樹 SiC High Blocking Voltage Transistor by Ren Kimura, Kousuke Uchida, Toru Hiyoshi, Mitsuhiko Sakai, Keiji Wada and Yasuki Mikamura Recently,
Microsoft PowerPoint - 集積デバイス工学2.ppt
 チップレイアウトパターン ( 全体例 ) 集積デバイス工学 () LSI の製造プロセス VLSI センター藤野毅 MOS トランジスタの基本構造 MOS トランジスタの基本構造 絶縁膜 絶縁膜 p 型シリコン 断面図 n 型シリコン p 型シリコン 断面図 n 型シリコン 破断面 破断面 トランジスタゲート幅 W 平面図 4 トランジスタゲート長 L 平面図 MOS トランジスタ (Tr) の構造
チップレイアウトパターン ( 全体例 ) 集積デバイス工学 () LSI の製造プロセス VLSI センター藤野毅 MOS トランジスタの基本構造 MOS トランジスタの基本構造 絶縁膜 絶縁膜 p 型シリコン 断面図 n 型シリコン p 型シリコン 断面図 n 型シリコン 破断面 破断面 トランジスタゲート幅 W 平面図 4 トランジスタゲート長 L 平面図 MOS トランジスタ (Tr) の構造
スライド 1
 SPring-8 利用推進協議会次世代先端デバイス研究会 ( 第 1 回 ) a-igzo 薄膜の局所構造及び電子状態解析 コベルコ科研エレクトロニクス事業部安野聡 1 1. 背景 a-ingazno(igzo) の特徴と課題 2. 研究の目的 Outline 研究事例の紹介 3. XAFSによるa-IGZO 薄膜の局所構造解析 4. a-igzo 薄膜における諸特性の成膜ガス圧力依存性 (HAXPES)
SPring-8 利用推進協議会次世代先端デバイス研究会 ( 第 1 回 ) a-igzo 薄膜の局所構造及び電子状態解析 コベルコ科研エレクトロニクス事業部安野聡 1 1. 背景 a-ingazno(igzo) の特徴と課題 2. 研究の目的 Outline 研究事例の紹介 3. XAFSによるa-IGZO 薄膜の局所構造解析 4. a-igzo 薄膜における諸特性の成膜ガス圧力依存性 (HAXPES)
Microsoft PowerPoint - 集積デバイス工学7.ppt
 集積デバイス工学 (7 問題 追加課題 下のトランジスタが O する電圧範囲を求めよただし T, T - とする >6 問題 P 型 MOS トランジスタについて 正孔の実効移動度 μ.7[m/ s], ゲート長.[μm], ゲート幅 [μm] しきい値電圧 -., 単位面積あたりの酸化膜容量
集積デバイス工学 (7 問題 追加課題 下のトランジスタが O する電圧範囲を求めよただし T, T - とする >6 問題 P 型 MOS トランジスタについて 正孔の実効移動度 μ.7[m/ s], ゲート長.[μm], ゲート幅 [μm] しきい値電圧 -., 単位面積あたりの酸化膜容量
Microsoft PowerPoint - 2.devi2008.ppt
 第 2 章集積回路のデバイス MOSトランジスタダイオード抵抗容量インダクタンス配線 広島大学岩田穆 1 半導体とは? 電気を通す鉄 アルミニウムなどの金属は導体 電気を通さないガラス ゴムなどは絶縁体 電気を通したり, 通さなかったり, 条件によって, 導体と絶縁体の両方の性質を持つことのできる物質を半導体半導体の代表例はシリコン 電気伝導率 広島大学岩田穆 2 半導体技術で扱っている大きさ 間の大きさ一般的な技術現在研究しているところナノメートル
第 2 章集積回路のデバイス MOSトランジスタダイオード抵抗容量インダクタンス配線 広島大学岩田穆 1 半導体とは? 電気を通す鉄 アルミニウムなどの金属は導体 電気を通さないガラス ゴムなどは絶縁体 電気を通したり, 通さなかったり, 条件によって, 導体と絶縁体の両方の性質を持つことのできる物質を半導体半導体の代表例はシリコン 電気伝導率 広島大学岩田穆 2 半導体技術で扱っている大きさ 間の大きさ一般的な技術現在研究しているところナノメートル
F 1 2 dc dz ( V V V sin t 2 S DC AC ) 1 2 dc dc 1 dc {( VS VDC ) VAC} ( VS VDC ) VAC sin t VAC cos 2 t (3.2.2) 2 dz 2 dz 4 dz 静電気力には (3.2.2) 式の右
 3-2 ケルビンプローブフォース顕微鏡による仕事関数の定量測定 3-2-1 KFM の測定原理ケルビンプローブフォース顕微鏡 (Kelvin Force Microscopy: KFM) は ケルビン法という測定技術を AFM に応用した計測手法で 静電気力によるプローブ振動の計測を利用して プローブとサンプルの仕事関数差を測定するプローブ顕微鏡の手法である 仕事関数というのは 金属の表面から電子を無限遠まで取り出すのに必要なエネルギーであり
3-2 ケルビンプローブフォース顕微鏡による仕事関数の定量測定 3-2-1 KFM の測定原理ケルビンプローブフォース顕微鏡 (Kelvin Force Microscopy: KFM) は ケルビン法という測定技術を AFM に応用した計測手法で 静電気力によるプローブ振動の計測を利用して プローブとサンプルの仕事関数差を測定するプローブ顕微鏡の手法である 仕事関数というのは 金属の表面から電子を無限遠まで取り出すのに必要なエネルギーであり
 1-x x µ (+) +z µ ( ) Co 2p 3d µ = µ (+) µ ( ) W. Grange et al., PRB 58, 6298 (1998). 1.0 0.5 0.0 2 1 XMCD 0-1 -2-3x10-3 7.1 7.2 7.7 7.8 8.3 8.4 up E down ρ + (E) ρ (E) H, M µ f + f E F f + f f + f X L
1-x x µ (+) +z µ ( ) Co 2p 3d µ = µ (+) µ ( ) W. Grange et al., PRB 58, 6298 (1998). 1.0 0.5 0.0 2 1 XMCD 0-1 -2-3x10-3 7.1 7.2 7.7 7.8 8.3 8.4 up E down ρ + (E) ρ (E) H, M µ f + f E F f + f f + f X L
< F91E F1835C D835E815B8CA48B8689EF5F8FE396EC2E786477>
 2011 年 5 月 20 日 第 4 回ソフトマター研究会 産業利用における GISAXS の活用 東レリサーチセンター構造化学研究部構造化学第 2 研究室岡田一幸 1. 小角 X 線散乱 ( 反射測定 ) 薄膜中のポア (Low-k 膜 ) 2.GISAXS による粒子サイズ評価 薄膜に析出した結晶 (High-k 膜 ) 3. ポリマーの秩序構造の評価 ブロックコポリマーの自己組織化過程 4.
2011 年 5 月 20 日 第 4 回ソフトマター研究会 産業利用における GISAXS の活用 東レリサーチセンター構造化学研究部構造化学第 2 研究室岡田一幸 1. 小角 X 線散乱 ( 反射測定 ) 薄膜中のポア (Low-k 膜 ) 2.GISAXS による粒子サイズ評価 薄膜に析出した結晶 (High-k 膜 ) 3. ポリマーの秩序構造の評価 ブロックコポリマーの自己組織化過程 4.
untitled
 /Si FET /Si FET Improvement of tunnel FET performance using narrow bandgap semiconductor silicide Improvement /Si hetero-structure of tunnel FET performance source electrode using narrow bandgap semiconductor
/Si FET /Si FET Improvement of tunnel FET performance using narrow bandgap semiconductor silicide Improvement /Si hetero-structure of tunnel FET performance source electrode using narrow bandgap semiconductor
Microsoft PowerPoint - SDF2007_nakanishi_2.ppt[読み取り専用]
![Microsoft PowerPoint - SDF2007_nakanishi_2.ppt[読み取り専用] Microsoft PowerPoint - SDF2007_nakanishi_2.ppt[読み取り専用]](/thumbs/94/118227082.jpg) ばらつきの計測と解析技術 7 年 月 日設計基盤開発部先端回路技術グループ中西甚吾 内容. はじめに. DMA(Device Matrix Array)-TEG. チップ間 チップ内ばらつきの比較. ばらつきの成分分離. 各ばらつき成分の解析. まとめ . はじめに 背景 スケーリングにともない さまざまなばらつきの現象が顕著化しており この先ますます設計困難化が予想される EDA ツール 回路方式
ばらつきの計測と解析技術 7 年 月 日設計基盤開発部先端回路技術グループ中西甚吾 内容. はじめに. DMA(Device Matrix Array)-TEG. チップ間 チップ内ばらつきの比較. ばらつきの成分分離. 各ばらつき成分の解析. まとめ . はじめに 背景 スケーリングにともない さまざまなばらつきの現象が顕著化しており この先ますます設計困難化が予想される EDA ツール 回路方式
2 磁性薄膜を用いたデバイスを動作させるには ( 磁気記録装置 (HDD) を例に ) コイルに電流を流すことで発生する磁界を用いて 薄膜の磁化方向を制御している
 1 磁化方向の電圧制御とそのメモリ センサ 光デバイスへの応用 秋田大学大学院工学資源学研究科 附属理工学研究センター 准教授 吉村哲 2 磁性薄膜を用いたデバイスを動作させるには ( 磁気記録装置 (HDD) を例に ) コイルに電流を流すことで発生する磁界を用いて 薄膜の磁化方向を制御している 3 従来技術とその問題点 エネルギーロスの大きい電流磁界により磁化反転を行っており 消費電力が高い 発生可能な磁界に限界があり(
1 磁化方向の電圧制御とそのメモリ センサ 光デバイスへの応用 秋田大学大学院工学資源学研究科 附属理工学研究センター 准教授 吉村哲 2 磁性薄膜を用いたデバイスを動作させるには ( 磁気記録装置 (HDD) を例に ) コイルに電流を流すことで発生する磁界を用いて 薄膜の磁化方向を制御している 3 従来技術とその問題点 エネルギーロスの大きい電流磁界により磁化反転を行っており 消費電力が高い 発生可能な磁界に限界があり(
研究成果報告書(基金分)
 様式 C-19 F-19 Z-19( 共通 ) 1. 研究開始当初の背景国内外のエネルギー問題に対応するため, 革新的な省 創エネルギーデバイス ( 低消費電力の単電子デバイスや超高効率太陽電池など ) の実現が求められている. そのためには, 機能上重要なビルディングブロックである低次元半導体ナノ材料 ( 量子ドット, 量子細線, 量子井戸など ) の規則配列構造を構築する必要がある. 低次元半導体ナノ材料を決められたサイズ
様式 C-19 F-19 Z-19( 共通 ) 1. 研究開始当初の背景国内外のエネルギー問題に対応するため, 革新的な省 創エネルギーデバイス ( 低消費電力の単電子デバイスや超高効率太陽電池など ) の実現が求められている. そのためには, 機能上重要なビルディングブロックである低次元半導体ナノ材料 ( 量子ドット, 量子細線, 量子井戸など ) の規則配列構造を構築する必要がある. 低次元半導体ナノ材料を決められたサイズ
低転位GaN 基板上の低抵抗・高耐圧GaNダイオード
 エレクトロニクス 低転位 G a N 基板上の低抵抗 高耐圧 G a N ダイオード 住 吉 和 英 * 岡 田 政 也 上 野 昌 紀 木 山 誠 中 村 孝 夫 Low On-Resistance and High Breakdown Voltage GaN SBD on Low Dislocation Density GaN Substrates by Kazuhide Sumiyoshi,
エレクトロニクス 低転位 G a N 基板上の低抵抗 高耐圧 G a N ダイオード 住 吉 和 英 * 岡 田 政 也 上 野 昌 紀 木 山 誠 中 村 孝 夫 Low On-Resistance and High Breakdown Voltage GaN SBD on Low Dislocation Density GaN Substrates by Kazuhide Sumiyoshi,
 2 1 7 - TALK ABOUT 21 μ TALK ABOUT 21 Ag As Se 2. 2. 2. Ag As Se 1 2 3 4 5 6 7 8 9 1 1 2 3 4 5 6 7 8 9 1 1 2 3 4 5 6 7 8 9 1 Sb Ga Te 2. Sb 2. Ga 2. Te 1 2 3 4 5 6 7 8 9 1 1 2 3 4 5 6 7 8 9 1 1 2 3 4
2 1 7 - TALK ABOUT 21 μ TALK ABOUT 21 Ag As Se 2. 2. 2. Ag As Se 1 2 3 4 5 6 7 8 9 1 1 2 3 4 5 6 7 8 9 1 1 2 3 4 5 6 7 8 9 1 Sb Ga Te 2. Sb 2. Ga 2. Te 1 2 3 4 5 6 7 8 9 1 1 2 3 4 5 6 7 8 9 1 1 2 3 4
スライド 1
 1 2017/8/3 GaN とほぼ格子整合する 新しい ITO 膜の形成技術 京都工芸繊維大学電気電子工学系 助教 西中浩之 2 発明の概要 ビックスバイト構造 (bcc-ito) 安定相 菱面体晶構造 (rh-ito) 準安定相 現在利用されている ITO は全て ビックスバイト構造もしくは非晶質 菱面体晶構造 (rh-ito) は合成に高圧が必要なため 作製例がほとんどなかった 新技術では この
1 2017/8/3 GaN とほぼ格子整合する 新しい ITO 膜の形成技術 京都工芸繊維大学電気電子工学系 助教 西中浩之 2 発明の概要 ビックスバイト構造 (bcc-ito) 安定相 菱面体晶構造 (rh-ito) 準安定相 現在利用されている ITO は全て ビックスバイト構造もしくは非晶質 菱面体晶構造 (rh-ito) は合成に高圧が必要なため 作製例がほとんどなかった 新技術では この
PowerPoint プレゼンテーション
 2004 SPring-8 2004/6/21 CMOS 2004 2007 2010 2013 nm 90 65 45 32 (nm) 1.2 0.9 0.7 0.6 High-performance Logic Technology Requirements (ITRS 2003) 10 Photoelectron Intensity (arb.units) CTR a-sio2 0.1 HfO
2004 SPring-8 2004/6/21 CMOS 2004 2007 2010 2013 nm 90 65 45 32 (nm) 1.2 0.9 0.7 0.6 High-performance Logic Technology Requirements (ITRS 2003) 10 Photoelectron Intensity (arb.units) CTR a-sio2 0.1 HfO
600 V系スーパージャンクション パワーMOSFET TO-247-4Lパッケージのシミュレーションによる解析
 [17.7 White Paper] 6 V 系スーパージャンクションパワー MOSFET TO-247-4L パッケージのシミュレーションによる解析 MOSFET チップの高速スイッチング性能をより引き出すことができる 4 ピン新パッケージ TO-247-4L 背景 耐圧が 6V 以上の High Voltage(HV) パワー半導体ではオン抵抗と耐圧のトレードオフの改善を行うためスーパージャンクション
[17.7 White Paper] 6 V 系スーパージャンクションパワー MOSFET TO-247-4L パッケージのシミュレーションによる解析 MOSFET チップの高速スイッチング性能をより引き出すことができる 4 ピン新パッケージ TO-247-4L 背景 耐圧が 6V 以上の High Voltage(HV) パワー半導体ではオン抵抗と耐圧のトレードオフの改善を行うためスーパージャンクション
SiC JFET による高速スイッチング電源
 エレクトロニクス S i C J F E T による高速スイッチング電源 初 川 聡 * 築 野 孝 藤 川 一 洋 志 賀 信 夫 ウリントヤ 和 田 和 千 大 平 孝 High-Speed Switching Power Supply Using SiC RESURF JFETs by Satoshi Hatsukawa, Takashi Tsuno, Kazuhiro Fujikawa, Nobuo
エレクトロニクス S i C J F E T による高速スイッチング電源 初 川 聡 * 築 野 孝 藤 川 一 洋 志 賀 信 夫 ウリントヤ 和 田 和 千 大 平 孝 High-Speed Switching Power Supply Using SiC RESURF JFETs by Satoshi Hatsukawa, Takashi Tsuno, Kazuhiro Fujikawa, Nobuo
α α α α α α
 α α α α α α 映像情報メディア学会誌 Vol. 71, No. 10 2017 図 1 レーザビーム方式 図 3 PLAS の断面構造 図 3 に PLAS の断面構造を示す PLAS はゲート電極上の チャネル部の部分的な領域のみをフォトマスクとエッチン グなしに結晶化することが可能である 従来のラインビー ム装置はゲート電極上 テーパー上 ガラス上などの表面 の結晶性制御の課題がある
α α α α α α 映像情報メディア学会誌 Vol. 71, No. 10 2017 図 1 レーザビーム方式 図 3 PLAS の断面構造 図 3 に PLAS の断面構造を示す PLAS はゲート電極上の チャネル部の部分的な領域のみをフォトマスクとエッチン グなしに結晶化することが可能である 従来のラインビー ム装置はゲート電極上 テーパー上 ガラス上などの表面 の結晶性制御の課題がある
Microsystem Integration & Packaging Laboratory
 2015/01/26 MemsONE 技術交流会 解析事例紹介 東京大学実装工学分野研究室奥村拳 Microsystem Integration and Packaging Laboratory 1 事例紹介 1. 解析の背景高出力半導体レーザの高放熱構造 2. 熱伝導解析解析モデルの概要 3. チップサイズの熱抵抗への影響 4. 接合材料の熱抵抗への影響 5. ヒートシンク材料の熱抵抗への影響 Microsystem
2015/01/26 MemsONE 技術交流会 解析事例紹介 東京大学実装工学分野研究室奥村拳 Microsystem Integration and Packaging Laboratory 1 事例紹介 1. 解析の背景高出力半導体レーザの高放熱構造 2. 熱伝導解析解析モデルの概要 3. チップサイズの熱抵抗への影響 4. 接合材料の熱抵抗への影響 5. ヒートシンク材料の熱抵抗への影響 Microsystem
Microsoft PowerPoint - アナログ電子回路3回目.pptx
 アナログ電 回路 3-1 電気回路で考える素 ( 能動素 ) 抵抗 コイル コンデンサ v v v 3-2 理 学部 材料機能 学科岩 素顕 iwaya@meijo-u.ac.jp トランジスタ トランジスタとは? トランジスタの基本的な動作は? バイポーラトランジスタ JFET MOFET ( エンハンスメント型 デプレッション型 ) i R i L i C v Ri di v L dt i C
アナログ電 回路 3-1 電気回路で考える素 ( 能動素 ) 抵抗 コイル コンデンサ v v v 3-2 理 学部 材料機能 学科岩 素顕 iwaya@meijo-u.ac.jp トランジスタ トランジスタとは? トランジスタの基本的な動作は? バイポーラトランジスタ JFET MOFET ( エンハンスメント型 デプレッション型 ) i R i L i C v Ri di v L dt i C
研究成果報告書
 ① ア ニ ー ル 温 度 の 違 い に よ る ナ ノ 構 造 制御 論文④ ⑤関連 シード層として Ti を用い Ag/Ti 薄膜を MgO(001)基板上に室温蒸着させた後にアニ ール処理を施す その際 アニール条件 温 度 時間 を変えた場合の基板上に形成され る Ag ナノ構造の変化について調べた Fig.1 の薄膜表面の原子間力顕微鏡 AFM 像に見られるように (a)ti シード層
① ア ニ ー ル 温 度 の 違 い に よ る ナ ノ 構 造 制御 論文④ ⑤関連 シード層として Ti を用い Ag/Ti 薄膜を MgO(001)基板上に室温蒸着させた後にアニ ール処理を施す その際 アニール条件 温 度 時間 を変えた場合の基板上に形成され る Ag ナノ構造の変化について調べた Fig.1 の薄膜表面の原子間力顕微鏡 AFM 像に見られるように (a)ti シード層
Microsoft PowerPoint - EUPS.ppt [互換モード]
![Microsoft PowerPoint - EUPS.ppt [互換モード] Microsoft PowerPoint - EUPS.ppt [互換モード]](/thumbs/96/128125575.jpg) 最表面原子の電子状態を捉える EUPS 独立行政法人産業技術総合研究所計測フロンティア研究部門 富江敏尚 EUPS 分析の特長 1. 最表面原子が見える ( 界面も見える : 深さ分解能.5nm) 2. バンド曲がりが評価できる 3. 絶縁薄膜が帯電しない 4.( 絶縁物も ) 仕事関数が評価できる 5.( ナノ粒子も ) 最表面の金属性が評価できる 6. ( ナノ粒子も ) 最表面原子の電子雲の角度分布が評価できる
最表面原子の電子状態を捉える EUPS 独立行政法人産業技術総合研究所計測フロンティア研究部門 富江敏尚 EUPS 分析の特長 1. 最表面原子が見える ( 界面も見える : 深さ分解能.5nm) 2. バンド曲がりが評価できる 3. 絶縁薄膜が帯電しない 4.( 絶縁物も ) 仕事関数が評価できる 5.( ナノ粒子も ) 最表面の金属性が評価できる 6. ( ナノ粒子も ) 最表面原子の電子雲の角度分布が評価できる
ポイント 太陽電池用の高性能な酸化チタン極薄膜の詳細な構造が解明できていなかったため 高性能化への指針が不十分であった 非常に微小な領域が観察できる顕微鏡と化学的な結合の状態を調査可能な解析手法を組み合わせることにより 太陽電池応用に有望な酸化チタンの詳細構造を明らかにした 詳細な構造の解明により
 この度 名古屋大学大学院工学研究科の望月健矢大学院生 後藤和泰助教 黒川康良准教授 山本剛久教授 宇佐美徳隆教授らは 太陽電池への応用に有 望な電気的特性を示す酸化チタン注 1) 極薄膜を開発しました さらに その微小領域 の構造を明らかにすることに世界で初めて成功しました 近年 原子層堆積法注 2) を用いて製膜した酸化チタン薄膜は 結晶シリコン注 3) の太 陽電池において 光で生成した電子を収集する材料として優れた特性を示すため
この度 名古屋大学大学院工学研究科の望月健矢大学院生 後藤和泰助教 黒川康良准教授 山本剛久教授 宇佐美徳隆教授らは 太陽電池への応用に有 望な電気的特性を示す酸化チタン注 1) 極薄膜を開発しました さらに その微小領域 の構造を明らかにすることに世界で初めて成功しました 近年 原子層堆積法注 2) を用いて製膜した酸化チタン薄膜は 結晶シリコン注 3) の太 陽電池において 光で生成した電子を収集する材料として優れた特性を示すため
Microsoft PowerPoint - S-17.ppt
 In situ XRD および XAFS を用いた燃料電池アノード触媒電極の劣化解析 日本電気 ( 株 ) 松本匡史 m-matsumoto@jv.jp.nec.com 直接型メタノール燃料電池の PtRu アノードにおいて Ru は触媒被毒の原因である CO の酸化を促進する役割を持ち 電池出力の向上に不可欠な要素である しかし 長時間運転時には Ru が溶出し 性能が劣化する Ru 溶出は 運転時の
In situ XRD および XAFS を用いた燃料電池アノード触媒電極の劣化解析 日本電気 ( 株 ) 松本匡史 m-matsumoto@jv.jp.nec.com 直接型メタノール燃料電池の PtRu アノードにおいて Ru は触媒被毒の原因である CO の酸化を促進する役割を持ち 電池出力の向上に不可欠な要素である しかし 長時間運転時には Ru が溶出し 性能が劣化する Ru 溶出は 運転時の
MOSFET HiSIM HiSIM2 1
 MOSFET 2007 11 19 HiSIM HiSIM2 1 p/n Junction Shockley - - on-quasi-static - - - Y- HiSIM2 2 Wilson E f E c E g E v Bandgap: E g Fermi Level: E f HiSIM2 3 a Si 1s 2s 2p 3s 3p HiSIM2 4 Fermi-Dirac Distribution
MOSFET 2007 11 19 HiSIM HiSIM2 1 p/n Junction Shockley - - on-quasi-static - - - Y- HiSIM2 2 Wilson E f E c E g E v Bandgap: E g Fermi Level: E f HiSIM2 3 a Si 1s 2s 2p 3s 3p HiSIM2 4 Fermi-Dirac Distribution
C-2 NiS A, NSRRC B, SL C, D, E, F A, B, Yen-Fa Liao B, Ku-Ding Tsuei B, C, C, D, D, E, F, A NiS 260 K V 2 O 3 MIT [1] MIT MIT NiS MIT NiS Ni 3 S 2 Ni
![C-2 NiS A, NSRRC B, SL C, D, E, F A, B, Yen-Fa Liao B, Ku-Ding Tsuei B, C, C, D, D, E, F, A NiS 260 K V 2 O 3 MIT [1] MIT MIT NiS MIT NiS Ni 3 S 2 Ni C-2 NiS A, NSRRC B, SL C, D, E, F A, B, Yen-Fa Liao B, Ku-Ding Tsuei B, C, C, D, D, E, F, A NiS 260 K V 2 O 3 MIT [1] MIT MIT NiS MIT NiS Ni 3 S 2 Ni](/thumbs/89/99121913.jpg) M (emu/g) C 2, 8, 9, 10 C-1 Fe 3 O 4 A, SL B, NSRRC C, D, E, F A, B, B, C, Yen-Fa Liao C, Ku-Ding Tsuei C, D, D, E, F, A Fe 3 O 4 120K MIT V 2 O 3 MIT Cu-doped Fe3O4 NCs MIT [1] Fe 3 O 4 MIT Cu V 2 O 3
M (emu/g) C 2, 8, 9, 10 C-1 Fe 3 O 4 A, SL B, NSRRC C, D, E, F A, B, B, C, Yen-Fa Liao C, Ku-Ding Tsuei C, D, D, E, F, A Fe 3 O 4 120K MIT V 2 O 3 MIT Cu-doped Fe3O4 NCs MIT [1] Fe 3 O 4 MIT Cu V 2 O 3
Microsoft PowerPoint - 豊田2008HP閲覧用資料
 核融合プラズマからプラズマプロセスまで - プラズマ中の原子過程 - 研究会 Aug 24. 26 プロセスガス分子およびイオンの同時照射下における表面反応過程の解析 名古屋大学工学研究科電子情報システム専攻 豊田浩孝 高田昇治 木下欣紀 菅井秀郎 Department of Electrical Engineering and omputer Science, Nagoya University
核融合プラズマからプラズマプロセスまで - プラズマ中の原子過程 - 研究会 Aug 24. 26 プロセスガス分子およびイオンの同時照射下における表面反応過程の解析 名古屋大学工学研究科電子情報システム専攻 豊田浩孝 高田昇治 木下欣紀 菅井秀郎 Department of Electrical Engineering and omputer Science, Nagoya University
予定 (川口担当分)
 予定 ( 川口担当分 ) (1)4 月 13 日 量子力学 固体の性質の復習 (2)4 月 20 日 自由電子モデル (3)4 月 27 日 結晶中の電子 (4)5 月 11 日 半導体 (5)5 月 18 日 輸送現象 金属絶縁体転移 (6)5 月 25 日 磁性の基礎 (7)6 月 1 日 物性におけるトポロジー 今日 (5/11) の内容 ブロッホ電子の運動 電磁場中の運動 ランダウ量子化 半導体
予定 ( 川口担当分 ) (1)4 月 13 日 量子力学 固体の性質の復習 (2)4 月 20 日 自由電子モデル (3)4 月 27 日 結晶中の電子 (4)5 月 11 日 半導体 (5)5 月 18 日 輸送現象 金属絶縁体転移 (6)5 月 25 日 磁性の基礎 (7)6 月 1 日 物性におけるトポロジー 今日 (5/11) の内容 ブロッホ電子の運動 電磁場中の運動 ランダウ量子化 半導体
酸化グラフェンのバンドギャップをその場で自在に制御
 同時発表 : 筑波研究学園都市記者会 ( 資料配布 ) 文部科学記者会 ( 資料配布 ) 科学記者会 ( 資料配布 ) 酸化グラフェンのバンドギャップをその場で自在に制御 - 新規炭素系材料を用いた高性能ナノスケール素子に向けて - 配布日時 : 平成 25 年 12 月 16 日 14 時解禁日時 : 平成 25 年 12 月 16 日 20 時独立行政法人物質 材料研究機構概要 1. 独立行政法人物質
同時発表 : 筑波研究学園都市記者会 ( 資料配布 ) 文部科学記者会 ( 資料配布 ) 科学記者会 ( 資料配布 ) 酸化グラフェンのバンドギャップをその場で自在に制御 - 新規炭素系材料を用いた高性能ナノスケール素子に向けて - 配布日時 : 平成 25 年 12 月 16 日 14 時解禁日時 : 平成 25 年 12 月 16 日 20 時独立行政法人物質 材料研究機構概要 1. 独立行政法人物質
PowerPoint Presentation
 半導体電子工学 II 1 全体の内容 日付内容 ( 予定 ) 備考 1 10 月 6 日半導体電子工学 I の基礎 ( 復習 ) 11/01/1 10 月 13 日 接合ダイオード (1) 3 10 月 0 日 4 10 月 7 日 5 11 月 10 日 接合ダイオード () 接合ダイオード (3) 接合ダイオード (4) MOS 構造 (1) 6 11 月 17 日 MOS 構造 () 7 11
半導体電子工学 II 1 全体の内容 日付内容 ( 予定 ) 備考 1 10 月 6 日半導体電子工学 I の基礎 ( 復習 ) 11/01/1 10 月 13 日 接合ダイオード (1) 3 10 月 0 日 4 10 月 7 日 5 11 月 10 日 接合ダイオード () 接合ダイオード (3) 接合ダイオード (4) MOS 構造 (1) 6 11 月 17 日 MOS 構造 () 7 11
2004/4/16 (Power Technology) O 2 ( ) (Information Technology) ( ) Gas (4H) GaN andgap (ev) Electron mobility (cm 2 /Vs)
 ontents semicon.kuee.kyoto-u.ac.jp P 5.47 ev 1.12 ev Ge 0.66 ev Sn 0.08 ev DVD LSI, 3.20 ev GaN 3.42 ev ZnO 2004/4/16 (Power Technology) O 2 ( ) (Information Technology) ( ) Gas (4H) GaN andgap (ev) 1.12
ontents semicon.kuee.kyoto-u.ac.jp P 5.47 ev 1.12 ev Ge 0.66 ev Sn 0.08 ev DVD LSI, 3.20 ev GaN 3.42 ev ZnO 2004/4/16 (Power Technology) O 2 ( ) (Information Technology) ( ) Gas (4H) GaN andgap (ev) 1.12
研究部 歪み Si/Si1-xCx ヘテロ構造の応力制御 研究代表者名山梨大学大学院 医学工学総合研究部 有元圭介 研究分担者名東北大学 金属材料研究所 宇佐美徳隆 1. はじめに圧縮歪み Si/Si1-xCx ヘテロ構造は 従来素子の 2 倍の高正孔移動度が期待される半導体薄膜構造である 移動度を
 研究部 研究課題名 Cu(In,Ga)Se 2 多結晶薄膜の局所構造と太陽電池性能の相関 研究代表者名立命館大学 理工学部 峯元高志 研究分担者名東北大学 金属材料研究所 宇佐美徳隆 1. はじめに太陽電池が 21 世紀を担うクリーンエネルギーとして期待されている 現状では 結晶シリコンが太陽電池材料の主流である 一方 ガラス等の基板上に金属や半導体などの薄膜を堆積させた薄膜型太陽電池が 低コスト
研究部 研究課題名 Cu(In,Ga)Se 2 多結晶薄膜の局所構造と太陽電池性能の相関 研究代表者名立命館大学 理工学部 峯元高志 研究分担者名東北大学 金属材料研究所 宇佐美徳隆 1. はじめに太陽電池が 21 世紀を担うクリーンエネルギーとして期待されている 現状では 結晶シリコンが太陽電池材料の主流である 一方 ガラス等の基板上に金属や半導体などの薄膜を堆積させた薄膜型太陽電池が 低コスト
AN504 Through-hole IRED/Right Angle Type 特長 パッケージ 製品の特長 φ3.6 サイドビュ - タイプ 無色透明樹脂 光出力 : 5mW TYP. (I F =50mA) 鉛フリーはんだ耐熱対応 RoHS 対応 ピーク発光波長指向半値角素子材質ランク選別はん
 特長 パッケージ 製品の特長 φ3.6 サイドビュ - タイプ 無色透明樹脂 光出力 : 5mW TYP. (I F =50mA) 鉛フリーはんだ耐熱対応 RoHS 対応 ピーク発光波長指向半値角素子材質ランク選別はんだ付け方法 ESD 出荷形態 950nm 60 deg. GaAs 放射強度選別を行い ランクごとに選別 半田ディップ マニュアルはんだ実装工程に対応 はんだ付けについては はんだ付け条件をご参照ください
特長 パッケージ 製品の特長 φ3.6 サイドビュ - タイプ 無色透明樹脂 光出力 : 5mW TYP. (I F =50mA) 鉛フリーはんだ耐熱対応 RoHS 対応 ピーク発光波長指向半値角素子材質ランク選別はんだ付け方法 ESD 出荷形態 950nm 60 deg. GaAs 放射強度選別を行い ランクごとに選別 半田ディップ マニュアルはんだ実装工程に対応 はんだ付けについては はんだ付け条件をご参照ください
電子回路I_8.ppt
 電子回路 Ⅰ 第 8 回 電子回路 Ⅰ 9 1 講義内容 1. 半導体素子 ( ダイオードとトランジスタ ) 2. 基本回路 3. 増幅回路 小信号増幅回路 (1) 結合増幅回路 電子回路 Ⅰ 9 2 増幅の原理 増幅度 ( 利得 ) 信号源 増幅回路 負荷 電源 電子回路 Ⅰ 9 3 増幅度と利得 ii io vi 増幅回路 vo 増幅度 v P o o o A v =,Ai =,Ap = = vi
電子回路 Ⅰ 第 8 回 電子回路 Ⅰ 9 1 講義内容 1. 半導体素子 ( ダイオードとトランジスタ ) 2. 基本回路 3. 増幅回路 小信号増幅回路 (1) 結合増幅回路 電子回路 Ⅰ 9 2 増幅の原理 増幅度 ( 利得 ) 信号源 増幅回路 負荷 電源 電子回路 Ⅰ 9 3 増幅度と利得 ii io vi 増幅回路 vo 増幅度 v P o o o A v =,Ai =,Ap = = vi
Title
 SIMS のアーティファクトについて ナノサイエンス株式会社 永山進 1 artifact( アーティファクト ) とは? 辞書を調べると Artifact ( 考古学 ), 人工品 人工遺物 ( 先史時代の単純な器物 宝石 武器など ) 出土品 Artifact ( 技術的なエラー ), 技術的な側面から入り込むデーターにおける望ましくない変化 ( 測定や解析の段階で発生したデータのエラーや解析のゆがみ
SIMS のアーティファクトについて ナノサイエンス株式会社 永山進 1 artifact( アーティファクト ) とは? 辞書を調べると Artifact ( 考古学 ), 人工品 人工遺物 ( 先史時代の単純な器物 宝石 武器など ) 出土品 Artifact ( 技術的なエラー ), 技術的な側面から入り込むデーターにおける望ましくない変化 ( 測定や解析の段階で発生したデータのエラーや解析のゆがみ
<4D F736F F D D CE81408E9F90A291E A82CC93AE8DEC8CB4979D82F08CB48E E71838C B82C589F096BE815B2E646F63>
 同時発表 : 文部科学記者会 ( 資料配布 ) 筑波研究学園都市記者会 ( 資料配布 ) 科学記者会 ( 資料配布 ) 解禁日時テレビ ラジオ インターネット :12 月 6 日午後 11 時から 現地時間 :6 日午前 9 時 新聞 :12 月 7 日 ( 月 ) 朝刊から 平成 21 年 11 月 30 日筑波大学 次世代メモリの書き込み のメカニズムを原子レベルで解明 概要 1. 筑波大学大学院数理物質研究科の村上浩一研究科長を中心に進めている
同時発表 : 文部科学記者会 ( 資料配布 ) 筑波研究学園都市記者会 ( 資料配布 ) 科学記者会 ( 資料配布 ) 解禁日時テレビ ラジオ インターネット :12 月 6 日午後 11 時から 現地時間 :6 日午前 9 時 新聞 :12 月 7 日 ( 月 ) 朝刊から 平成 21 年 11 月 30 日筑波大学 次世代メモリの書き込み のメカニズムを原子レベルで解明 概要 1. 筑波大学大学院数理物質研究科の村上浩一研究科長を中心に進めている
2θχ/φ scan λ= å Al 2 (11-20) Intensity (a. u.) ZnO(<1nm)/MgO(0.8nm)/Al 2 MgO(0.8nm)/Al 2 WZ-MgO(10-10) a=3.085å MgZnO(10-10) a=3.101å
 MgO/c-Al 2 界面構造解析 課題番号 2005B0434 利用ビームライン BL13XU 東北大学金属材料研究所博士課程後期 3 年の過程 2 年嶺岸耕 1. 背景 ZnO は直接遷移型のワイドギャップ半導体で バンドギャップは室温で 3.37eV 光の波長に換算すると 368nm と紫外域にあることから貸し領域で透明である この性質を利用して紫外域での発光素子としての応用に関する研究 [1-3]
MgO/c-Al 2 界面構造解析 課題番号 2005B0434 利用ビームライン BL13XU 東北大学金属材料研究所博士課程後期 3 年の過程 2 年嶺岸耕 1. 背景 ZnO は直接遷移型のワイドギャップ半導体で バンドギャップは室温で 3.37eV 光の波長に換算すると 368nm と紫外域にあることから貸し領域で透明である この性質を利用して紫外域での発光素子としての応用に関する研究 [1-3]
PowerPoint Presentation
 / 2008/04/04 Ferran Salleras 1 2 40Gb/s 40Gb/s PC QD PC: QD: e.g. PCQD PC/QD 3 CP-ON SP T CP-OFF PC/QD-SMZ T ~ps, 40Gb/s ~100fJ T CP-ON CP-OFF 500µm500µm Photonic Crystal SMZ K. Tajima, JJAP, 1993. Control
/ 2008/04/04 Ferran Salleras 1 2 40Gb/s 40Gb/s PC QD PC: QD: e.g. PCQD PC/QD 3 CP-ON SP T CP-OFF PC/QD-SMZ T ~ps, 40Gb/s ~100fJ T CP-ON CP-OFF 500µm500µm Photonic Crystal SMZ K. Tajima, JJAP, 1993. Control
Microsoft Word - sp8m4-j.doc
 4V 駆動タイプ Nch+Pch MOS FET 構造シリコン N チャネル / P チャネル MOS 型電界効果トランジスタ 外形寸法図 (Unit : mm) SOP8 5..4.75 (8) (5) 特長 ) 新ライン採用により 従来品よりオン抵抗大幅低減 2) ゲート保護ダイオード内蔵 3) 小型面実装パッケージ (SOP8) で省スペース pin mark () (4).27 3.9 6..2.4Min.
4V 駆動タイプ Nch+Pch MOS FET 構造シリコン N チャネル / P チャネル MOS 型電界効果トランジスタ 外形寸法図 (Unit : mm) SOP8 5..4.75 (8) (5) 特長 ) 新ライン採用により 従来品よりオン抵抗大幅低減 2) ゲート保護ダイオード内蔵 3) 小型面実装パッケージ (SOP8) で省スペース pin mark () (4).27 3.9 6..2.4Min.
PowerPoint プレゼンテーション
 Drain Voltage (mv) 4 2 0-2 -4 0.0 0.2 0.4 0.6 0.8 1.0 Gate Voltage (V) Vds [V] 0.2 0.1 0.0-0.1-0.2-10 -8-6 -4-2 0 Vgs [V] 10 1000 1000 1000 1000 (LSI) Fe Catalyst Fe Catalyst Carbon nanotube 1~2 nm
Drain Voltage (mv) 4 2 0-2 -4 0.0 0.2 0.4 0.6 0.8 1.0 Gate Voltage (V) Vds [V] 0.2 0.1 0.0-0.1-0.2-10 -8-6 -4-2 0 Vgs [V] 10 1000 1000 1000 1000 (LSI) Fe Catalyst Fe Catalyst Carbon nanotube 1~2 nm
Acrobat Distiller, Job 2
 2 3 4 5 Eg φm s M f 2 qv ( q qφ ) = qφ qχ + + qφ 0 0 = 6 p p ( Ei E f ) kt = n e i Q SC = qn W A n p ( E f Ei ) kt = n e i 7 8 2 d φ( x) qn = A 2 dx ε ε 0 s φ qn s 2ε ε A ( x) = ( x W ) 2 0 E s A 2 EOX
2 3 4 5 Eg φm s M f 2 qv ( q qφ ) = qφ qχ + + qφ 0 0 = 6 p p ( Ei E f ) kt = n e i Q SC = qn W A n p ( E f Ei ) kt = n e i 7 8 2 d φ( x) qn = A 2 dx ε ε 0 s φ qn s 2ε ε A ( x) = ( x W ) 2 0 E s A 2 EOX
結晶粒と強度の関係
 SPring-8 金属材料評価研究会 218 年 1 月 22 日 @AP 品川 転載不可 アルミニウムにおける 置換型固溶元素が引張変形中の 転位密度変化に及ぼす影響 兵庫県立大学材料 放射光工学専攻〇足立大樹 背景 放射光を用いた In-situ XRD 測定により 変形中の転位密度変化を高時間分解能で測定可能となっており 結晶粒径による転位増殖挙動の変化について明らかにしてきた * * H.
SPring-8 金属材料評価研究会 218 年 1 月 22 日 @AP 品川 転載不可 アルミニウムにおける 置換型固溶元素が引張変形中の 転位密度変化に及ぼす影響 兵庫県立大学材料 放射光工学専攻〇足立大樹 背景 放射光を用いた In-situ XRD 測定により 変形中の転位密度変化を高時間分解能で測定可能となっており 結晶粒径による転位増殖挙動の変化について明らかにしてきた * * H.
2015 OEG セミナー 次世代パワーデバイスの評価 解析 2015 年 7 月 14 日 信頼性解析事業部 解析センタ 長谷川覚 Copyright 2015 Oki Engineering Co., Ltd.
 2015 OEG セミナー 次世代パワーデバイスの評価 解析 2015 年 7 月 14 日 信頼性解析事業部 解析センタ 長谷川覚 Copyright 2015 Oki Engineering Co., Ltd. 目次 1. 次世代パワーデバイス評価 解析の背景 はじめに 良品解析とは 良品解析から劣化を考慮した良品解析へ 2. SiC デバイスの劣化を考慮した良品解析 ( 加速試験による劣化を考慮した
2015 OEG セミナー 次世代パワーデバイスの評価 解析 2015 年 7 月 14 日 信頼性解析事業部 解析センタ 長谷川覚 Copyright 2015 Oki Engineering Co., Ltd. 目次 1. 次世代パワーデバイス評価 解析の背景 はじめに 良品解析とは 良品解析から劣化を考慮した良品解析へ 2. SiC デバイスの劣化を考慮した良品解析 ( 加速試験による劣化を考慮した
e - カーボンブラック Pt 触媒 プロトン導電膜 H 2 厚さ = 数 10μm H + O 2 H 2 O 拡散層 触媒層 高分子 電解質 触媒層 拡散層 マイクロポーラス層 マイクロポーラス層 ガス拡散電極バイポーラープレート ガス拡散電極バイポーラープレート 1 1~ 50nm 0.1~1
 Development History and Future Design of Reduction of Pt in Catalyst Layer and Improvement of Reliability for Polymer Electrolyte Fuel Cells 6-43 400-0021 Abstract 1 2008-2008 2015 2 1 1 2 2 10 50 1 5
Development History and Future Design of Reduction of Pt in Catalyst Layer and Improvement of Reliability for Polymer Electrolyte Fuel Cells 6-43 400-0021 Abstract 1 2008-2008 2015 2 1 1 2 2 10 50 1 5
パナソニック技報
 67 Next-generation Power Switching Devices for Automotive Applications: GaN and SiC Tetsuzo Ueda Yoshihiko Kanzawa Satoru Takahashi Kazuyuki Sawada Hiroyuki Umimoto Akira Yamasaki GaNSiCGaNSiGate Injection
67 Next-generation Power Switching Devices for Automotive Applications: GaN and SiC Tetsuzo Ueda Yoshihiko Kanzawa Satoru Takahashi Kazuyuki Sawada Hiroyuki Umimoto Akira Yamasaki GaNSiCGaNSiGate Injection
Microsoft PowerPoint - 6.memory.ppt
 6 章半導体メモリ 広島大学岩田穆 1 メモリの分類 リードライトメモリ : RWM リードとライトができる ( 同程度に高速 ) リードオンリメモリ : ROM 読み出し専用メモリ, ライトできない or ライトは非常に遅い ランダムアクセスメモリ : RAM 全番地を同時間でリードライトできる SRAM (Static Random Access Memory) 高速 DRAM (Dynamic
6 章半導体メモリ 広島大学岩田穆 1 メモリの分類 リードライトメモリ : RWM リードとライトができる ( 同程度に高速 ) リードオンリメモリ : ROM 読み出し専用メモリ, ライトできない or ライトは非常に遅い ランダムアクセスメモリ : RAM 全番地を同時間でリードライトできる SRAM (Static Random Access Memory) 高速 DRAM (Dynamic
